1. Усилительные свойства транзистора
Физические основы микроэлектроники; Электроника; Флеров А.Н., 2015
Лекция 9, тезисы
Параметры транзисторов
Параметры транзисторов делятся на электрические и предельные эксплуатационные.
Электрические параметры:
1. Граничная частота, fГР;
2. Коэффициент передачи тока, KI;
3. Обратные токи переходов при заданных обратных напряжениях, IKO;
4. Емкости переходов, Сi-j;
и т.д.
Кроме общих электрических параметров в зависимости от назначения
транзистора указывается ряд специфических параметров, присущих данной категории транзисторов.
Предельные эксплуатационные параметры.
Предельные эксплуатационные параметры — это максимально допустимые значения напряжений, токов, мощности, температуры, при которых гарантируются работоспособность транзистора и значений его электрических параметров в пределах норм технических условий.
Например, к предельным эксплуатационным параметрам относятся:
1. Максимально допустимые обратные напряжения на переходах. Uобр макс;
2. Максимально допустимая рассеиваемая мощность, Pк макс;
3. Максимально допустимая температура корпуса, toмакс корп;
4. Диапазон рабочих температур, toмин, toмакс.
Режимы работы транзистора
В зависимости от полярности напряжений, приложенных к электродам транзистора, возможны четыре режима его работы:
— активный;
— отсечки;
— насыщения;
— инверсный.
Режимы насыщения и отсечки объединяют одним термином – ключевой режим.
Активный режим работы используется при усилении малых сигналов, прямое напряжение подается на эмиттерный переход, а обратное — на коллекторный.
В режиме отсечки оба перехода смещаются в обратном направлении. Ток транзистора в этом режиме мал, он практически заперт (транзистор заперт).
В режиме насыщения оба перехода смещаются в прямом направлении, через транзистор протекает максимальный ток, он полностью открыт (транзистор открыт).
В инверсном режиме (используется редко), эмиттерный переход смещен в обратном направлении, а коллекторный в прямом. Этот режим чаще всего используют в быстродействующих ключевых схемах.

режим
полярность
активный
+
—
+
отсечки
—
+
+
—
насыщения
+
—
—
+
инверсный
—
+
—
+
Принцип действия транзисторов типа n-p-n такой же, только в область базы вводятся из эмиттера не дырки, а электроны; полярность напряжений Ек и Еэ будет противоположной случаю p-n-р; направления токов изменится на противоположное, т.к. они обусловлены в данном случае не дырочной, а электронной проводимостью.
Усилительные свойства транзистора рассмотрим на примере схемы включения транзистора с общей базой, рис .9.2
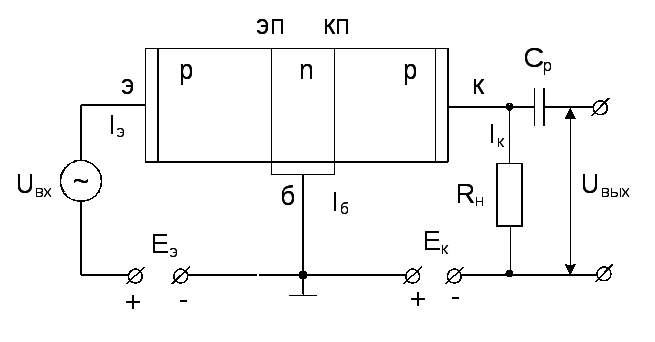
Рис.9.2
Uвх<< ЕЭ (9.1)
Соотношение источников питания ЕКи смещения ЕЭ:
ЕЭ< ЕК.(9.2)
В коллекторную цепь транзистора включается сопротивление нагрузки RH.
Т.к. выходное сопротивление
транзистора (транзистор, со стороны
коллекторного перехода является
источником тока, его
внутреннее сопротивление велико,1-10
МОм), то можно в цепь коллектора включать
большие по номиналу сопротивления
нагрузки, почти не влияя на величину
коллекторного тока (R
Соответственно в цепи нагрузки может выделяться значительная мощность (переменной составляющей)
Pвых~=1/2Iк2Rн (9.3)
Входное сопротивление схемы, напротив, весьма мало (прямо смещенного эмиттерного перехода, единицы — десятки Ом). Соответственно
Rн >> Rвх, (9.4)
Поэтому при почти одинаковых токах коллектора и эмиттера Iк ~ Iэ , (включение транзистора в схеме с общей базой) мощность, потребляемая в цепи эмиттера
Pвх~=1/2Iэ2Rвх (9.5)
оказывается несравненно меньше, чем выделяемая в цепи нагрузки.
Pвых/ Pвх ~Rн / Rвх (9.6а)
Из (9.6) и (9.4) видно, что
Pвых>> Pвх (9.6б)
!!! Т.о транзистор способен усиливать мощность, т.е. он является усилительным прибором.
Показатели, характеризующие усилительные свойства транзистора
— коэффициент усиления по току;
— коэффициент усиления по напряжению;
— коэффициент усиления по мощности.
Коэффициент усиления по току: отношение изменения выходного тока к, к вызвавшего его изменение входного тока Iэ
КI=Iвых/Iвх= Iк/Iэ (9.7)
Для приведенной схемы KI < 1 (типовые значения КI= 0,9 — 0,95), т.е. ток IК в выходной цепи всегда несколько меньше тока Iэ, протекающего во входной цепи и транзистор, включенный по представленной выше схеме, усиления по току не дает.
Обычно отношение Iк/Iэ обозначается (в системе h параметров, см. п.3 “Для самостоятельного изучения“, для схемы с ОБ обозначается h21б).
Чем больше коэффициент , тем меньше отличаются между собой токи IК и IЭ, и соответственно, тем большими оказываются коэффициенты усиления транзистора по напряжению и по мощности.
Коэффициент усиления по напряжению — отношение изменения выходного Uвых переменного напряжения к входному Uвx,:
KU=Uвых /U
Uвых=IK. .Rн (9.9)
Uвх =Iвх rэб, (9.10)
где rэб сопротивление входной цепи транзистора (сопротивление участка эмиттер-база).
KU=IKRн/IЭ. rэб =. Rн/ rэб (9.11а)
т.к Iэ ~Iк , т.е. ~1 то
К
Коэффициент усиления по мощности транзистора: отношение выходной мощности (выделяющейся на нагрузке) к входной
КР~ = Pвых/ Pвх=0.5IK2Rн/ 0.5IЭ2.rэб=.2 Rн/.rэб = Rн/.rэб (9.12)
причем
КР= KU КI(9.13)
Для данной схемы (ОБ) КР
Усиление сигнала с помощью транзистора происходит за счет потребления энергии от источника питания.
Сам транзистор выполняет функции своеобразного регулятора выходного тока, который под действием слабого входного сигнала, введенного в цепь с малым сопротивлением, изменяет ток в выходной цепи, обладающей большим сопротивлением.
Полевые транзисторы
Полевой транзистор полупроводниковый прибор, ток которого изменяется в результате действияперпендикулярноготоку электрического поля, создаваемого входным напряжением.
Полевые транзисторы (ПТ) в отличие от биполярных (БТ) ряд специфических особенностей:
— высокое входное сопротивление;
— малое потребление энергии по цепи управления
ПТ нашли широкое применение и как дискретные элементы схем, также они широко используются в интегральных микросхемах (ИМС). Это объясняется простотой изготовления (в настоящее время) ПТ ИМС, по сравнению с БТ, малым потреблением энергии и высокой плотностью расположения элементов в ИМС.
Классификация полевых транзисторов (упрощенная)
ПТ



с изолированным
затвором (МОП, МДП)


металл — п/п с управляющим встроенный канал индуцированный канал
p—n переходом








р- канал n — канал р -канал n — канал
Рис.9.3 Упрощенная классификация полевых транзисторов
Идея полевого транзистора с изолированным затворомбыла предложена
Ю. Лилиенфельдом в 1926-1928 годах. Объективные научные и технологические трудности в реализации этой конструкции позволили создать первый работающий прибор этого типа только в 1960 году.
В 1953 году Дейки и Росс предложили и реализовали другую конструкцию полевого транзистора — с управляющим p-n переходом.
Конструкция полевых транзисторов с барьером Шоттки— была предложена и реализована Мидом в 1966 году.
Полевой транзистор с управляющим р-n переходом
Полевой транзистор с управляющим p-n переходом— это полевой транзистор, управление потоком основных носителей в котором происходит с помощью выпрямляющего электрического перехода, смещенного в обратном направлении.
Конструкция
Схематическое устройство полевого транзистора с управляющим p-n переходом представлено на рис. 9.4

Рис. 9.4 Упрощенная структура полевого транзистора с управляющим p-n переходом
Полевой транзистор с управляющим p-n переходом представляет собой монокристалл полупроводникаn—типа проводимости.
По торцам кристалла методом напыления сформированы электроды, а посередине, с двух сторон, созданы две области p-типа проводимости также с электрическими выводами от этих областей,соединенные между собой(возможны и другие варианты структуры, например – цилиндрическая с кольцевым затвором).
На границе раздела областей с различным типом проводимости возникнет
р-n переход.
ПТ содержит три полупроводниковые области: две одного и того же типа проводимости, называемые соответственно истоком (И) и стоком (С), и противоположной им типа проводимости, называемой затвором (З).
Область между стоком и истоком называется каналом.
К каждой из областей (стоку, истоку и затвору) присоединены соответствующие выводы (невыпрямляющие контакты, омические).
В транзисторе используется движение носителей заряда одного знака (основных носителей), которые, ПОД ДЕЙСТВИЕМ ЭЛЕКТРИЧЕСКОГО ПОЛЯ, СОЗДАВАЕМОГО ВНЕШНИМ ИСТОЧНИКОМ (Uси), движутся из истока через канал в сток.
Этим объясняются названия: исток— область, из которой выходят носители заряда, и сток — область, в которую они входят.
p—n переход при нормальном режиме работы транзистора должен быть обратносмещенным.
Физика работы
Действие прибора основано на зависимости толщины p-n перехода в зависимости от
приложенного к нему напряжения.
Источник напряжения U3И создает отрицательное напряжение на затворе (относительно истока), p-n переход находится в запертом состоянии и почти полностью лишен подвижных носителей заряда, его проводимость практически равна нулю.
Увеличение запирающего напряжение на затворе приводит к увеличению ширины перехода (области обедненной носителями заряда) и соответственно к уменьшению сечения проводящего канала.
Если подключить к каналу источник питания UИС между стоком и истоком (невыпрямляющими контактами), то через кристалл полупроводника потечет ток.
С уменьшением или увеличением напряжения на затворе (U3И’, U3И” на рис.9.4) уменьшается или увеличивается ширина p-n перехода, вследствие этого изменяется сечение канала которое зависит от толщины р-n перехода т.е. изменяется сопротивление канала и в результате изменяется величина тока стока IС.
Таким образом, изменением напряжения на затворе, можно управлять 1С.
Носители в канале движутся от истока к стоку под действием продольного электрического поля (направленного вдоль канала), создаваемого напряжением меду стоком и истоком.
Основным процессом переноса носителей заряда, образующим ток полевого транзистора, является дрейфосновных носителей в электрическом поле.
Электрическое поле, возникающее при приложении напряжения между затвором и истоком, направлено перпендикулярно движению носителей в канале и при этом говорят, что ток транзистора управляется поперечным электрическим полем.
Можно подобрать такое отрицательное напряжение на затворе, при котором произойдет полное перекрытие канала.
При полностью перекрытом канале ток канала IC обращается в нуль, а в цепи стока течет лишь малый остаточный ток (или ток отсечки) IСО.
Он состоит из обратного тока p-n перехода I0 и тока утечки Iу, протекающего по поверхности кристалла. Т.к. Iу « I0, то Iсо ~ I0 .
!!! Полевой транзисторв отличие от биполярного иногда называютуниполярным, т. к. его работа основана только токах основных носителях заряда либо электронов, либо дырок (зависит от типа канала).
Вследствие этого в полевом транзисторе отсутствуют процессы накопления и рассасывания объемного заряда неосновных носителей, оказывающих заметное влияние на быстродействие биполярного транзистора.
Модуляция ширины канала
В рабочем режиме по каналу протекает
ток IС,
поэтому потенциалы различных
поперечных сечений оказываются
неодинаковыми, рис.9.5 (для примера показан
транзистор с каналом p-
типа, напряжение на затворе – положительное,
а на стоке — отрицательное).
рабочем режиме по каналу протекает
ток IС,
поэтому потенциалы различных
поперечных сечений оказываются
неодинаковыми, рис.9.5 (для примера показан
транзистор с каналом p-
типа, напряжение на затворе – положительное,
а на стоке — отрицательное).
Рис. 9.5 Модуляция шириныp- канала
Потенциал UCх, распределенный вдоль канала, меняется от 0 (у земляного вывода) у истока до UC у стока.
Оба напряжения UЗИ (положительное)и UCх(отрицательное) являются запирающими для p-n перехода.
Наибольшим будет сечение канала возле истока, где напряжение на переходе Upn = U3И, и наименьшим возле стока, где Upn = UЗИ — Uc.
Если увеличивать напряжение на стоке Uc, то увеличение IС, начиная с некоторого
значения Uc, прекратиться, т.к. сужение канала будет увеличивать его сопротивление и увеличения тока, несмотря на увеличение напряжения, происходить не будет. Этот процесс называется насыщением.
При относительно большом напряжении Uc, когда UСИ + U3И > Upn допуст , в стоковом участке обратно включенного управляющего p-n перехода возникает электрический лавинный пробой и IС резко возрастает. Этот ток замыкается через электрод затвора.
Условное графическое обозначениеполевого транзистора с управляющимp-nпереходом:

Рис. 9.6Условные обозначения полевого транзистора, имеющего канал n-типа (а) и
p-типа (б). Стрелка в выводе затвора указывает направление прямого тока через р-n переход
Статические ВАХ ПТ с управляющим р —n переходом
Статическая стоковая характеристика
Ic = f(Uc) при UЗИ = const, см. рис.9.7
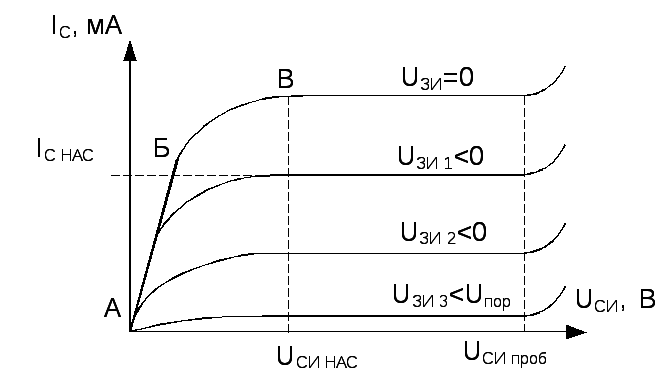
Рис. 9.7 Стоковая характеристика
При UЗИ < Uпор — транзистор закрыт, и его ВАХ подобна обратной ветви полупроводникового диода (нижняя кривая на рис.9.7).
Она практически совпадает с осью напряжений, отклоняясь от нее в области электрического пробоя.
При U3И = 0 и малых значениях UСИ ток стока изменяется прямо пропорционально с изменением напряжения (участок АБ).
В точке БВ из-за заметного сужения стокового участка канала и уменьшения его общей проводимости намечается некоторое отклонение характеристики от прямой линии.
На участке БВ существенное сужение стокового участка канала и значительное уменьшения его общей проводимости вызывают замедление роста тока IС с увеличением UСИ.
В точке В, при UСИ нас ток стока достигает величины IС нас и в дальнейшем остается почти неизменным.
Составной транзистор — Википедия
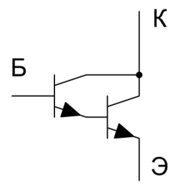 Пара Дарлингтона составленная из транзисторов n-p-n типа
Пара Дарлингтона составленная из транзисторов n-p-n типаСоставно́й транзи́стор — электрическое соединение двух (или более) биполярных транзисторов, полевых транзисторов или IGBT-транзисторов, с целью улучшения их электрических характеристик. К этим схемам относят так называемую пару Дарлингтона, пару Шиклаи, каскодную схему включения транзисторов, схему так называемого токового зеркала и др.
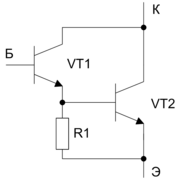 Пара Дарлингтона с резистором, который используется в качестве нагрузки транзистора VT1.
Пара Дарлингтона с резистором, который используется в качестве нагрузки транзистора VT1.Составной транзистор (или схема) Дарлингтона (часто — пара Дарлингтона) была предложена в 1953 году инженером Bell Laboratories Сидни Дарлингтоном (Sidney Darlington). Схема является каскадным соединением двух (редко — трех или более) биполярных[1] транзисторов, включённых таким образом, что нагрузкой в эмиттерной цепи предыдущего каскада является переход база-эмиттер транзистора последующего каскада (то есть эмиттер предыдущего транзистора соединяется с базой последующего), при этом коллекторы транзисторов соединены. В этой схеме ток эмиттера предыдущего транзистора является базовым током последующего транзистора.
Коэффициент усиления по току пары Дарлингтона очень высок и приблизительно равен произведению коэффициентов усиления по току транзисторов составляющих такую пару. У мощных транзисторов включенных по схеме пары Дарлингтона, конструктивно выпускаемой в одном корпусе (например, транзистор КТ825) гарантированный коэффициент усиления по току при нормальных условиях эксплуатации) не менее 750[2].
У пар Дарлингтона, собранных на маломощных транзисторах этот коэффициент может достигать значения 50000.
Высокий коэффициент усиления по току обеспечивает управление малым током, поданным на управляющий вход составного транзистора, выходными токами превышающими входной на несколько порядков.
Достигнуть повышения коэффициента усиления по току можно также уменьшив толщину базы при изготовлении транзистора, такие транзисторы выпускаются промышленностью и называются «супербета транзистор», но процесс их изготовления представляет определённые технологические трудности и такие транзисторы имеют очень низкие коллекторные рабочие напряжения, не превышающие нескольких вольт. Примерами супербета транзисторов могут служить серии одиночных транзисторов КТ3102, КТ3107. Однако и такие транзисторы иногда объединяют в схеме Дарлингтона. Поэтому в относительно сильноточных и высоковольтных схемах, где требуется снизить управляющий ток, используются пары Дарлингтона или пары Шиклаи.
Иногда и схему Дарлингтона не совсем корректно называют «супербета транзистор»[3].
Составные транзисторы Дарлингтона используются в сильноточных схемах, например, в схемах линейных стабилизаторов напряжения, выходных каскадах усилителей мощности) и во входных каскадах усилителей, если необходимо обеспечить большой входной импеданс и малые входные токи.
Составной транзистор имеет три электрических вывода, которые эквивалентны выводам базы, эмиттера и коллектора обычного одиночного транзистора. Иногда в схеме для ускорения закрывания выходного транзистора и снижения влияния начального тока входного транзистора используется резистивная нагрузка эмиттера входного транзистора, как показано на рисунке.
Пару Дарлингтона электрически в целом рассматривают как один транзистор, коэффициент усиления по току которого, при работе транзисторов в линейном режиме, приблизительно равен произведению коэффициентов усиления всех транзисторов, например, двух:
- βD≈β1⋅β2{\displaystyle \beta _{D}\approx \beta _{1}\cdot \beta _{2}}
- где βD{\displaystyle \beta _{D}} — коэффициент усиления по току пары Дарлингтона;
- β1,{\displaystyle \beta _{1},} β2{\displaystyle \beta _{2}} — коэффициенты усиления по току транзисторов пары.
Покажем, что составной транзистор действительно имеет коэффициент β{\displaystyle \beta }, значительно больший, чем у его обоих транзисторов. Анализ проведен для схемы без эмиттерного резистора R1{\displaystyle R_{1}} (см. рисунок).
Ток эмиттера IE{\displaystyle I_{E}} любого транзистора через базовый ток IB,{\displaystyle I_{B},} статический коэффициент передачи тока базы β{\displaystyle \beta } и из 1-го правила Кирхгофа выражается формулой:
- IE=IB+IC=IB+IB⋅β=IB⋅(1+β),{\displaystyle I_{E}=I_{B}+I_{C}=I_{B}+I_{B}\cdot \beta =I_{B}\cdot (1+\beta ),}
- где IC{\displaystyle I_{C}} — ток коллектора.
Так как ток эмиттера второго транзистора IE2{\displaystyle I_{E2}}, опять же из 1-го правила Кирхгофа равен:
- IE2=IB1+IC1+IC2,{\displaystyle I_{E2}=I_{B1}+I_{C1}+I_{C2},}
- где IB1{\displaystyle I_{B1}} — базовый ток 1-го транзистора;
- IC1,{\displaystyle I_{C1},} IC2{\displaystyle I_{C2}} — коллекторные токи транзисторов.
Имеем:
- βD=β1+β2+β1⋅β2,{\displaystyle \beta _{D}=\beta _{1}+\beta _{2}+\beta _{1}\cdot \beta _{2},}
- где β1,{\displaystyle \beta _{1},} β2,{\displaystyle \beta _{2},} — статические коэффициенты передачи тока базы на коллектор транзисторов 1 и 2.
Так как у транзисторов β>>1,{\displaystyle \beta >>1,} то βD≈β1⋅β2.{\displaystyle \beta _{D}\approx \beta _{1}\cdot \beta _{2}.}
Коэффициенты β1{\displaystyle \beta _{1}} и β2{\displaystyle \beta _{2}} различаются даже в случае применения пары совершенно одинаковых по всем параметрам транзисторов, поскольку ток эмиттера IE2{\displaystyle I_{E2}} в 1+β2{\displaystyle 1+\beta _{2}} раз больше тока эмиттера IE1{\displaystyle I_{E1}}, (это вытекает из очевидного равенства IB2=IE1,{\displaystyle I_{B2}=I_{E1},} а статический коэффициент передачи тока транзистора заметно зависит от тока коллектора и может различаться во много раз при разных токах[4].
 Каскад Шиклаи, эквивалентный n-p-n транзистору
Каскад Шиклаи, эквивалентный n-p-n транзисторуПаре Дарлингтона подобно соединение транзисторов по схеме Шиклаи (Sziklai pair), названное так в честь его изобретателя Джорджа К. Шиклаи, также иногда называемое комплементарным транзистором Дарлингтона[5]. В отличие от схемы Дарлингтона, состоящей из двух транзисторов одного типа проводимости, схема Шиклаи содержит транзисторы разного типа проводимости(p-n-p и n-p-n). Пара Шиклаи электрически эквивалентна n-p-n-транзистору c большим коэффициентом усиления. Входное напряжение — это напряжение между базой и эмиттером транзистора Q1, а напряжение насыщения равно по крайней мере падению напряжения на диоде[уточнить]. Между базой и эмиттером транзистора Q2 обычно включают резистор с небольшим сопротивлением. Такая схема применяется в мощных двухтактных выходных каскадах при использовании выходных транзисторов одной проводимости.[уточнить]

Основная статья: Каскодный усилитель
Составной транзистор, выполненный по так называемой каскодной схеме, характеризуется тем, что транзистор VT1 включен по схеме с общим эмиттером, а транзистор VT2 — по схеме с общей базой. Такой составной транзистор эквивалентен одиночному транзистору, включенному по схеме с общим эмиттером, но при этом он имеет гораздо лучшие частотные свойства, высокое выходное сопротивление и больший линейный диапазон, то есть меньше искажает передаваемый сигнал. Так как потенциал коллектора входного транзистора практически не изменяется, это существенно подавляет нежелательное влияние эффекта Миллера и расширяет рабочий диапазон по частоте.
Достоинства и недостатки составных транзисторов[править | править код]
Высокие значения коэффициента усиления в составных транзисторах реализуются только в статическом режиме, поэтому составные транзисторы нашли широкое применение во входных каскадах операционных усилителей. В схемах на высоких частотах составные транзисторы уже не имеют таких преимуществ — граничная частота усиления по току и быстродействие составных транзисторов меньше, чем эти же параметры для каждого из транзисторов VT1 и VT2.
Достоинства составных пар Дарлингтона и Шиклаи:
- Высокий коэффициент усиления по току.
- Схема Дарлингтона изготавливается в составе интегральных схем и при одинаковом токе площадь занимаемая парой на поверхности кристалла кремния меньше, чем у одиночного биполярного транзистора.
- Применяются при относительно высоких напряжениях.
Недостатки составного транзистора:
- Низкое быстродействие, особенно в ключевом режиме при переходе из открытого состояния в закрытое. Поэтому составные транзисторы используются преимущественно в низкочастотных ключевых и усилительных схемах, работающих в линейном режиме. На высоких частотах их частотные параметры хуже, чем у одиночного транзистора.
- Прямое падение напряжения Uбэ составного транзистора в схеме Дарлингтона почти в два раза больше[6], чем у одиночного транзистора, и составляет для кремниевых транзисторов около 1,2 — 1,4 В, так как равна сумме падений напряжения на прямосмещённых p-n переходах двух транзисторов.
- Большое напряжение насыщения коллектор-эмиттер, для кремниевого транзистора около 0,9 В (по сравнению с 0,2 В у обычных транзисторов) для маломощных транзисторов и около 2 В для транзисторов большой мощности, так как не может быть меньше чем падение напряжения на прямосмещённом p-n переходе плюс падение напряжения на насыщенном входном транзисторе.[уточнить]
Применение нагрузочного резистора R1 позволяет улучшить некоторые характеристики составного транзистора. Величина резистора выбирается с таким расчётом, чтобы ток коллектор-эмиттер транзистора VT1 в закрытом состоянии (начальный ток коллектора) создавал на резисторе падение напряжения, недостаточное для открытия транзистора VT2. Таким образом, ток утечки транзистора VT1 не усиливается транзистором VT2, тем самым уменьшается общий ток коллектор-эмиттер составного транзистора в закрытом состоянии. Кроме того, применение резистора R1 способствует увеличению быстродействия составного транзистора за счёт форсирования закрытия транзистора, так как неосновные носители, накопленные в базе VT2 при его запирании из режима насыщения не только рассасываются, но и стекают через этот резистор. Обычно сопротивление R1 выбирают величиной сотни ом в мощном транзисторе Дарлингтона и несколько килоом в маломощном транзисторе Дарлингтона. Примером схемы Дарлингтона выполненной в одном корпусе со встроенным эмиттерным резистором служит мощный n-p-n транзистор Дарлингтона типа КТ827, его типовой коэффициент усиления по току около 1000 при коллекторном токе 10 А.
- ↑ Полевые транзисторы, в отличие от биполярных, не используются в составном включении, так как обладая высоким входным сопротивлением, управляются напряжением, а не током и такое включение нецелесообразно.
- ↑ Технический паспорт транзистора КТ825.
- ↑ Супербе́та (супер-β) транзисторами называют транзисторы со сверхбольшим значением коэффициента усиления по току, полученным за счёт очень малой толщины базы, а не за счёт составного включения. При этом рабочий базовый ток одиночного транзистора можно снизить до десятков пА. Такие транзисторы применены в первом каскаде операционных усилителей со сверхмалыми входными токами, например, типов LM111 и LM316.
- ↑ Степаненко И. П. Основы теории транзисторов и транзисторных схем. — 4-е изд., перераб. и доп.. — М.: Энергия, 1977. — С. 233, 234. — 672 с.
- ↑ Хоровиц П., Хилл У. Искусство схемотехники: В 3-х томах: Пер. с. англ. — 4-е изд., перераб. и доп. — М.: Мир, 1993. — Т. 1. — С. 104, 105. — 413 с. — 50 000 экз. — ISBN 5-03-002337-2.
- ↑ Это не всегда (не во всех применениях) является недостатком, но всегда — особенностью, которую надо учитывать при расчёте схемы по постоянному току, и которая не позволяет напрямую заменить одиночный транзистор на составной Дарлингтона.
Транзистор с высокой подвижностью электронов — Википедия
Транзистор с высокой подвижностью электронов (ТВПЭ, HEMT) — полевой транзистор, в котором для создания канала используется контакт двух полупроводниковых материалов с различной шириной запрещенной зоны (вместо легированной области как у обычных МОП-транзисторов)[1]. В отечественной и зарубежной литературе такие приборы часто обозначают HEMT — от англ. High Electron Mobility Transistor. Также в зависимости от структуры используются аналогичные названия: HFET, HEMFET, MODFET, TEGFET, SDHT. Другие названия этих транзисторов: полевые транзисторы с управляющим переходом металл — полупроводник и гетеропереходом, ГМеП транзисторы, полевые транзисторы с модулированным легированием, селективно-легированные гетероструктурные транзисторы (СЛГТ)[источник не указан 1926 дней].
Изобретателем ТВПЭ обычно считается Такаси Мимура (яп. 三村高志; Fujitsu, Япония)[2]. Однако Рэй Дингл и его сотрудники из Bell Laboratories также внесли значительный вклад в изобретение ТВПЭ.
Структура HEMT-транзистора в сеченииНа рисунке представлена структура HEMT-транзистора в разрезе. На полуизолирующей подложке арсенида галлия (GaAs) выращивается нелегированный буферный слой GaAs. На нем наращивается тонкий слой полупроводника с иной шириной запрещенной зоны — InGaAs, такой, что образуется область двумерного электронного газа (2DEG). Сверху слой защищается тонким спейсером на основе арсенида алюминия-галлия AlxGa1−xAs (далее AlGaAs). Выше следуют легированный кремнием слой n-AlGaAs и сильнолегированный слой n+-GaAs под контактными площадками стока и истока. Контакт затвора приближен к области двумерного электронного газа.
Распространенными материалами для ТВПЭ является комбинация GaAs и AlGaAs, хотя возможны и значительные вариации в зависимости от назначения устройства. Например, приборы с повышенным содержанием индия в общем случае показывают лучшую производительность на высоких частотах, в то время как в последние[когда?] годы наблюдается массовый рост научно-исследовательских разработок ТВПЭ на нитриде галлия (GaN), в связи с их лучшей производительностью при высоких мощностях. Существует достаточно много изоструктурных аналогов GaAs — полупроводниковых материалов, имеющих близкий к GaAs период кристаллической решетки. Это позволяет использовать GaAs в качестве основы для создания широкого класса гетероструктурных транзисторов, обладающих выдающимися характеристиками. Параметры некоторых из таких материалов приведены в таблице 1.
Таблица 1. Параметры некоторых полупроводниковых материалов, применяемых для создания гетероструктур на основе GaAs.
| Полупроводник | Параметр решетки a0{\displaystyle a_{0}}, нм | Ширина запрещенной зоны ΔEg{\displaystyle \Delta E_{\text{g}}}, эВ | Подвижность электронов μn{\displaystyle \mu _{n}}, см2/В·с | Подвижность дырок μp{\displaystyle \mu _{p}}, см2/В·с |
|---|---|---|---|---|
| GaAs | 0,5654 | 1,42 | 8500 | 420 |
| AlAs | 0,5661 | 2,95 | н/д | н/д |
| Ge | 0,5658 | 0,67 | 3800 | 1820 |
| InP | 0,5869 | 1,26 | 4600 | 150 |
| InAs | 0,6057 | 0,35 | 27000 | 450 |
| AlSb | 0,6135 | 2,5 | н/д | н/д |
| InSb | 0,6479 | 0,17 | 78000 | 750 |
Помимо приведенных в таблице, для создания гетероструктур широко применяются различные твердые растворы (AlxGa1−xAs, GaxIn1−xAs, GaxIn1−xP, AlxIn1−xAs и другие).
Обычно для создания гетероперехода выбираются материалы с одинаковым параметром кристаллической решётки (расстояниями между атомами). По аналогии, представьте, что вы сцепляете две расчёски с немного отличающимся шагом между зубчиками. Через какие-то определённые интервалы будет происходить наложение двух зубьев друг на друга. В полупроводниках такие несоответствия играют роль «ловушек» носителей и существенно ухудшают производительность приборов. В реальности практически невозможно подобрать пару разных п/п, у которых было бы идеальное согласование и кристаллических структур, и коэффициентов термического расширения. Поэтому на границе раздела гетероперехода обычно возникают механические напряжения, вызывающие появление дислокаций несоответствия, создающих на границе раздела граничные состояния. Даже у такой хорошо согласующейся пары как Ge и GaAs присутствует пластическая деформация. Поэтому для создания структуры используются твердые растворы. Например, замена Ge на твердый раствор Ge0,98Si0,02 приводит к снижению напряжений на границе раздела до уровня, исключающего возможность пластической деформации GaAs, и улучшает характеристики гетероперехода — у него резко уменьшается обратный ток.
В HEMT транзисторах чаще всего применяют гетеропереход GaAs-AlGaAs. С увеличением относительного содержания Al в твердом растворе AlGaAs плавно увеличивается ширина запрещенной зоны. Для состава с х = 0,3 ∆Eз = 1,8 эВ и различие в ширине запрещённой зоны составляет ~0,38 эВ. Вследствие хорошего соответствия кристаллических решёток GaAs и AlGaAs в гетеропереходе обеспечивается низкая плотность поверхностных состояний и дефектов. По этим причинам для электронов, накопленных в области накопления затвора, в слабых электрических полях достигается очень высокая подвижность, близкая к объёмной подвижности для нелегированного GaAs [(8..9)⋅103 см2/В•с при Т = 300 К]. Причём эта подвижность резко увеличивается при понижении температуры, так как в нелегированном GaAs преобладает решётчатое рассеяние.
Также подвижность электронов в канале увеличивается благодаря дополнительной прослойке (спейсеру) между каналом GaAs и барьером AlGaAs. Спейсер — тонкий (несколько нм) разделительный слой нелегированного AlxGa1-xAs. Он способствует лучшему пространственному разделению двумерного электронного газа и рассеивающих центров между нелегированным GaAs и легированным донорами AlxGa1-xAs. Концентрация рассеивающих центров в нелегированном слое ниже, чем в легированном, поэтому подвижность электронов, накопленных в области насыщения затвора, дополнительно увеличивается. В этом случае волновая функция электронов в канале не проникает в барьер, а затухает в спейсере. При этом уменьшается рассеяние носителей на барьере. Введение спейсера также улучшает омический контакт, что приводит к повышению предельной рабочей частоты почти до теоретического предела.[3]
Равновесная энергетическая диаграмма гетероперехода между нелегированным GaAs и легированным донорными примесями, например, Si, AlxGa1-xAs
В нелегированном GaAs уровень Ферми располагается почти посередине запрещённой зоны, а в легированном AlxGa1-xAs вблизи дна зоны проводимости (Ес). В GaAs у границы раздела 5 2-х п/п образуется область 3 с минимальной энергией электронов. В эту область из п/п с более широкой запрещенной зоной «скатываются» свободные электроны ионизированных атомов примеси. В результате произойдет пространственное разделение электронов и компенсирующих их ионизованных атомов примеси. Электроны, накопленные в области 3, находятся в потенциальной яме и в слабых электрических полях могут перемещаться только вдоль границы 5 в плоскости, перпендикулярной плоскости рисунка. Поэтому совокупность электронов в области 3 и называют двумерным электронным газом, подчеркивая тем самым, что в слабых полях эти е− не могут перемещаться в третьем измерении, то есть переходить, например, из области 3 в область 4, так как этому препятствует потенциальный барьер ∆Ес ≈ (0,6 ÷ 0,65)(∆Ез2 — ∆Ез1).
Температурная зависимость подвижности электронного газа. 1 — гетероструктура; 2 — GaAs. На рисунке 2 (кривая 1) показана температурная зависимость подвижности электронного газа, полученная в этом случае. При температурах жидкого азота (77 К) и жидкого гелия (4 К) μn соответственно возрастает до 1,4⋅105 и 2⋅106 см²/В•с. На этом же рисунке (кривая 2) показана температурная зависимость μn в GaAs с концентрацией Nд = 1017 см−3.
Псевдоморфный гетеропереход[править | править код]
ТВПЭ, в котором правило соответствия параметра кристаллической решётки слоёв гетероперехода не соблюдается, называется псевдоморфным (пТВПЭ или pHEMT). Для этого слой одного из материалов делается очень тонким — настолько, что его кристаллическая решётка попросту растягивается до соответствия другому материалу. Такой способ позволяет изготавливать структуры с увеличенной разницей в ширине запрещенной зоны, что недостижимо другими путями. Такие приборы обладают улучшенной производительностью.
Метаморфный гетеропереход[править | править код]
Другой способ совмещения материалов с разными решётками — помещение между ними буферного слоя. Это применяется в метаморфном ТВПЭ (мТВПЭ или mHEMT). Буферный слой представляет собой AlInAs, с концентрацией индия подобранной таким образом, что решётка буферного слоя может быть согласована как подложкой GaAs, так и с каналом InGaAs. Преимуществом такой структуры является возможность выбора практически любой концентрации индия для создания канала, то есть прибор может быть оптимизирован для различных применений (низкая концентрация индия обеспечивает низкий шум, а высокая — бо́льшую степень усиления).
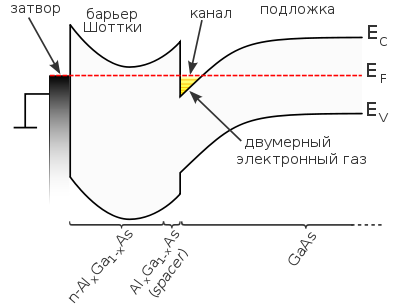 Зонная диаграмма HEMT-транзистора
Зонная диаграмма HEMT-транзистораВ общем случае, для создания проводимости в полупроводниках используются легирующие примеси. Однако, получаемые электроны проводимости испытывают столкновения с примесными островами, что отрицательно сказывается на подвижности носителей и быстродействии прибора. В ТВПЭ этого удается избежать за счет того, что электроны с высокой подвижностью генерируются на гетеропереходе в области контакта высоколегированного донорного слоя N-типа с широкой запрещенной зоной (в нашем примере AlGaAs) и нелегированного канального слоя с узкой запрещенной зоной без каких-либо легирующих примесей (в данном случае GaAs).
Электроны, образующиеся в тонком слое N-типа, полностью перемещаются в слой GaAs, обедняя слой AlGaAs. Обеднение происходит из-за изгиба потенциального рельефа в гетеропереходе — между полупроводниками с разной шириной запрещенной зоны образуется квантовая яма. Таким образом, электроны способны быстро передвигаться без столкновений с примесями в нелегированном слое GaAs. Образуется очень тонкая прослойка с большой концентрацией высокоподвижных электронов, обладающих свойствами двумерного электронного газа (ДЭГ). Сопротивление канала очень низкое, и подвижность носителей в нём высока.
Так же, как в других типах полевых транзисторов, приложенное к затвору ТВПЭ напряжение изменяет проводимость канального слоя.
Принцип действия ТВПЭ — транзистора аналогичен принципу действия МеП-транзистора. Между металлическим затвором и расположенным под ним слоем из AlGaAs, образуется управляющий переход Металл — Полупроводник (далее по тексту Ме — п/п). Обедненная область этого перехода располагается, в основном, в слоях AlGaAs. Канал нормально открытого транзистора при Ugs<0{\displaystyle U_{\text{gs}}<0} формируется в слое нелегированного GaAs на границе гетероперехода в области накопления двумерного электронного газа. Под действием управляющего напряжения Ugs{\displaystyle U_{\text{gs}}} изменяется толщина обедненной области перехода Ме — п/п, концентрация электронов в ДЭГ и ток стока. Электроны поступают в область накопления из истока. При достаточно большом (по модулю) отрицательном Ugs=Uf{\displaystyle U_{\text{gs}}=U_{f}} обедненная область расширяется настолько, что перекрывает область насыщения электронов. Ток стока при этом прекращается.
В нормально закрытом транзисторе вследствие меньшей толщины верхнего слоя AlGaAs при Ugs=0{\displaystyle U_{\text{gs}}=0} проводящий канал отсутствует, так как область насыщения двумерного электронного газа перекрыта обедненной областью управляющего перехода. Канал возникает при некотором положительном Ugs=Uf{\displaystyle U_{\text{gs}}=U_{f}}, когда обедненная область управляющего перехода сужается настолько, что её нижняя граница попадает в область накопления электронов.
Стокозатворные характеристики нормально открытого (1) и нормально закрытого (2) транзисторов приведены на рисунке 4. Благодаря высокой подвижности электронов и малой Lg{\displaystyle L_{\text{g}}} практически во всем диапазоне Ugs достигается насыщение дрейфовой скорости электронов в канале (Vsat) и наблюдается линейная зависимость Ic от Ugs.
- Ic=S∗⋅(Ug−Uf−EkpLg){\displaystyle I_{c}=S^{*}\cdot (U_{g}-U_{f}-E_{kp}L_{g})}
где Ekp{\displaystyle E_{kp}} — критическая напряжённость поля;
- S∗=S/(1+Rs⋅S){\displaystyle S^{*}=S/(1+R_{s}\cdot S)}
где Rs{\displaystyle R_{s}} — сопротивление истока, S=ϵ0ϵf2Vsat⋅b/dk{\displaystyle S=\epsilon _{0}\epsilon _{f}^{2}V_{sat}\cdot b/dk}.
Для кривой (1) S*/b = 117 мСм/мм, для кривой (2) — 173 мСм/мм. Большее значение крутизны н.з. транзистора обусловлено меньшей толщиной легированного донорами AlxGa1-xAs.
Важным достоинством HEMT транзисторов, по сравнению со структурой МеП транзисторов являются меньшая плотность поверхностных состояний на границе между AlxGa1-xAs и диэлектриком, и большая высота барьера Шоттки (φ0g ≈ 1 В). Вследствие меньшей плотности поверхностных состояний уменьшается отрицательный поверхностный заряд и толщина обеднённых областей в промежутках ИСТОК — ЗАТВОР и ЗАТВОР — СТОК. Это позволяет получить меньшие паразитные сопротивления обеднённых областей без самосовмещения. Вследствие большей высоты барьера Шоттки, для HEMT транзисторов возможно большее (до 0,8 В) прямое напряжение Ugs, что особенно важно для нормально закрытых транзисторов, рабочие напряжения на затворах которых могут изменяться лишь в узком диапазоне, ограниченном сверху напряжением управляющего перехода Ме — п/п. Импульсные и частотные свойства HEMT транзисторов в основном определяются временем пролёта электронов через канал, где они движутся со скоростью насыщения: τk=Lg/Vsat{\displaystyle \tau _{k}=L_{g}/V_{sat}}. При Т = 300 К Vsat{\displaystyle V_{sat}} ≈ 2∙107 см/с. При понижении температуры скорость насыщения увеличивается по закону Vsat{\displaystyle V_{sat}} ~ 1/Т. Одним из важнейших параметров, характеризующих семейство логических ИМС, является произведение быстродействия на мощность (P×τk{\displaystyle P\times \tau _{k}}), представляющее собой произведение мощности, рассеиваемой одним вентилем, на время задержки в этом вентиле. Другой сравнительной характеристикой служит произведение мощности, рассеиваемой одним вентилем, на квадрат времени задержки в этом вентиле (P×τk2{\displaystyle P\times \tau _{k}^{2}}), что представляет собой произведение энергии на время. В таблице 2 приведены сравнительные характеристики КМОП, МеП, HEMT ИМС при комнатной температуре.
Таблица 2. Сравнительные характеристики КМОП, МеП, HEMT ИМС при комнатной температуре.
| Тип транзистора | lк, мкм (Lg, мкм) | Р, мВт/вент | τk{\displaystyle \tau _{k}}, нс | P×τk{\displaystyle P\times \tau _{k}}, Дж∙10−15 (фДж) | P×τk2{\displaystyle P\times \tau _{k}^{2}}, Дж∙с∙10−26 |
|---|---|---|---|---|---|
| МеП | 0,3 | 0,75 | 16 | 12 | 19,2 |
| HEMT | 1,0 | 1,1 | 12,2 | 13,4 | 16,4 |
| КМОП | 1,0 | 1,8 | 50 | 90 | 450 |
Основными недостатками ТВПЭ являются инерционность затвора и подзатворный пробой.
Область применения ТВПЭ, как и металл-полупроводниковых полевых транзисторов[en] (англ. MESFET) — связь в микроволновом и миллиметровом диапазоне длин волн, радары и радиоастрономия, от мобильных телефонов[4] и широкополосных спутниковых ресиверов до систем электронного обнаружения — то есть любые устройства, в которых требуется высокая степень усиления сигнала и низкий шум на больших частотах. ТВПЭ способны производить усиление по току при частотах выше 600 ГГц и по мощности при частотах более 1 ТГц. В апреле 2005 г. были продемонстрированы биполярные транзисторы на гетеропереходе[en] (англ. HBT) с усилением по току на частотах более 600 ГГц. В январе 2010 г. группа ученых из Японии и Европы представила терагерцовый ТВПЭ с рабочей частотой (при полной ширине половины пика FWHM) 2,5 ТГц [5]
Несколько компаний во всем мире разрабатывают и производят приборы на основе ТВПЭ. Это могут быть отдельные транзисторы, но чаще приборы выпускаются в форме монолитной интегральной схемы (СВЧ МИС, англ. MMIC).
- Sheng S. Li. Semiconductor Physical Electronics. — Second Edition. — Springer, 2006. — 708 с. — ISBN 978-0387-28893-2.
Одноэлектронный транзистор — Википедия
Рис. 1. Схема одноэлектронного транзистора. Рис. 2. Энергетические уровни истока, проводящего канала (острова) и стока (слева направо) в одноэлектронном транзисторе для закрытого (верхняя часть) и проводящего (нижняя часть) состояний.
Рис. 2. Энергетические уровни истока, проводящего канала (острова) и стока (слева направо) в одноэлектронном транзисторе для закрытого (верхняя часть) и проводящего (нижняя часть) состояний. 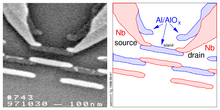 Одноэлектронный транзистор с подводящими контактами из ниобия и алюминиевым островом.
Одноэлектронный транзистор с подводящими контактами из ниобия и алюминиевым островом.Одноэлектронный транзистор (англ. Single-electron transistor, SET) — концепция транзистора, использующего возможность получения заметных изменений напряжения при манипуляции с отдельными электронами. Такая возможность имеется, в частности, благодаря явлению кулоновской блокады.
Впервые о возможности создания одноэлектронных транзисторов на основе кулоновской блокады сообщили в 1986 г. советские учёные К. К. Лихарев и Д. В. Аверин[1]. В 1996 г. российские физики С. П. Губин, В. В. Колесов, Е. С. Солдатов, А. С. Трифонов, В. В. Ханин, Г. Б. Хомутов, С. А. Яковенко впервые в мире создали одноэлектронный молекулярный нанокластерный транзистор, работающий при комнатной температуре[2].
Аналогично полевому полупроводниковому транзистору, одноэлектронный транзистор имеет три электрода: исток, сток и затвор. В области между электродами располагаются два туннельных перехода, разделённых дополнительным металлическим или полупроводниковым электродом с малой ёмкостью, который называется «островом». Остров представляет собой наночастицу или кластер нанометровых размеров, изолированный от электродов диэлектрическими прослойками, через которые и может при определённых условиях происходить движение электрона. Электрический потенциал острова может регулироваться изменением напряжения на затворе, с которым остров связан ёмкостной связью. Если приложить напряжение между истоком и стоком, то ток, вообще говоря, протекать не будет, поскольку электроны заблокированы на наночастице. Когда потенциал на затворе станет больше некоторого порогового значения, кулоновская блокада прорвётся, электрон пройдёт через барьер, и в цепи исток-сток начнёт протекать ток. При этом ток в цепи будет протекать порциями, что соответствует движению единичных электронов. Таким образом, управляя потенциалом на затворе, можно пропускать через кулоновские барьеры одиночные электроны. Количество электронов в наночастице должно быть не более 10 (а желательно и меньше). Это может быть достигнуто в квантовых структурах с размером порядка 10 нм.
Рассмотрим квантовые состояния электрона при разных потенциалах на затворе. В блокированном состоянии у электрона на истоке нет доступных энергетических уровней в пределах диапазона туннелирования (красная точка на рис. 2). Все уровни с меньшей энергией на острове заняты.
Когда к затвору прикладывается положительный потенциал, энергетические уровни на острове понижаются. Электрон (зелёный 1.) может туннелировать на остров (зелёный 2.), занимая свободный энергетический уровень. Отсюда он может туннелировать на сток (зелёный 3.), где он неупруго рассеивается и достигает на нём уровня Ферми (зелёный 4.).
Энергетические уровни на острове распределены равномерно; расстояние между ними (ΔE{\displaystyle \Delta E}) равно энергии, необходимой каждому последующему электрону для попадания на остров, обладающий ёмкостью C{\displaystyle C}. Чем ниже C{\displaystyle C}, тем больше ΔE{\displaystyle \Delta E}. Для преодоления кулоновской блокады необходимо выполнение трёх условий:
- напряжение смещения не может превышать энергии зарядки;
- тепловая энергия kBT{\displaystyle k_{B}T} должна быть ниже энергии зарядки EC=e2C{\displaystyle E_{C}={\frac {e^{2}}{C}}}, либо электрон должен пройти квантовую точку за счёт теплового возбуждения;
- сопротивление туннелирования (Rt{\displaystyle R_{t}}) должно быть больше, чем he2{\displaystyle {\frac {h}{e^{2}}}}, которое вытекает из принципа неопределённости Гейзенберга.
Одноэлектронный транзистор содержит два туннельных перехода. Фоновый заряд диэлектрика, в котором находится островок, обозначен q0{\displaystyle q_{0}}, а n1{\displaystyle n_{1}} и n2{\displaystyle n_{2}} обозначают числа электронов, туннелирующих через первый и второй туннельные переходы, соответственно.
Соответствующие заряды на первом и втором туннельных переходах и на островке можно записать как:
- q1=C1V1{\displaystyle q_{1}=C_{1}V_{1}},
- q2=C2V2{\displaystyle q_{2}=C_{2}V_{2}},
- q=q2−q1+q0=−ne+q0{\displaystyle q=q_{2}-q_{1}+q_{0}=-ne+q_{0}},
где C1{\displaystyle C_{1}} и C2{\displaystyle C_{2}} — паразитные ёмкости утечки туннельных переходов. Учитывая соотношение Vb=V1+V2{\displaystyle V_{b}=V_{1}+V_{2}}, можно получить следующие значения напряжений на туннельных переходах:
- V1=C2Vb+ne−q0CΣ{\displaystyle V_{1}={\frac {C_{2}V_{b}+ne-q_{0}}{C_{\Sigma }}}},
- V2=C1Vb−ne+q0CΣ{\displaystyle V_{2}={\frac {C_{1}V_{b}-ne+q_{0}}{C_{\Sigma }}}},
где CΣ=C1+C2{\displaystyle C_{\Sigma }=C_{1}+C_{2}}.
Электростатическая энергия двойного соединения туннельных переходов будет
- EC=q122C1+q222C2=C1C2Vb2+(ne−q0)22CΣ{\displaystyle E_{C}={\frac {q_{1}^{2}}{2C_{1}}}+{\frac {q_{2}^{2}}{2C_{2}}}={\frac {C_{1}C_{2}V_{b}^{2}+(ne-q_{0})^{2}}{2C_{\Sigma }}}}.
Работа, выполненная при туннелировании электронов через первый и второй переходы, будет соответственно:
- W1=n1eVbC2CΣ{\displaystyle W_{1}={\frac {n_{1}eV_{b}C_{2}}{C_{\Sigma }}}},
- W2=n2eVbC1CΣ{\displaystyle W_{2}={\frac {n_{2}eV_{b}C_{1}}{C_{\Sigma }}}}.
Учитывая стандартное определение свободной энергии в виде:
- F=EΣ−W{\displaystyle F=E_{\Sigma }-W},
где EΣ=EC=ΔEF+EN{\displaystyle E_{\Sigma }=E_{C}=\Delta E_{F}+E_{N}}, находим свободную энергию одноэлектронного транзистора:
- F(n,n1,n2)=EC−W=1CΣ(12C1C2Vb2+(ne−q0)2+eVbC1n2+C2n1){\displaystyle F(n,n_{1},n_{2})=E_{C}-W={\frac {1}{C_{\Sigma }}}{\big (}{\frac {1}{2}}C_{1}C_{2}V_{b}^{2}+(ne-q_{0})^{2}+eV_{b}C_{1}n_{2}+C_{2}n_{1}{\big )}}.
Для дальнейшего рассмотрения необходимо знать изменение свободной энергии при нулевых температурах на обоих туннельных переходах:
- ΔF1±=F(n±1,n1±1,n2)−F(n,n1,n2)=eCΣ[e2±(VbC2+ne−q0)]{\displaystyle \Delta F_{1}^{\pm \;}=F(n\pm \;1,n_{1}\pm \;1,n_{2})-F(n,n_{1},n_{2})={\frac {e}{C_{\Sigma }}}{\big [}{\frac {e}{2}}\pm \;(V_{b}C_{2}+ne-q_{0}){\big ]}},
- ΔF2±=F(n±1,n1,n2±1±1)−F(n,n1,n2)=eCΣ[e2±(VbC1−ne+q0)]{\displaystyle \Delta F_{2}^{\pm \;}=F(n\pm \;1,n_{1},n_{2}\pm \;1\pm \;1)-F(n,n_{1},n_{2})={\frac {e}{C_{\Sigma }}}{\big [}{\frac {e}{2}}\pm \;(V_{b}C_{1}-ne+q_{0}){\big ]}}
Вероятность туннельного перехода будет высокой тогда, когда изменение свободной энергии будет отрицательным. Основной член в приведенных выше выражениях и обусловливает положительное значение ΔF{\displaystyle \Delta F} до тех пор, пока приложенное напряжение Vb{\displaystyle V_{b}} не превысит пороговое значение, которое зависит от наименьшей из ёмкостей. В общем случае для незаряженого островка (n=0{\displaystyle n=0}, q0=0{\displaystyle q_{0}=0}) для симметричных переходов (C1=C2=C{\displaystyle C_{1}=C_{2}=C}) имеем условие
- Vth=|Vb|≥e2C{\displaystyle V_{th}=|V_{b}|\geq \;{\frac {e}{2C}}}
(то есть пороговое напряжение уменьшается в два раза по сравнению с одним переходом).
При нулевом значении приложенного напряжения, уровень Ферми на металлических электродах будет находиться внутри энергетической щели. При повышении напряжения до порогового значения возникает туннелирование слева направо, а при повышении обратного напряжения выше пороговой возникает туннелирование справа налево.
Существование кулоновской блокады четко видно на вольт-амперной характеристике одноэлектронного транзистора (графике зависимости тока стока от напряжения на затворе). При низких (по абсолютному значению) напряжениях на затворе ток стока будет равен нулю, а при повышении напряжения выше порога переходы ведут себя подобно омическому сопротивлению (случай одинаковой проницаемости переходов) и ток линейно растет. Здесь необходимо отметить, что фоновый заряд в диэлектрике может не только уменьшить, но и полностью заблокировать кулоновскую блокаду q0=±(0.5+m)e{\displaystyle q_{0}=\pm \;(0.5+m)e}.
В случае, когда проницаемость туннельных барьеров сильно отличается (RT1≫RT2=RT{\displaystyle R_{T1}\gg \;R_{T2}=R_{T}}), возникает ступенчатая ВАХ одноэлектронного транзистора. Электрон туннелирует на островок через первый переход и удерживается на нём, вследствие высокого значения туннельного сопротивления второго перехода. Через некоторый промежуток времени электрон туннелирует через второй переход, однако этот процесс вызывает туннелирование второго электрона на островок через первый переход. Поэтому бо́льшую часть времени островок заряжен с превышением одного заряда. Для случая с обратной зависимостью проницаемости (RT1≪RT2=RT{\displaystyle R_{T1}\ll \;R_{T2}=R_{T}}), островок будет незаселён и его заряд будет уменьшаться ступенчато. Только теперь можно понять принцип работы одноэлектронного транзистора. Его эквивалентную схему можно представить в виде последовательного соединения двух туннельных переходов, к точке соединения которых добавлен ещё один управляющий электрод (затвор), который соединен с островом через ёмкость управления Cg{\displaystyle C_{g}}. Электрод затвора может изменять фоновый заряд в диэлектрике, поскольку затвор дополнительно поляризует островок так, что заряд островка становится равным величине
- q=−ne+q0+Cg(Vg−V2){\displaystyle q=-ne+q_{0}+C_{g}(V_{g}-V_{2})}.
Подставляя это значение в найденные выше формулы, находим новые значения для напряжений на переходах:
- V1=(C2+Cg)Vb−CgVg+ne−q0CΣ{\displaystyle V_{1}={\frac {(C_{2}+C_{g})V_{b}-C_{g}V_{g}+ne-q_{0}}{C_{\Sigma }}}},
- V2=C1Vb+CgVg−ne+q0CΣ{\displaystyle V_{2}={\frac {C_{1}V_{b}+C_{g}V_{g}-ne+q_{0}}{C_{\Sigma }}}},
где CΣ=C1+C2+Cg{\displaystyle C_{\Sigma }=C_{1}+C_{2}+C_{g}}. Электростатическая энергия должна включать в себя энергию, сохраненную на конденсаторе затвора, а работа, выполненная напряжением на затворе, должна быть учтена в свободной энергии:
- ΔF1±=eCΣ[e2±Vb(C2+Cg)−VgCg+ne+q0]{\displaystyle \Delta F_{1}^{\pm \;}={\frac {e}{C_{\Sigma }}}{\big [}{\frac {e}{2}}\pm \;V_{b}(C_{2}+C_{g})-V_{g}C_{g}+ne+q_{0}{\big ]}},
- ΔF2±=eCΣ[e2±VbC1+VgCg−ne+q0]{\displaystyle \Delta F_{2}^{\pm \;}={\frac {e}{C_{\Sigma }}}{\big [}{\frac {e}{2}}\pm \;V_{b}C_{1}+V_{g}C_{g}-ne+q_{0}{\big ]}}.
При нуле температур разрешены только переходы с отрицательной свободной энергией: ΔF1<0{\displaystyle \Delta F_{1}<0}, или ΔF2<0{\displaystyle \Delta F_{2}<0}. Эти условия могут быть использованы для нахождения областей стабильности в плоскости Vb−Vg{\displaystyle V_{b}-V_{g}}.
При увеличении напряжения на электроде затвора, когда напряжение питания поддерживается ниже напряжения кулоновской блокады (то есть Vb<e/CΣ{\displaystyle V_{b}<e/C_{\Sigma }}), выходной ток стока будет осциллировать с периодом e/CΣ{\displaystyle e/C_{\Sigma }}. Эти области соответствуют провалам в области стабильности. Здесь необходимо отметить, что осцилляции туннельного тока протекают во времени, а осцилляции в двух последовательно соединенных переходах имеют периодичность по управляющему напряжению затвора. Тепловое уширение осцилляций растёт с ростом температуры в значительной степени.
Различные одноэлектронные приборы можно получить при увеличении количества туннельно-связанных наноостровов. Один из таких приборов — одноэлектронная ловушка. Главное свойство данного прибора — это так называемая би- или мультистабильная внутренняя зарядовая память. У одноэлектронной ловушки в пределах некоторого диапазона напряжения, прикладываемого к затвору, один из наноостровов (обычно ближайший к затвору) может быть в одном, двух или более устойчивых зарядовых состояниях, то есть содержать один, два или несколько электронов. На этой основе уже сегодня создаются различные логические элементы, которые в ближайшем будущем могут стать элементной базой нанокомпьютеров.
В 2008 году группа учёных из Манчестерского университета (А. К. Гейм, К. С. Новосёлов, Л. Пономаренко и др.) сообщила о результатах эксперимента, в котором доказана принципиальная возможность создания одноэлектронного транзистора c размерами около 10 нм. Подобный одноэлектронный транзистор может являться единичным элементом будущих графеновых микросхем. Исследователи графена считают, что можно сократить размеры квантовой точки до 1 нм, при этом физические характеристики транзистора не должны измениться[3].
Основное свойство — транзистор — Большая Энциклопедия Нефти и Газа, статья, страница 1
Основное свойство — транзистор
Cтраница 1
Основные свойства транзистора определяются соотношениями токов и напряжений в различных его цепях и взаимным их влиянием друг на друга. Транзистор может работать на постоянном токе, малом переменном сигнале, большом переменном сигнале и импульсном сигнале. [1]
Основное свойство транзистора состоит в том, что изменение значения прямого тока в одном из переходов вызывает пропорциональное изменение обратного тока в другом переходе. Это свойство позволяет использовать транзистор в качестве управляемого элемента в усилителях. [2]
Основные свойства транзистора определяются процессами в базе, и им в дальнейшем будет уделено главное внимание. Характер движения инжектированных носителей в базе в общем случае заключается в сочетании диффузии и дрейфа. [4]
Основные свойства транзистора определяются соотношениями токов и напряжении в различных его цепях, их взаимным влиянием друг на друга. [5]
Основные свойства транзистора определяются соотношениями токов и напряжений в различных его цепях и взаимным их влиянием друг на друга. Транзистор может работать на постоянном токе, малом переменном сигнале, большом переменном сигнале и импульсном сигнале. [6]
Основное свойство транзистора состоит в том, что изменение значения прямого тока в одном из переходов вызывает пропорциональное изменение обратного тока в другом переходе. Это свойство позволяет использовать транзистор в качестве управляемого элемента в усилителях. [7]
Основные свойства транзистора определяются соотношениями токов и напряжений в различных его цепях и взаимным их влиянием друг на друга. Транзистор может работать на постоянном токе, малом переменном сигнале, большом переменном сигнале и импульсном сигнале. [8]
Правило 4 определяет основное свойство транзистора: небольшой ток базы управляет большим током коллектора. [10]
Правило 4 определяет основное свойство транзистора: небольшой ток базы управляет большим током коллектора. [11]
После того как мы познакомились с основными свойствами транзисторов, возникает вопрос, в каких границах могут лежать их характеристики. [12]
Страницы: 1



