Транзистор (Реферат) — TopRef.ru
Реферат
По теме:
Транзистор
Выполнил: С. Андрей, 2ПР-1.
Понятие транзистора
Транзистор (от англ. transfеr —
переносить и резистор), полупроводниковый
прибор для усиления, генерирования и
преобразования электрических колебаний,
выполненный на основе монокристаллического
полупроводника (преимущественно Si или
Ge), содержащего не менее трех областей
с различной — электронной ( n)
и дырочной ( p)
— проводимостью. Изобретен в 1948
американцами У. Шокли, У. Браттейном и
Дж. Бардином. По физической структуре
и механизму управления током различают
транзисторы биполярные (чаще называют
просто транзисторами) и униполярные
(чаще называют полевыми транзисторами).
Во-первых, содержащих два или более
электронно-дырочных перехода, носителями
заряда служат как электроны, так и дырки,
во вторых — либо электроны, либо дырки.
Принцип действия МДП-транзистора
Физической основой работы МДП транзистора является эффект поля, который состоит в изменении концентрации свободных носителей заряда в приповерхностной области полупроводника под действием внешнего электрического поля.
Рис.1. Зонная диаграмма МДП-структуры.
а) обогащение, Vg>0,
s>0; б) обеднение, Vg<0,
s<0,| s|<| 0|; в) инверсия, V
Ток в канале МДП-транзистора, изготовленного на подложке n-типа, обусловлен свободными дырками, концентрация которых r. Электрическое поле Еy обсловлено напряжением между стоком и истоком Vd. Согласно закону Ома плотность тока канала
(1)
где q-заряд электрона, m p-подвижность
и p(x)-концентрация дырок в канале,. Проинтегрируем (1) по ширине Z и глубине
Х канала. Тогда интеграл в левой части
(1) дает полный ток канала Id, а для правой
получим
Проинтегрируем (1) по ширине Z и глубине
Х канала. Тогда интеграл в левой части
(1) дает полный ток канала Id, а для правой
получим
Величина подинтегралом — есть полный заряд дырок Qp в канале на единицу площади. Тогда Id= Wm pQp? dV/dy (3)
Найдем величину заряда дырок Qp. Запишем уравнение электронейтральности для зарядов на единицу площади в виде
Qм = Qох + Qp + QB (4)
Рис.2. Схема МОП-транзистора. Vd=0, Vg<0.
Основными элементами конструкции
МДП-транзистора являются:1)- две сильно
легированные области противоположного
с подложкой типа проводимости, сток
и исток; 2) диэлектрический
слой, отделяющий металлический электрод,
Особенности субмикронных МОП-транзисторов
Традиционная структура
МОП-транзистора обеспечила снижение
длины затвора от 10 мкм в 70-х годах до
0,06 мкм в настоящее время путём простого
масштабирования, то есть уменьшением
длины затвора, толщины диэлектрика и
глубины залегания p-n-переходов.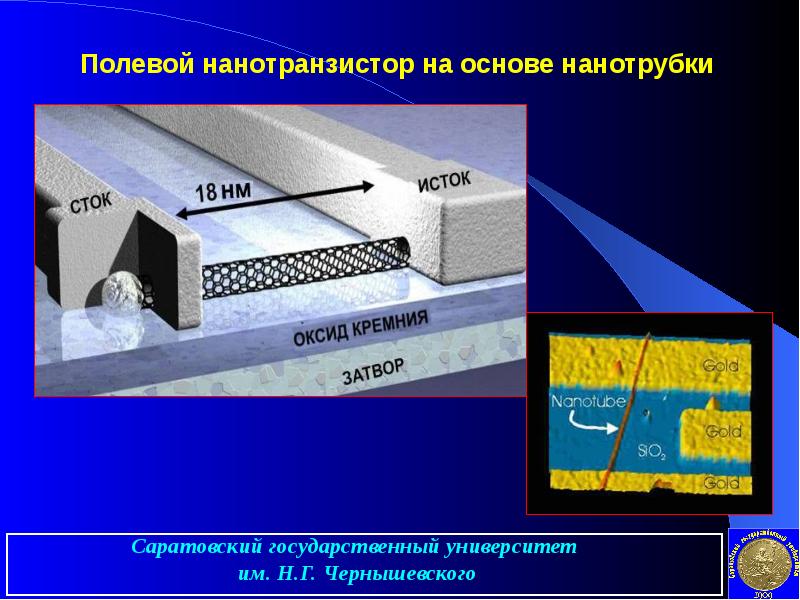 Однако
переход проектных норм через границу
130 нм в рамках традиционной конструкции
наталкивается на физические ограничения.
Таким образом, транзисторы для технологий
XXI века должны иметь иную структуру и
использовать новые материалы для
подзатворного диэлектрика.
Однако
переход проектных норм через границу
130 нм в рамках традиционной конструкции
наталкивается на физические ограничения.
Таким образом, транзисторы для технологий
XXI века должны иметь иную структуру и
использовать новые материалы для
подзатворного диэлектрика.
С уменьшением геометрических
размеров транзисторов снижается площадь
кристалла, уменьшаются паразитные
ёмкости, улучшается быстродействие и
снижается энергопотребление СБИС. За
последние 30 лет длина затвора
МОП-транзистора уменьшилась в 200 раз (с
10 мкм в начале 70-х годов до 60 нм в наши
дни) [1]. В настоящее время коммерчески
доступной является технология с
минимальными горизонтальными размерами
элементов 0,13 мкм, позволившая реализовать
массовое производство микропроцессоров
Intel Pentium 4 с тактовой частотой более 2,5
ГГц на МОП-транзисторах с длиной канала
60 нм и толщиной подзатворного окисла
1,5 нм [1]. В соответствии с прогнозами
Ассоциации предприятий полупроводниковой
индустрии NTRS, минимальные размеры
элементов будут продолжать быстро
уменьшаться и к 2012 году достигнут 50 нм.
Каждый технологический шаг в направлении уменьшения размеров сопряжён с ростом проблем конструирования и производства, которые приходится решать для обеспечения теоретически прогнозируемых характеристик транзистора. Любое улучшение одних параметров приводит к ухудшению других, причём с уменьшением размеров взаимное влияние параметров становится всё более сильным.

Особыми требованиями к «аналоговым» транзисторам являются также повышенная нагрузочная способность (ток стока в режиме насыщения), линейность и малые нелинейные искажения на малом сигнале. Для дифференциальных каскадов и токового зеркала важна согласованность характеристик транзисторов.
Основными проблемами
микроминиатюризации МОП-транзисторов
являются туннелирование через затвор,
инжекция горячих носителей в окисел,
прокол между истоком и стоком, утечки
в подпороговой области, уменьшение
подвижности носителей в канале, увеличение
последовательного сопротивления между
истоком и стоком, обеспечение запаса
между пороговым напряжением и напряжением
питания. Транзистор должен иметь слабую
зависимость порогового напряжения от
напряжения на стоке, от длины и ширины
канала, а также большую передаточную
проводимость, большое выходное
сопротивление, малое сопротивления
областей истока и стока и большую
нагрузочную способность.
Реферат — Полярные транзисторы — Рефераты на referat.store
Полярные транзисторы.
ВВЕДЕНИЕ
Действие транзистора можно сравнить с действием плотины. С помощью постоянного источника (течения реки) и плотины создан перепад уровней воды. Затрачивая очень небольшую энергию на вертикальное перемещение затвора, мы можем управлять потоком воды большой мощности, т.е. управлять энергией мощного постоянного источника.
Срок
службы полупроводниковых триодов и их
экономичность во много раз больше, чем
у электронных ламп. За счёт чего
транзисторы нашли широкое применение
в микроэлектронике —
теле-, видео-, аудио-, радиоаппаратуре
и, конечно же, в компьютерах. Они заменяют
электронные лампы во многих электрических
цепях научной, промышленной и бытовой
аппаратуры.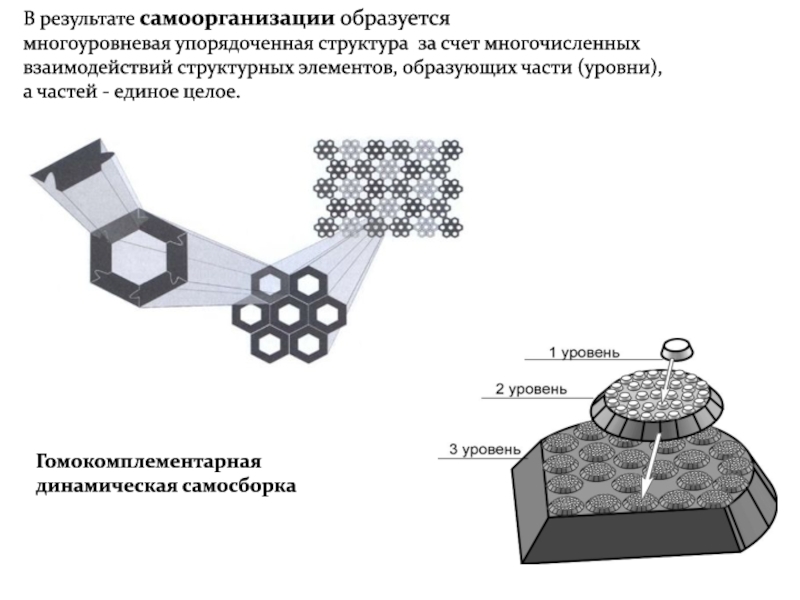
Преимущества транзисторов по сравнению с электронными лампами — те же, как и у полупроводниковых диодов — отсутствие накалённого катода, потребляющего значительную мощность и требующего времени для его разогрева. Кроме того транзисторы сами по себе во много раз меньше по массе и размерам, чем электрические лампы, и транзисторы способны работать при более низких напряжениях и более высоких частотах.
Но наряду с положительными качествами, триоды имеют и свои недостатки. Как и полупроводниковые диоды, транзисторы очень чувствительны к повышению температуры, электрическим перегрузкам и сильно проникающим излучениям (чтобы сделать транзистор более долговечным, его помещают в специальные корпуса ).
Основные материалы из которых изготовляют транзисторы — кремний и германий, перспективные – арсенид галлия, сульфид цинка и широко зонные проводники.
Существует 2 типа транзисторов: биполярные и полевые.
Рассмотрим
устройство и принцип действия полевого
транзистора МОП- структуры (Металл-
Окисел- Полупроводник), который нашел
широкое применение в качестве основного
элемента всех современных интегральных
микросхем КМОП структуры.
МОП – ТРАНЗИСТОРЫ
1. Устройство полевого транзистора.
Полевой транзистор — это полупроводниковый прибор, усилительные свойства которого обусловлены потоком основных носителей, протекающим через проводящий канал и управляемый электрическим полем. В отличие от биполярных работа полевых транзисторов основана на использовании основных носителей заряда в полупроводнике. По конструктивному исполнению и технологии изготовления полевые транзисторы можно разделить на две группы: полевые транзисторы с управляющим р- п — переходом и полевые транзисторы с изолированным затвором.
Рис.1. Структура полевого транзистора
Полевой
транзистор с управляющим р-п- переходом — это полевой
транзистор, затвор которого отделен в
электрическом отношении от канала р-п — переходом,
смещенным в обратном направлении. Электрод, из которого в канал входят
носители заряда, называют истоком;
электрод, через который из канала уходят
носители заряда, — стоком; электрод,
служащий для регулирования поперечного
сечения канала, — затвором. При подключении
к истоку отрицательного (для п-канала),
а к стоку положительного напряжения
(рис. 1 ) в канале возникает электрический
ток, создаваемый движением электронов
от истока к стоку, т.е. основными носителями
заряда. В этом заключается существенное
отличие полевого транзистора от
биполярного. Движение носителей заряда
вдоль электронно-дырочного перехода
(а не через переходы, как в биполярном
транзисторе) является второй характерной
особенностью полевого транзистора.
Электрод, из которого в канал входят
носители заряда, называют истоком;
электрод, через который из канала уходят
носители заряда, — стоком; электрод,
служащий для регулирования поперечного
сечения канала, — затвором. При подключении
к истоку отрицательного (для п-канала),
а к стоку положительного напряжения
(рис. 1 ) в канале возникает электрический
ток, создаваемый движением электронов
от истока к стоку, т.е. основными носителями
заряда. В этом заключается существенное
отличие полевого транзистора от
биполярного. Движение носителей заряда
вдоль электронно-дырочного перехода
(а не через переходы, как в биполярном
транзисторе) является второй характерной
особенностью полевого транзистора.
Электрическое
поле, создаваемое между затвором и
каналом, изменяет плотность носителей
заряда в канале, т.е. величину протекающего
тока. Так как управление происходит
через обратно смещенный р-п-переход,
сопротивление между управляющим
электродом и каналом велико, а потребляемая
мощность от источника сигнала в цепи
затвора ничтожно мала. Поэтому полевой
транзистор может обеспечить усиление
электромагнитных колебаний как по
мощности, так и по току и напряжению.
Поэтому полевой
транзистор может обеспечить усиление
электромагнитных колебаний как по
мощности, так и по току и напряжению.
Рис. 2. Структура полевого транзистора с изолированным затвором: а — с индуцированным каналом ; б — со встроенным каналом.
Полевой
транзистор с изолированным затвором — это полевой транзистор, затвор которого
отделен в электрическом отношении от
канала слоем диэлектрика. Полевой
транзистор с изолированным затвором
состоит из пластины полупроводника
(подложки) с относительно высоким
удельным сопротивлением, в которой
созданы две области с противоположным
типом электропроводности (рис. 2 ). На
эти области нанесены металлические
электроды — исток и сток. Поверхность
полупроводника между истоком и стоком
покрыта тонким слоем диэлектрика (обычно
слоем оксида кремния). На слой диэлектрика
нанесен металлический электрод — затвор.
Получается структура, состоящая из
металла, диэлектрика и полупроводника. Поэтому полевые транзисторы с изолированным
затвором часто называют МДП- транзисторами
или МОП- транзисторами (металл
— оксид- полупроводник).
Поэтому полевые транзисторы с изолированным
затвором часто называют МДП- транзисторами
или МОП- транзисторами (металл
— оксид- полупроводник).
Существуют две разновидности МДП-транзисторов с индуцированным и со встроенным каналами.
В МДП-транзисторах с индуцированным каналом проводящий канал между сильнолегированными областями истока и стока и, следовательно, заметный ток стока появляются только при определенной полярности и при определенном значении напряжения на затворе относительно истока (отрицательного при р-канале и положительного при п-канале). Это напряжение называют пороговым (UЗИ.пор ). Так как появление и рост проводимости индуцированного канала связаны с обогащением его основными носителями заряда, то считают, что канал работает в режиме обогащения.
В
МДП — транзисторах со встроенным каналом
проводящий канал, изготавливается
технологическим путем, образуется при
напряжении на затворе равном нулю. Током
стока можно управлять, изменяя значение
и полярность напряжения между затвором
и истоком. При некотором положительном
напряжении затвор — исток транзистора
с р — каналом или отрицательном напряжении
транзистора с n —каналом
ток в цепи стока прекращается. Это
напряжение называют напряжением отсечки
(UЗИ.отс ). МДП —
транзистор со встроенным каналом может
работать как в режиме обогащения, так
и в режиме обеднения канала основными
носителями заряда.
Током
стока можно управлять, изменяя значение
и полярность напряжения между затвором
и истоком. При некотором положительном
напряжении затвор — исток транзистора
с р — каналом или отрицательном напряжении
транзистора с n —каналом
ток в цепи стока прекращается. Это
напряжение называют напряжением отсечки
(UЗИ.отс ). МДП —
транзистор со встроенным каналом может
работать как в режиме обогащения, так
и в режиме обеднения канала основными
носителями заряда.
2. Схемы включения полевого транзистора.
Рис. 3. Схемы включения полевого транзистора.
Полевой
транзистор в качестве элемента схемы
представляет собой активный несимметричный
четырехполюсник, у которого один из
зажимов является общим для цепей входа
и выхода. В зависимости от того, какой
из электродов полевого транзистора
подключен к общему выводу, различают
схемы: с общим истоком и входом затвор;
с общим стоком и входом на затвор; с
общим затвором и входом на исток. Схемы
включения полевого транзистора показаны
на рис. 3.
Схемы
включения полевого транзистора показаны
на рис. 3.
По аналогии с ламповой электроникой, где за типовую принята схема с общим катодом, для полевых транзисторов типовой является схема с общим истоком.
3. Эквивалентная схема полевого транзистора.
Рис. 4. Эквивалентная схема полевого транзистора.
Эквивалентная схема полевого транзистора, элементы которой выражены через у-параметры, приведен на рис. 4. При таком подключении каждая из проводимости имеет физический смысл.
4. Параметры полевого транзистора.
Входная
проводимость определяется проводимостью
участка затвор — исток уЗИ. = у11 +
у12 ;
выходная проводимость — проводимость
участка сток — исток уСИ = у22 + у21 ; функции передачи — крутизной вольт-амперной
характеристики S =
у21 — у12 ; функция обратной передачи — проходной
проводимостью уЗС = у12. Эти параметры применяются за первичные
параметры полевого транзистора,
используемого в качестве четырехполюсника.
Если первичные параметры четырехполюсника
для схем с общим истоком определены, то
можно рассчитать параметры для любой
другой схемы включения полевого
транзистора.
Эти параметры применяются за первичные
параметры полевого транзистора,
используемого в качестве четырехполюсника.
Если первичные параметры четырехполюсника
для схем с общим истоком определены, то
можно рассчитать параметры для любой
другой схемы включения полевого
транзистора.
Начальный
ток стока IС.нач — ток стока при напряжении между затвором
и истоком, равном нулю и напряжении на
стоке, равном или превышающим напряжение
насыщения. Остаточный
ток стока IС.ост — ток стока при напряжении между затвором
и истоком, превышающем напряжение
отсечки. Ток
утечки затвора IЗ.ут — ток затвора при заданном напряжении
между затвором и остальными выводами,
замкнутыми между собой. Обратный ток перехода затвор — сток IЗСО — ток, протекающий
в цепи затвор — сток при заданном обратном
напряжении между затвором и стоком и
разомкнутыми остальными выводами. Обратный
ток перехода затвор — исток I ЗИО — ток, протекающий в цепи затвор — исток
при заданном обратном напряжении между
затвором и истоком и разомкнутыми
остальными выводами.
Напряжение отсечки полевого транзистора UЗИ.отс — напряжениемежду затвором и истоком транзистора с р -п переходом или изолированным затвором, работающего в режиме обеднения, при котором ток стока достигает заданного низкого значения. Пороговое напряжение полевого транзистора UЗИ.пор — напряжение между затвором и истоком транзистора с изолированным затвором, работающего в режиме обогащения, при котором ток стока достигает заданного низкого значения.
Крутизна характеристик полевого транзистора S — отношение изменения тока стока к изменению напряжения на затворе при коротком замыкании по переменному току на выходе транзистора в схеме с общим истоком.
Входная
емкость полевого транзистора С11и — емкость между затвором и истоком при
коротком замыкании по переменному току
на выходе в схеме с общим истоком. Выходная
емкость полевого транзистора С22и — емкость между стоком и истоком при
коротком замыкании по переменному току
на входе в схеме с общим истоком. Проходная
емкость полевого транзистора C12и — емкость
между затвором и стоком при коротком
замыкании по переменному току на входе
в схеме с общим истоком. Емкость
затвор -сток СЗСО — емкость между затвором и стоком при
разомкнутых по переменному току остальных
выводах. Емкость
затвор — исток СЗИО емкость между затвором и истоком при
разомкнутых по переменному току остальных
выводах.
Проходная
емкость полевого транзистора C12и — емкость
между затвором и стоком при коротком
замыкании по переменному току на входе
в схеме с общим истоком. Емкость
затвор -сток СЗСО — емкость между затвором и стоком при
разомкнутых по переменному току остальных
выводах. Емкость
затвор — исток СЗИО емкость между затвором и истоком при
разомкнутых по переменному току остальных
выводах.
Коэффициент усиления по мощности Кур — отношение мощности на выходе полевого транзистора к мощности на входе при определенной частоте и схеме включения.
4.1. Частотные свойства.
Частотные
свойства полевых
транзисторов определяются постоянной
времени RC — цепи затвора. Поскольку входная емкость С11и у транзисторов с р-п переходом
велика (десятки пикофарад), их применение
в усилительных каскадах с большим
входным сопротивлением возможно в
диапазоне частот, ре превышающих сотен
килогерц — единиц мегагерц.
При работе в переключающих схемах скорость переключения полностью определяется постоянной времениRC — цепи затвора. У полевых транзисторов с изолированным затвором входная емкость значительно меньше, поэтому их частотные свойства намного лучше, чем у полевых транзисторов с р-п — переходом.
Граничная частота определяется по формулеfгр.=159/С11и, где fгр = частота, МГц; S — крутизна характеристики транзистора, мА/В; С11и — емкость между затвором и истоком при коротком замыкании по переменному току выходной цепи, пФ.
4.2. Шумовые свойства.
Шумовые
свойства полевых транзисторов оцениваются
коэффициентом шума КШ,
который мало зависит от напряжения сток
— исток, тока стока и окружающей температуры
(ниже 50 0 С) и монотонно возрастает с уменьшением
частоты и внутреннего сопротивления
источника сигнала. Коэффициент шума
измеряют в заданном режиме по постоянному
току UСИ, ICна определенной
частоте.
Коэффициент шума
измеряют в заданном режиме по постоянному
току UСИ, ICна определенной
частоте.
Вместо коэффициента шума иногда указывают шумовое напряжение полевого транзистора Uш — эквивалентное шумовое напряжение, приведенное ко входу, в полосе частот при определенном полном сопротивлении генератора в схеме с общим истоком; шумовой ток Iш — эквивалентный шумовой ток, приведенный ко входу, при разомкнутом входе в полосе частот в схеме с общим истоком.
4.3. Тепловые параметры.
Тепловые параметры полевого транзистора характеризуют его устойчивость при работе в диапазоне температур. При изменении температуры свойства полупроводниковых материалов изменяются. Это приводит к изменению параметров полевого транзистора, в первую очередь, тока стока, крутизны и тока утечки затвора.
Зависимость
изменения тока стока от температуры
определяется двумя факторами: контактной
разностью потенциалов р-п перехода
и изменением подвижности основных
носителей заряда в канале. При повышении
температуры контактная разность
потенциалов уменьшается, сопротивление
канала падает, а ток увеличивается. Но
повышение температуры приводит к
уменьшению подвижности носителей заряда
в канале и тока стока. При определенных
условиях действие этих факторов
взаимнокомпенсируется и ток полевого
транзистора перестает зависеть от
температуры. На рис. 5. приведены
стокозатворные характеристики при
различных температурах окружающей
среды и указано положение термостабильной
точки.
При повышении
температуры контактная разность
потенциалов уменьшается, сопротивление
канала падает, а ток увеличивается. Но
повышение температуры приводит к
уменьшению подвижности носителей заряда
в канале и тока стока. При определенных
условиях действие этих факторов
взаимнокомпенсируется и ток полевого
транзистора перестает зависеть от
температуры. На рис. 5. приведены
стокозатворные характеристики при
различных температурах окружающей
среды и указано положение термостабильной
точки.
Рис. 5. Сток — затворные характеристики полевого транзистора при разных температурах.
Зависимость
крутизны характеристики от температуры
у полевых транзисторов такая же как и
у тока стока. С ростом температуры ток
утечки затвора увеличивается. Хотя
абсолютное изменение тока незначительно,
его надо учитывать при больших
сопротивлениях в цепи затвора. В этом
случае изменение тока утечки затвора
может вызвать существенное изменение
напряжения на затворе полевого транзистора
и режима его работы. Температурная
зависимость тока утечки затвора полевого
транзистора с р-п переходом приведена на рис. 6.
Температурная
зависимость тока утечки затвора полевого
транзистора с р-п переходом приведена на рис. 6.
рис. 6. Зависимость тока утечки затвора полевого транзистора от температуры.
В полевом транзисторе с изолированным затвором ток затвора практически не зависит от температуры.
4.4. Максимально допустимые параметры.
Максимально
допустимые параметры определяют значения
конкретных режимов полевых транзисторов,
которые не должны превышаться при любых
условиях эксплуатации и при которых
обеспечивается заданная надежность. К
максимально допустимым параметрам
относятся: максимально допустимое
напряжение затвор — исток UЗИmax,
затвор — сток UЗСmax,
сток — исток UСИmax, максимально допустимое напряжение сток
— подложка UСПmax, исток — подложка UИПmax,
затвор — подложка UЗПmax. Максимально
допустимый постоянный ток стока IСmax максимально
допустимый прямой ток затвора IЗ(пр)max, максимально допустимая постоянная
рассеиваемая мощность Рmax.
Максимально
допустимый постоянный ток стока IСmax максимально
допустимый прямой ток затвора IЗ(пр)max, максимально допустимая постоянная
рассеиваемая мощность Рmax.
4.5. Вольт – амперные характеристики полевых транзисторов.
Рис. 7. Вольт – амперные характеристики полевого транзистора со встроеным каналом n-типа: а – стоковые; б – стоко – затворные.
Вольт — амперные характеристики полевых транзисторов устанавливают зависимость тока стока ICот одного из напряжений UСИ или UЗИ при фиксированной величине второго.
В
МДП — транзисторе с индуцированным
каналом с подложкой р-типа
при UЗИ = 0 канал п-типа
может находиться в проводящем состоянии.
При некотором пороговом напряжении UЗИ. ПОР < 0 за счет обеднения канала основными
носителями проводимость его значительно
уменьшается. Статические стоковые
характеристики в этом случае будут
иметь вид, изображенный на рис. 7, а стоко
— затворная характеристика пересекает
ось ординат в точке со значением тока IC.НАЧ.
ПОР < 0 за счет обеднения канала основными
носителями проводимость его значительно
уменьшается. Статические стоковые
характеристики в этом случае будут
иметь вид, изображенный на рис. 7, а стоко
— затворная характеристика пересекает
ось ординат в точке со значением тока IC.НАЧ.
Особенностью МДП — транзистора с индуцированным каналом п — типа является возможность работы без постоянного напряжения смещения ( U ЗИ = 0) в режиме как обеднения, так и обогащения канала основными носителями заряда. МДП — транзистор с встроенным каналом имеет вольт-амперные характеристики, аналогичные изображенным на рис. 7.
У
МДП — транзисторов всех типов потенциал
подложки относительно истока оказывает
заметное влияние на вольт -амперные
характеристики и соответственно
параметры транзистора. Благодаря
воздействию на проводимость канала
подложка может выполнять функцию
затвора. Напряжение на подложке
относительно истока должно иметь такую
полярность, чтобы р-п переход
исток — подложка включался в обратном
направлении. При этом р-п переход канал — подложка действует как
затвор полевого транзистора с управляющим р-п переходом.
Напряжение на подложке
относительно истока должно иметь такую
полярность, чтобы р-п переход
исток — подложка включался в обратном
направлении. При этом р-п переход канал — подложка действует как
затвор полевого транзистора с управляющим р-п переходом.
5. Рекомендации по применению полевых транзисторов.
Рекомендации
по применению полевых транзисторов. Полевые
транзисторы имеют вольт-амперные
характеристики, подобные ламповым, и
обладают всеми принципиальными
преимуществами транзисторов. Это
позволяет применять их в схемах, в
большинстве случаев использовались
электронные лампы, например, в усилителях
постоянного тока с высокоомным входом,
в истоковых повторителях с особо
высокоомным входом, в электрометрических
усилителях, различных реле времени, RS — генераторах синусоидальных колебаний
низких и инфранизких частот, в генераторах
пилообразных колебаний, усилителях
низкой частоты, работающих от источников
с большим внутренним сопротивлением,
в активных RC — фильтрах низких частот. Полевые
транзисторы с изолированным затвором
используют в высокочастотных усилителях,
смесителях, ключевых устройствах.
Полевые
транзисторы с изолированным затвором
используют в высокочастотных усилителях,
смесителях, ключевых устройствах.
В рекомендации по использованию транзисторов для случая полевых транзисторов следует внести дополнения:
1. На затвор полевых транзисторов с р-п ( отрицательное для транзисторов с р — каналом и положительным для транзистора с п — каналом).
2. Полевые транзисторы с изолированным затвором следует хранить с закороченными выводами. При включении транзисторов в схему должны быть приняты все меры для снятия зарядов статического электричества. Необходимую пайку производить на заземленном металлическом листе, заземлить жало паяльника, а так же руки монтажника при помощи специального металлического браслета. Не следует применять одежду из синтетических тканей. Целесообразно подсоединять полевой транзистор к схеме, предварительно закоротив его выводы.
Транзисторы: открытие и применение (кратко) | Физика. Закон, формула, лекция, шпаргалка, шпора, доклад, ГДЗ, решебник, конспект, кратко
Тема: Транзисторы
| Рис. 8.20. Внешний вид транзистора |
Еще в 1921 — 1925 гг. сотрудник Нижегородской лаборатории О. Лосев показал, что с помощью полупроводниковых приборов можно усиливать и генерировать электромагнитные колебания. Однако в те времена интенсивно развивалась электроника с использованием электронных ламп, и основное внимание физиков было обращено на них. Тем не менее, вскоре оказалось, что возможности электронных ламп в некоторых областях техники были довольно быстро исчерпаны.
И вот в 1948 г. Шокли, Бардин и Браттейн (США) открыли так называемый транзисторный эффект и создали первый транзистор, или полупроводниковый триод, который успешно работал.
Транзистор (англ. transistor, от trans(fer) — переносить и re(sistor) — сопротивление) — полупроводниковый прибор.
За эту работу упомянутым ученым в 1956 г. была присуждена Нобелевская премия по физике. Материал с сайта http://worldofschool.ru
Транзистор имеет ряд преимуществ перед другими приборами, использующимися в электронике. Он начинает работать сразу после включения, имеет высокий коэффициент полезного действия, может работать при низких напряжениях питания, имеет небольшие размеры и высокую надежность.
Транзисторы сегодня применяются в радиоприемниках, телевизорах, электронно-вычислительных машинах, устройствах автоматики и др. (рис. 8.20).
На этой странице материал по темам:Транзисторы реферат кратко
Строение и применение транзисторов краткое содержание
Транзистор кратко
Все по теме транзисторы кратко физика
Реферат по физике на тему транзисторы
Кто создал первый транзистор?
Где используют транзисторы?
Полевые транзисторы с управляющим P-N переходом
Основная часть
- УСТРОЙСТВО И ПРИНЦИП ДЕЙСТВИЯ ПОЛЕВЫХ ТРАНЗИ-
СТОРОВ С УПРАВЛЯЮЩИМ P-N ПЕРЕХОДОМ
Все задачи, которые решаются с помощью электронных приборов в практических схемах, по существу сводятся к управлению потоком носителей заряда. Естественно, что при выборе того или иного прибора предпочтение отдается такому, у которого при прочих равных условиях меньше затраты мощности для управления, меньше токи в цепи управления.
У биполярных транзисторов сравнительно мало входное сопротивление в основных схемах включения с ОЭ и особенно с ОБ, поэтому в цени управления протекают сравнительно большие токи, особенно в схеме с ОБ, и требуется значительная мощность
[pic 1]
Рис.1. К пояснению
создания полевого
транзистора на основе
биполярного
для управления потоком носителей заряда. Поэтому возникла задача — создать полупроводниковый прибор с большим входным сопротивлением, минимальным потреблением тока и мощности на входе для управления потоком носителей заряда. Как решается подобная задача? Напомним, что у биполярных транзисторов в активном режиме работы эмиттерный переход открыт, потенциальный барьер компенсируется, входное сопротивление уменьшается. Для того чтобы входное сопротивление было велико, чтобы не было тока в цепи управления, а следовательно, и затрат мощности, необходимо, чтобы входной PN-переход был закрыт, находился под обратным напряжением. В биполярном транзисторе это соответствует режиму отсечки, при котором транзистор не поддается управлению. Эта задача — создание полупроводникового прибора с РN-переходом на входе, работающим при обратном напряжении, была решена с помощью полевых транзисторов. Чтобы лучше уяснить принцип работы полевого транзистора, рассмотрим биполярный транзистор, например, типа PNP, у которого к двум концам продольного сечения базы подключен источник питания, коллектор и эмиттер соединены между собой и образуют с базой РN-переходы, на которые подается обратное напряжение (рис.1).
Концентрация примесей в базе гораздо меньше, чем в эмиттере и коллекторе, поэтому при подаче обратного напряжения PN-переход в основном расположится в базе. Напомним, что при различных концентрациях примесей PN-переход при подаче обратного напряжения расширяется в направлении области с меньшей концентрацией примеси. Не занятая переходом область в базе является токопроводящим каналом. Очевидно, что чем больше обратное напряжение, приложенное к PN-переходу, тем шире РN-переход, и, следовательно, меньше сечение токопроводящего канала, что ведет к увеличению его сопротивления. Таким образом, управление в данном приборе сводится к изменению обратного напряжения, приложенного к РN-переходу, в результате меняется сопротивление токопроводящего канала и, следовательно, его ток. Вместе с тем благодаря тому, что входной РN-переход, на который подаются сигналы управления, включен под обратное напряжение, его сопротивление остается постоянно большим, т. е. для управления практически не требуется тока (если не считать незначительного обратного тока неосновных носителей РN-перехода) и мощности.
Рассмотрим, как практически реализуется идея, изложенная выше. Полевой транзистор, в котором управление осуществляется с помощью изменения обратного напряжения, подаваемого на управляющий РN-переход, состоит из токопроводящего канала с двумя выводами, которые получили названия исток и сток . Токопроводящий канал находится между двумя областями противоположной проводимости, в данном случае Р-типа, с которым он образует два РN-перехода. Эти области соединяются между собой и имеют один вывод — затвор.
Имеются также полевые транзисторы с токопроводящим Р- каналом, который в этом случае расположен между двумя N-областями. Таким образом, токопроводящий канал и окружающие его области противоположной полярности образуют два РN-перехода. Концентрация примеси в токопроводящем канале гораздо ниже, чем в областях, соединенных с затвором. На участках канала, примыкающих к электродам сток и исток, создается повышенная концентрация примесей — [pic 2], чтобы уменьшить их сопротивление и, следовательно, падение напряжения на них. Условное обозначение полевого транзистора с управляющим РN-переходом показано на рис. 3: а—с N-каналом, б—с Р- каналом.
4.6 HEMT-транзисторы. Введение в наноэлектронику
Похожие главы из других работ:
Введение в наноэлектронику
4.2 КНИ-транзисторы
КНИ-транзисторы (кремний на изоляторе) имеют полностью или частично обедненное носителями основание. Вследствие обеднения подложки зарядами электрическое поле в инверсионном слое прибора существенно меньше…
Введение в наноэлектронику
4.3 Транзисторы с двойным затвором
В таких транзисторах удалось увеличить ток транзистора. FinFET-транзистор с двойным затвором представлен на рисунке 9. Рисунок 9 — Структура FinFET-транзистора Затвор формирует два самосовмещающихся канала…
Введение в наноэлектронику
4.5 Полевые транзисторы
Полевые транзисторы (Field-Effect Transistor), или FET-транзисторы, характеризуются максимальной удельной крутизной ВАХ и предельной частотой. На рисунке 12 изображен n-канальный полевой транзистор с затвором Шоттки на арсенид-галиевой структуре (MESFET)…
Введение в наноэлектронику
4.7 MODFET-транзисторы
Данные транзисторные структуры создаются на основе Si-SiGe. Рассогласование постоянных решетки составляет 4,2%, что вызывает механические напряжения в тонком слое гетероструктуры…
Запираемые тиристоры и полевые транзисторы
Транзисторы с изолированным затвором (МДП-транзисторы)
Рис. 2. Устройство полевого транзистора с изолированным затвором. Полевой транзистор с изолированным затвором — это полевой транзистор, затвор которого отделён в электрическом отношении от канала слоем диэлектрика…
Идентификация параметров математических моделей биполярных транзисторов КТ209Л, КТ342Б и полевого транзистора КП305Е
Полевые транзисторы
…
Идентификация параметров математических моделей биполярных транзисторов КТ209Л, КТ342Б и полевого транзистора КП305Е
Биполярные транзисторы
Теоретические сведения по биполярным транзисторам Биполярные транзисторы можно определить как полупроводниковые приборы, управляемые током (под этим понимается…
Полевые транзисторы и их применение
1.4 Транзисторы с изолированным затвором (МДП-транзисторы)
Эти приборы имеют затвор в виде металлической плёнки, которая изолирована от полупроводника слоем диэлектрика. В качестве диэлектрика применяется окись кремния…
Полупроводниковые приборы
4. Транзисторы
Транзистор — это электронный прибор на основе полупроводникового кристалла, имеющий три (или более) вывода, предназначенный для генерирования и преобразования электрических колебаний…
Полупроводниковые приборы
4.1 Биполярные транзисторы
Биполярным транзистором (БТ) называется полупроводниковый прибор с двумя взаимодействующими электрическими p-n-переходами и тремя выводами. Усилительные свойства БТ обусловлены движением неосновных носителей обоих знаков (электронов и дырок)…
Полупроводниковые приборы
4.2 Полевые транзисторы
Полевые транзисторы представляют собой полупроводниковые приборы, в которых прохождение тока обусловлено дрейфом основных носителей заряда только одного знака (электронами или дырками) под действием продольного электрического поля…
Разработка компьютерных аналогов схем исследования биполярных транзисторов
6.1 МДП полевые транзисторы
…
Разработка устройства логического управления
3.2 Транзисторы VT1,VT2 -КП812А
Общие сведения о данных транзисторах занесены в таблицу (таблица 3): Таблица 3 Тип транзистора КП812А: КП — транзистор полевой; 812 — номер серии; Структура N-FET Макс. напр. сток-исток, В 60 Макс. ток сток-исток, А 50 Макс. напр…
Синтезатор частоты УКВ радиостанции
3.3 Транзисторы
VT1, VT2 — кремниевый биполярный, тип КТ3102, КТ3156 (рисунок 3.1). Рисунок 3.1 — транзистор КТ3102 Тип: n-p-n Uкбо(и),В: 50 Uкэо(и), В: 50 Iкmax(и), мА: 100(200) Pкmax(т), Вт: 0.25 h31э: 100-200 Iкбо, мкА: меньше 0,05 fгр., МГц: больше 150 VT2 — кремниевый биполярный, тип КТ3685 (рисунок 3.2)…
Транзисторы на горячих электронах
3. Транзисторы на горячих электронах
К настоящему времени разработаны два типа транзисторов, для работы которых существенное значение имеет тот факт, что электроны, пролетающие через канал или базу, являются горячими, т. е. имеют кинетическую энергию значительно выше равновесной…
Читать реферат по электротехнике: «Полупроводниковые приборы (тиристоры,транзисторы, диоды)» Страница 1
(Назад) (Cкачать работу)
Функция «чтения» служит для ознакомления с работой. Разметка, таблицы и картинки документа могут отображаться неверно или не в полном объёме!
Транзисторы
Свойства p—n-пеpехода можно использовать для создания усилителя электрических колебаний, называемого полупроводниковым триодом или тpанзистоpом.В полупроводниковом триоде две p-
-области кристалла разделяются узкой n-
-областью. Такой триод условно обозначают p—n—p. Можно делать и n—p—n тpиод, т.е. pазделять две n-области кpисталла узкой p-
-областью (рис. 1).
Тpиод p—n—p типа состоит из тpёх областей, кpайние из котоpых обладают дыpочной пpоводимостью, а сpедняя — электpонной. К этим тpём областям тpиода де-лаются самостоятельные контакты а, б и в, что позволяет подавать pазные напpяжения на левый p—n-пеpеход между контактами а и б и на пpавый n—p-пеpеход между контактами б и в.
Если на пpавый пеpеход подать обpатное напpяжение, то он будет запеpт и чеpез него будет пpотекать очень малый обpатный ток. Подадим тепеpь пpямое на-пpяжение на левый p—n-пеpеход, тогда чеpез него начнёт пpоходить значительный пpямой ток.
Одна из областей тpиода, напpимеp левая, содеpжит обычно в сотни pаз большее количество пpимеси p-типа, чем количество n-пpимеси в n-области. Поэтому прямой ток через p—n-пеpеход будет состоять почти исключительно из дыpок, движущихся слева напpаво. Попав в n-область тpиода, дыpки, совеpшающие тепловое движение, диффундируют по направлению к n—p-переходу, но частично успевают претерпеть рекомбинацию со свободными электронами n-области. Но если n-область узка и свободных электронов в ней не слишком много (не ярко выраженный проводник n-типа), то большинство дырок достигнет второго перехода и, попав в не-го, переместится его полем в правую p-область. У хороших триодов поток дырок, проникающих в правую p-область, составляет 99% и более от потока, проникающего слева в n-область.
Если при отсутствии напряжения между точками а и б обратный ток в n— p-
-переходе очень мал, то после появления напряжения на зажимах а и б этот ток поч-ти так же велик, как прямой ток в левом переходе. Таким способом можно управлять силой тока в правом (запертом) n—p-переходе с помощью левого p—n-перехода. Запирая левый переход, мы прекращаем ток через правый переход; открывая левый переход, получаем ток в правом переходе.Изменяя величину прямого напряжения на левом переходе, мы будем изменять тем самым силу тока в правом переходе. На этом и основано применение p—n—p-триода в качестве усилителя.
При работе триода (рис. 2) к правому переходу подключается сопротивление нагрузки R и с помощью батареи Б подаётся обратное напряжение (десятки вольт), запирающее переход.При этом через переход протекает очень малый обратный ток, а всё напряжение батареи Б прикладывается к n—p-переходу. На нагрузке же напряжение равно нулю. Если подать теперь на левый переход небольшое прямое напряжение, то через него начнёт протекать небольшой прямой ток. Почти такой же ток начнёт протекать и через правый переход, создавая падения напряжения на сопротивлении нагрузки R. Напряжение на правом n—p-переходе при этом уменьшается, так как теперь часть напряжения батареи падает на сопротивлении нагрузки.
При увеличении прямого напряжения на левом переходе увеличивается ток через правый переход и растёт напряжение на сопротивлении нагрузки R. Когда левый p—n-переход открыт, ток через правый n—p-переход делается настолько большим, что значительная
3 Спин-полевые транзисторы
Спинтроника — научно-техническое направление, связанное с возникающими при спин-зависимом транспорте явлениями и с их применением для создания электронных приборов.
В спинтронике спин электрона, как и его заряд, используется для обработки информации. Интерес к спинтронным приборам вызван тем, что они могут быть базовыми логическими элементами квантовых компьютеров. Спиновые эффекты возникают в микроэлектронных и наноэлектронных структурах при помещении их в магнитное поле. Главным из них является изменение электрического сопротивления материала или структуры под воздействием магнитного поля. Магнетосопротивление характеризует спиновые эффекты при туннелировании, диффузионном и баллистическом транспорте носителей.
Спинтроника изучает магнитные и магнитооптические взаимодействия в металлических и полупроводниковых наногетероструктурах, динамику и когерентные свойства спинов в конденсированных средах, а также квантовые магнитные явления в структурах нанометрового размера. Химические, литографические и молекулярно-кластерные технологии позволяют создавать для спинтроники наноструктуры с необходимыми магнитными свойствами. Наноструктуры могут состоять из чередующихся квантовых слоев или квантовых точек, в которых возникают такие явления, как спин-зависимое рассеяние электронов проводимости, косвенная обменная связь, поверхностная магнитная анизотропия.
Рисунок 10 — Структура спин-полевого транзистора
Структура этих транзисторов подобна обычному полевому транзистору, но области истока и стока создаются из ферромагнетиков, а затвор — из полупроводника. Принцип работы такого транзистора иллюстрирует рисунок 10, где стрелки, ориентированные по оси y, показывают направление эффективного магнитного поля By в канале. Спин-поляризованные носители покидают исток со спинами, параллельными намагниченности феррамагнетика (в направлении z), перемещаются в направлении х с волновым вектором k = (kx, 0, 0), а их спины при этом движении прецессируют, что иллюстрируется поворотом магнитных стрелок на рисунке 10. При этом электроны движутся со скоростью, составляющей 1% от скорости света в вакууме. Основная идея рассматриваемого спинового транзистора состоит в том, что поляризация спинов электрона в истоке выбрана перпендикулярной к вектору B = (0, By, 0), т. е. электроны в истоковом контакте поляризованы в +z направлении. Если стоковый контакт является также ферромагнитным, то электроны покидают полупроводниковый канал и попадают в стоковую область только при условии, что спиновая ориентация, т. е. направление вектора <S̅> электронов при x = L согласовано с поляризацией P̅С стокового контакта, т. е. cos χ = P̅С <S̅> ≈ 1, где χ — определяет угол между векторами P̅С и <S̅>. Близкое к единице значение cоs χ указывает на то, что электроны могут легко покидать полупроводниковый канал, в то время как при такой же по модулю отрицательной величине cos χ спин-поляризованный электронный ток подавлен.
Таким образом, если величина напряженности магнитного поля достаточно велика, то спины электронов в канале изменяют ориентацию на противоположную. В результате сопротивление канала возрастает и ток стока уменьшается. При изменении напряжения на затворе происходит изменение проводимости канала и тока стока IС.
| Скачать полную версию статьи (в формате PDF) Ю. О. Кругляк Номера PACS: 72.20.Dp, 73.23.Ad, 73.40.-c, 73.50.Bk, 84.32.Ff, 85.30.De, 85.35.-p Как показано, модель передачи может быть тесно связана с моделью виртуального источника.Путем простой замены диффузионной подвижности в модели виртуального источника кажущейся подвижностью для линейного тока мы получаем правильные результаты от баллистического предела до предела диффузии. Заменяя скорость насыщения, ограниченную рассеянием, на скорость впрыска, мы получаем правильное значение тока. Сравнение экспериментально измеренных характеристик показывает, что нанотранзисторы на кремниевой подложке работают очень далеко от баллистического предела, в то время как наноразмерные полевые транзисторы IIIV работают очень близко к баллистическому пределу.По модели прохождения есть два серьезных недостатка. Один из них обусловлен сложностью расчета зависимости из-за проблем с расчетом зависимости. Другой связан с трудностями в прогнозировании тока, что, в свою очередь, связано с трудностью вычисления критической длины при высоком напряжении на стоке; из-за этого трудно предсказать величину. Из-за этих ограничений модель передачи и модель виртуального источника комбинируются таким образом, что параметры модели передачи берутся из вставки экспериментальных результатов в модель виртуального источника, а физический смысл параметров принимается от модели трансмиссии.Показано, как можно анализировать вольт-амперные характеристики нанотранзисторов на основе модели MVS / проход. Многообразие типов транзисторов порождает новые частные проблемы; Однако принципиально методология анализа экспериментальных данных не меняется. Как подчеркнуто, применение модели МВС / трансмиссии оправдано, если транзистор собран качественно. Для таких транзисторов модель позволяет надежно получать физически значимые параметры. Ключевые слова: наноэлектроника, полевой транзистор, MOSFET, модель LDL, параметры транзистора, модель MVS / передачи. https://doi.org/10.15407/nnn.17.02.255 Список литературы 1. Ю. Кругляк А.А., Наносистемы, Наноматериалы, Нанотехнологии, 17, № 2: 225 (2019). 2. Ю. Кругляк А.А., Наносистемы, Наноматериалы, Нанотехнологии, 17, № 1: 57 (2019). 3. П.Палестри, Д. Эссени, С. Эминенте, К. Фигна, Э. Санджорджи и Л. Селми, IEEE Trans. Электронная разработка, 52: 2727 (2005). https://doi.org/10.1109/TED.2005.859593 4. П. Палестри, Р. Клерк, Д. Эссени, Л. Луччи и Л. Селми, Intern. Электрон Дев. Mtg. (IEDM), Технический сборник, 945 (2006). 5. Р. Клерк, П. Палестри, Л. Селми и Г. Гибаудо, J. Appl. Физ., 110: 104502 (2011). https://doi.org/10.1063/1.3660769 6. Ю. Кругляк, Наносистемы, Наноматериалы, Нанотехнологии, 17, вып.1: 25 (2019). 7. М. Лундстром, Основы перевозки грузов (Кембридж, Великобритания: Cambridge Univ. Press: 2000). https://doi.org/10.1017/CBO9780511618611 8. Я. Цивидис, К. МакЭндрю, Работа и моделирование МОП-транзистора (Нью-Йорк: Oxford Univ. Press: 2011). 9. Лим К. Ю., Чжоу Х., Твердотельная электроника, 45: 193 (2001). https://doi.org/10.1016/S0038-1101(00)00190-8 10. М. Дж. Чен, Х. Т. Хуанг, К. К. Хуанг, П.Н. Чен, С. С. Чанг и К. Х. Диаз, Intern. Электрон Дев. Mtg. (IEDM), Технический дайджест, 39 (2002). 11. В. Барраль, Т. Пуару, М. Винэ, Дж. Видьез, Б. Превитали, П. Гросжорж, Г. Ле Карваль, С. Барро, Дж. Л. Отран, Д. Мунтяну и С. Делеонибус, Solid State Электрон., 51: 537 (2007). https://doi.org/10.1016/j.sse.2007.02.016 12. Зилли М., Палестри П., Эссени Д. и Селми Л., Междунар. Электрон Дев. Mtg. (IEDM), Технический сборник, 105 (2007). 13.R. Wang, H. Liu, R. Huang, J. Zhuge, L. Zhang, D. W. Kim, X. Zhang, D. Park и Y. Wang, IEEE Trans. Электронная разработка, 55: 2960 (2008). https://doi.org/10.1109/TED.2008.2005152 14. В. Барраль, Т. Пуару, Дж. Сен-Мартен, Д. Мунтяну, Дж. Л. Отран и С. Делеонибус, IEEE Trans. Электронная разработка, 56: 408 (2009). https://doi.org/10.1109/TED.2008.2011681 15. В. Барраль, Т. Пуару, Д. Мунтяну, Дж. Л. Отран и С. Делеонибус, IEEE Trans. Электронная разработка, 56: 420 (2009).https://doi.org/10.1109/TED.2008.2011682 16. Хакифируоз А., Антониадис Д. А., Междунар. Электрон Дев. Mtg. (IEDM), Технический дайджест, 667 (2006). 17. А. Хакифируоз, Д. А. Антониадис, IEEE Trans. Электронная разработка, 55: 1391 (2008). https://doi.org/10.1109/TED.2008.921017 18. А. Хакифируоз, Д. А. Антониадис, IEEE Trans. Электронная разработка, 55: 1401 (2008). https://doi.org/10.1109/TED.2008.921026 19. Д. Х. Ким, Дж. А. дель Аламо, Д.А. Антониадис, Б. Брар, Междунар. Электрон Дев. Mtg. (IEDM), Технический сборник, 861 (2009). 20. А. Маджумдар, Д. А. Антониадис, IEEE Trans. Электронная разработка, 61: 351 (2014). https://doi.org/10.1109/TED.2013.2294380 21. S. Rakheja, M. Lundstrom, D. Antoniadis, Intern. Электрон Дев. Mtg. (IEDM), Технический дайджест, 35.1.1 (2014). 22. A. Majumdar, Z. Ren, S.J. Koester, W. Haensch, IEEE Trans. Электронная разработка, 56: 2270 (2009). https: // doi.org / 10.1109 / TED.2009.2028057 23. A. Majumdar, X. Wang, A. Kumar, J. R. Holt, D. Dobuzinsky, R. Venigalla, C. Ouyang, S.J. Koester, W. Haensch, IEEE Electron Dev. Lett., 30: 413 (2009). https://doi.org/10.1109/LED.2009.2014086 24. Д. Х. Ким, Дж. А. дель Аламо, IEEE Electron Dev. Lett., 29: 830 (2008). https://doi.org/10.1109/LED.2008.2000794 25. А. Хакифируоз, О. М. Найфех, Д. А. Антониадис, IEEE Trans. Электронная разработка, 56: 1674 (2009).https://doi.org/10.1109/TED.2009.2024022 26. Ш. Рахеджа и Д. Антониадис, Модель нанотранзистора MVS 1.0.1 (кремний). www.nanohub.org/resources/19684. 27. Ш. Рахеджа, Д. Антониадис, Модель нанотранзистора MVS (кремний) 1.1.1. www.nanohub.org/publications/15/4. 28. Ю. Кругляк А.А., Наносистемы, Наноматериалы, Нанотехнологии, 16, № 4: 599 (2018). 29. Таур Ю., Нинг Т. Основы современных устройств СБИС.Пресса: 2013). 30. M. S. Lundstrom, IEEE Electron Dev. Lett., 18: 361 (1997). https://doi.org/10.1109/55.596937 31. Ю. Кругляк, Наносистемы, Наноматериалы, Нанотехнологии, 16, № 3: 465 (2018). 32. М. Лундстром, Основы нанотранзисторов (Сингапур: World Scientific: 2018). www.nanohub.org/courses/NT. 33. Д. А. Антониадис, IEEE Trans. Электронная разработка, 63: 2650 (2016). https://doi.org/10.1109/TED.2016.2562739 34. K. Natori, H. Iwai, and K. Kakushima, J. Appl. Физ., 118: 234502 (2015). https://doi.org/10.1063/1.4937548 35. M. V. Fischetti, S.E. Laux, J. Appl. Физ., 89: 1205 (2001). https://doi.org/10.1063/1.1332423 36. Уэчи Т., Фукуи Т., Сано Н., Phys. Статус Solidi C, 5: 102 (2008). https://doi.org/10.1002/pssc.200776547 |
(PDF) Нанотранзисторы из металлических и металлоидных композитных нанотрубок
International Journal of Scientific & Engineering Research Volume 4, Issue 2, February-2013 4
ISSN 2229-5518
IJSER © 2013
http: // www.ijser.org
(b)
Рис. 6 (a) Транзистор с нанотрубками из нитрида алюминия (b) Транзистор с трубкой из нитрида бора nano-
Результат показывает, что модель транзистора хорошо подходит для нанотрубок из нитрида алюминия
, но Пороговое напряжение
довольно высокое по сравнению с таковым для нанотрубки из нитрида бора и транзистора из нанотрубок из нитрида галлия
. Кривая имеет крутой и плавный рост
в переходной области в ламповых транзисторах из нитрида алюминия нано-
.
4 ЗАКЛЮЧЕНИЕ
Современные тенденции показывают, что кремний больше не может использоваться в электронной промышленности, поскольку его пределы уже достигнуты. Недавнее изобретение
4D транзисторов ускорило исследования полупроводников III-V com-
фунтов. В данной работе было доказано, что
нанотрубок BN, AlN и GaN могут выступать в качестве нанотранзисторных каналов с соответствующими модификациями в составе каналов.Несогласованность в характеристиках транзистора BN nanotube
может быть уменьшена путем использования соответствующих контактных материалов с атомными характеристиками, аналогичными характеристикам нанотрубок BN.
БЛАГОДАРНОСТЬ
Автор благодарит Всевышнего за знания. Она
благодарит своего гида, доктора К. А. Нараянанкутти, за руководство ее исследовательской работой в магистратуре. Последний, но не
наименьший; в долгу перед родителями Н.Чандрасекара, р.
Сантакумари, брата К. Сентиля Кумарана и мужа К. В.
Шивакумара за их моральную поддержку и силу.
СПИСОК ЛИТЕРАТУРЫ
[1] Дж. Кавальерос, Б.С. Дойл, С. Датта, Г. Дьюи и Р. Чау
Архитектура трехзатворного транзистора«с кристаллом затвора High-k —
Лекция, металлические вентили и деформационная инженерия , «Дайджест
технических статей Симпозиум по технологиям СБИС, стр.62-63,
июнь 2006 г.
[2] ITRS: Международная технологическая дорожная карта для полупроводников-
тор: Интеграция процессов, устройства и структуры, Tech-
nical report, www.itrs.net, 2009.
[3] ZheChuanFeng, «III-Nitride Devices and Nanoengineer-
ing», Imperial College Press, ISBN-13 978-1-84816-223-5,
2008.
[ 4] Минь Чжан, Чжун Мин Су, Ли Кай Янь, Юн Цин Цю,
Гуахуа Чен, Ронг Шун Ван, «Теоретическая интерпретация
различных морфологий нанотрубок среди нитридов группы III
(B, Al, Ga) , ”Химическая физика Letters, Vol. 408,
pp 145–149, 2005.
[5] Йеу Рен Дженг, Пинг Чи Цай и ТеХуа Фанг, «Растяжение
Деформация трубчатых структур нанотрубок на основе нитридов
: хрупкое и слабое поведение», Тамканг. Журнал
науки и техники, Vol.8, pp. 191–195, 2005.
[6] Энгин Дургун, Салим Чирачи, «Теоретическое исследование кремний
con и составных нанотрубок III-V» Journal of Turk
Physics, Vol. 29, pp. 307 — 318, 2005.
[7] X.W. Ван, Дж. Шао, A.T. Нил, М.Дж. Манфра, Р.Г. Гордан,
P.D. Йе, «Транзисторы III-V 4D», 70-я ежегодная конференция по поиску устройств
(DRC), июнь 2012 г.
[8] X. Blase, A. Rubio, SG Louie и ML Cohen, «Stability
and Постоянство ширины запрещенной зоны нанотрубок нитрида бора »,
Europhysics Letters, Vol.28, pp. 335-340, 1994.
[9] Н. Г. Чопра, Р. Дж. Лейкен, К. Черри, В. Х. Геспи, ML
Коэн, С. Г. Лут, А. Зеттл, «Нанотрубки нитрида бора»,
Science, Vol. 269, pp 966–969, 1995.
[10] Джошуа Голдбергер, Ронгруи Хе, Янфэн Чжан,
Сангквон ли, Хаоцюань Ян, Хеон Джин Чой, Пейдун
Ян, «Монокристаллические нанотрубки нитрида галлия, нанотрубки»
туре, Т. 422, pp 599 — 602, 2003.
[11] W.Кон, А.Д. Бек и Р.Г. Парр, «Функциональная плотность плотности
Теория электронной структуры», Journal of Physical Chem-
istry, Vol.100, pp 12974-12980, 1996.
[12] Роберт К. Парр, Вэйтао Ян, «Плотностно-функциональная теория
электронной структуры молекул», Annual Review
of Physical Chemistry, Vol. 46, pp 701-728, 1995.
[13] С. Дж. Танс, Р. М. Вершуерен и К. Деккер, «Температурный транзистор
на основе одной углеродной нанотрубки»,
Nature, Vol.393, pp 49–52, 1998.
[14] Хо-Янг Ча, Хуацян Ву, М.В.С.Чандрашекхар, YC
Чой, С. Чае, Г. Колей и М.Г. Спенсер, «Изготовление и
характеристики предварительно выровненного нитрида галлия. nanowire
полевые транзисторы ”, Нанотехнологии, Vol. 17, pp. 1264-
1271, 2006.
[15] Пиа Джулиан Вессели, Франк Вессели, Эмра Биринчи, Удо
Швальке и Бернадетт Ридингер, «Катион графеновых транзисторов без переноса». Vacuum Sci-
ence and Technology B, Vol.30, 03D114, 2012.
[16] Мингвен Чжао, Юэюань Ся, Дунцзю Чжан и Лян-
Мо Мэй, «Стабильность и электронная структура трубок AlN nano-
», Physical Review B, Vol. 68, pp. 235415, 2003.
[17] AtomistixToolKit версия 12.8.0, QuantumWise A / S
(www.quantumwise.com)
[18] ХайрулАлам, Роджер Лейк, «Роль допинга в углероде
Нанотрубка. Транзисторы с перекрытиями исток / сток »,
Транзакции IEEE по нанотехнологиям, Vol.6, No. 6, No.
vember 2007.
[19] Багавати Чандрасекара, KA Narayanankutty, «Галлий
Нитридные нанотрубкии их применение в качестве транзисторов» в
International Journal of Computer and Applications
(IJCA) , ISSN 0975-888, Vol. 47, No. 14, pp. 39-44, June
2012.
[20] M. Brandbyge, J.-L. Мозос, П. Ордехон, Дж. Тейлор и К.
Стокбро, «Метод функции плотности для неравновесного переноса
электронов», Physical Review B, Vol.65, pp. 165401,
2002.
[21] Суприйо Датта, «Квантовый перенос: от атома к трансистору
», Cambridge University Press, 2005.
[22] R.G. Парр и У. Янг, «Теория функций плотности
атомов и молекул», Оксфорд, 1989.
[23] Дж. П. Пердью, Алекс Зунгер, «Поправка самодействия к приближениям
функционала плотности для многих электронов. sys-
tems, Physical Review B, Vol. 23, стр. 5048-5079, 1981.
Механическая конструкция графеновых нанодиодов и нанотранзисторов: геометрические, температурные и деформационные эффекты
Техника ламинирования одного или нескольких слоев графена на подложке и создания моста малых размеров с последующим измерением изменений электрических свойств схемы, полученной из этого соединения, еще больше повысила надежды на миниатюризацию электронных устройств. В связи с важностью этого предмета и необходимостью механического проектирования таких систем перед приемом сигналов, в этой статье влияние геометрии, температуры и механических деформаций на механические свойства графеновых нанодиодов и нанотранзисторов было изучено с использованием метода молекулярной динамики. метод.Испытание на растяжение использовалось в качестве подходящего средства измерения механических свойств подвешенных листов графена и графеновых нанодиодов, а испытание на виртуальное вдавливание применялось для зигзагообразных и кресельных транзисторов. После проверки использованного метода путем сравнения его с предыдущими работами наиболее важный вывод для случая диода показывает, что при увеличении угла выпрямления от нуля до 90 ° модуль упругости падает с 1,092 до 0,79 ТПа для определенных размеров; что меньше 27.65%. В графеновом транзисторе модуль упругости увеличивается с увеличением ширины транзистора. Тем не менее, в отличие от кресельных транзисторов, разница между механическими свойствами зигзагообразных транзисторов и подвешенного графена становится больше с увеличением длины транзистора. В общем, квадратный транзистор имеет самый высокий модуль упругости и, следовательно, лучшую жесткость; в то время как такие квадратные листы графена разрушаются при более низких деформациях и напряжениях по сравнению с графеновыми транзисторами других размеров.
У вас есть доступ к этой статье
Подождите, пока мы загрузим ваш контент… Что-то пошло не так. Попробуй еще раз?Одномерная эффективная модель для нанотранзисторов в формализме Ландауэра-Бюттикера
Принадлежности Расширять
Принадлежность
- 1 Факультет вычислительной физики Бранденбургского технологического университета Котбус-Зенфтенберг, почтовый ящик 101344, 03013 Котбус, Германия.
Элемент в буфере обмена
Ульрих Вульф. Микромашины (Базель). .
Бесплатная статья PMC Показать детали Показать вариантыПоказать варианты
Формат АннотацияPubMedPMID
Принадлежность
- 1 Факультет вычислительной физики Бранденбургского технологического университета Котбус-Зенфтенберг, почтовый ящик 101344, 03013 Котбус, Германия.
Элемент в буфере обмена
Полнотекстовые ссылки Опции CiteDisplayПоказать варианты
Формат АннотацияPubMedPMID
Абстрактный
В серии публикаций мы разработали компактную модель нанотранзисторов, в которой квантовый перенос в различных промышленных нано-полевых транзисторах был описан количественно.Компактная модель нанотранзистора позволяет извлекать такие важные параметры устройства, как эффективная высота барьера исток-сток, нагрев устройства и качество связи между каналом проводимости и контактами. Начиная с базового описания квантового транспорта в многополюсном устройстве в формализме Ландауэра-Бюттикера, мы даем подробный вывод всех соответствующих формул, необходимых для построения нашей компактной модели нанотранзистора. Здесь мы широко используем метод R-матрицы.
Ключевые слова: Формализм Ландауэра – Бюттикера; R-матричный метод; нанотранзистор; квантовый транспорт.
Заявление о конфликте интересов
Автор заявляет об отсутствии конфликта интересов.
Цифры
Рисунок A1
Формулировка уравнения (A1)…
Рисунок A1
Формулировка уравнения (A1) для контакта s = 1 в N…
Рисунок A1Формулировка уравнения (A1) для контакта s = 1 в N = 3-контактном устройстве на Γ¯1 (см. Также рисунок 1).Составляющая тока, направленная в направлении −n → 1, равна I1in. Три компонента тока в направлении n → 1: I1 → 1out, I1 → 2out и I1 → 3out. Поскольку в Ω1 нет процессов рассеяния, то I1 → 2out и I1 → 3out одинаковы в Γ1 и Γ¯1 (см. Горизонтальные штриховые линии).
Рисунок 1
Идеальная многопозиционная система: N =…
Рисунок 1
Идеализированная многополюсная система: N = 3 клеммы, обозначенные индексом s — это…
фигура 1Идеализированная многополюсная система: N = 3 клеммы, обозначенные индексом s , подключены к центральному рассеивающему объему Ω0 (красный).Каждый терминал связан, во-первых, с резервуаром носителей заряда Rs, определяющим химический потенциал носителей μs (серый цвет). Во-вторых, он связан с контактной областью Ωs (синий цвет), в которой формируются состояния когерентного рассеяния. Зеленым цветом мы изображаем границы раздела Γs между Ωs и Ω0 (сплошные), а также границы раздела Γ¯s между Ωs и Rs (пунктир). Объем когерентности Ω состояний рассеяния составляет совокупность множеств Ω0 и всех Ωs. Здесь Γ — поверхность Ω, исключая Γ¯s (пурпурный).
Рисунок 2
( a ) Элементы конструкции…
Рисунок 2
( a ) Структурные элементы обычного нано-MOSFET: контакт истока и стока…
фигура 2( a ) Структурные элементы обычного нано-МОП-транзистора: исток и сток контактируют с мелкими переходными удлинителями SJE, последние отмечены синим цветом.Красный цвет — канал проводимости и перекрытие между каналом проводимости и SJE. Граница раздела полупроводник-изолятор расположена при y = 0. ( b ) Назначение вышеуказанных структурных элементов структурным элементам общей многополюсной системы на рисунке 1: SJE связаны с кубическими контактными областями Ωs. ( c ) Красным цветом: потенциал поперечного ограничения VT (y) канала проводимости в отделимом анзаце для потенциала в уравнении (35). Коричневым цветом обозначена самая низкая энергия E0Ty подзоны в ограничивающем потенциале канала, как определено в уравнении (62) (сплошной цвет), и соответствующая собственная функция (пунктир).( d ) Линейное падение приложенного напряжения стока, приводящее к линейному продольному потенциалу VL (x) в уравнении (35).
Рисунок 3
Двухконтактная система на рисунке…
Рисунок 3
Двухконтактная система на рис. 2b, где для простоты направление z опущено.…
Рисунок 3Двухконтактная система на рис. 2b, где для простоты направление z опущено. Осевые контакты в направлении x: n → 2 точки в направлении x , n → 1 в направлении минус x .
Похожие статьи
- За пределами теории Маркуса и подхода Ландауэра-Бюттикера в молекулярных соединениях: единая структура.
Sowa JK, Mol JA, Briggs GAD, Gauger EM. Sowa JK, et al. J Chem Phys. 21 октября 2018 г .; 149 (15): 154112. DOI: 10,1063 / 1,5049537. J Chem Phys. 2018. PMID: 30342434
- Подход Ландауэра-Бюттикера к сильносвязанной квантовой термодинамике: двойственность эволюции энтропии изнутри и снаружи.
Брух А., Левенкопф С., фон Оппен Ф. Bruch A, et al.Phys Rev Lett. 2018 9 марта; 120 (10): 107701. DOI: 10.1103 / PhysRevLett.120.107701. Phys Rev Lett. 2018. PMID: 29570311
- Квантовый транспорт в кремниевых нанопроволочных полевых транзисторах: горячие электроны и локальное рассеяние мощности.
Мартинес А., Баркер-младший. Мартинес А. и др. Материалы (Базель). 2020 26 июля; 13 (15): 3326. DOI: 10.3390 / ma13153326. Материалы (Базель).2020. PMID: 32722649 Бесплатная статья PMC. Обзор.
- Транспорт и термодинамика в квантовых контактах: подход рассеяния.
Семенов А, Ницан А. Семенов А, и др. J Chem Phys. 2020 28 июня; 152 (24): 244126. DOI: 10.1063 / 5.0010127. J Chem Phys. 2020. PMID: 32610981
- За пределами современного состояния: новые подходы к тепловому и электрическому транспорту в наномасштабных устройствах.
Биле Р., Д’Агоста Р. Биле Р. и др. Энтропия (Базель). 2019 2 августа; 21 (8): 752. DOI: 10.3390 / e21080752. Энтропия (Базель). 2019. PMID: 33267466 Бесплатная статья PMC. Обзор.
использованная литература
- Немнес Г.А., Вульф У., Racec P.N. Нанотранзисторы в формализме Ландауэра-Бюттикера.J. Appl. Phys. 2004; 96: 596. DOI: 10,1063 / 1,1748858. — DOI
- Немнес Г.А., Вульф У., Racec P.N. Нелинейные ВАХ нанотранзисторов в формализме Ландауэра-Бюттикера. J. Appl. Phys. 2005; 98: 84308. DOI: 10,1063 / 1,2113413.- DOI
- Вульф У., Рихтер Х. Масштабно-инвариантный ток стока в нано-полевых транзисторах. J. Nano Res. 2010; 10: 49–61. DOI: 10.4028 / www.scientific.net / JNanoR.10.49. — DOI
- Вульф У., Рихтер Х. Масштабирование квантового транспорта в кремниевых нанотранзисторах. Твердотельный Феном. 2010. 10: 156–158. DOI: 10.4028 / www.scientific.net / SSP.156-158.517. — DOI
- Вульф У., Рихтер Х. Масштабирующие свойства баллистических нанотранзисторов.Nanoscale Res. Lett. 2011; 6: 365. DOI: 10.1186 / 1556-276X-6-365. — DOI — ЧВК — PubMed
Показать все 51 упоминание
Inderscience Publishers — объединение научных кругов, бизнеса и промышленности посредством исследований
Улучшенные отчеты о цитировании Clarivate и импакт-факторы для журналов Inderscience
16 июля 2021 года
Редакция журнала Inderscience рада сообщить, что в отчетах о цитировании журналов от Clarivate Analytics за 2021 год были обнаружены достижения во многих журналах Inderscience, включая European Journal of Industrial Engineering, European Journal of International Management, International Journal of Bio-Inspired Computing, International Journal of Exergy, International Journal of Global Warming, International Journal of Mobile Communications, International Journal of Нефть, газ и угольные технологии, Международный журнал судоходства и транспортной логистики, Международный журнал исследований поверхности и инженерии, Международный журнал по управлению технологиями, Международный журнал веб- и сетевых служб и Прогресс в вычислительной гидродинамике cs.
Редакция хотела бы поздравить и поблагодарить всех участвующих редакторов, членов правления, авторов и рецензентов и рада видеть, что их усилия были вознаграждены в этих последних отчетах о цитировании.
Европейский журнал международного менеджмента отмечает достижения в области индексации
29 июня 2021 г.
Мы рады сообщить, что Европейский журнал международного менеджмента недавно улучшил свои показатели индексации по нескольким направлениям, переместившись в рейтинг 2 в рейтинге. Chartered ABS Academic Journals Guide, улучшенный рейтинг Scopus CiteScore 3.7 (с 2,7), а индекс Scimago H подскочил до 25 (с 22). Главный редактор и заместитель главного редактора EJIM , проф. Илан Алон и проф. Влодзимеж, благодарят свою редакцию, старших редакторов, редакционный и рецензионный совет, рецензентов и авторов за помощь журналу в достижении столь значительных успехов.
Член правления Inderscience профессор Мохан Мунасингх выиграл премию Blue Planet Warming была удостоена премии Blue Planet 2021 года.В этом году отмечается 30-я присуждение премии Blue Planet Prize, международной экологической премии, спонсируемой фондом Asahi Glass Foundation под председательством Такуя Шимамура. Ежегодно Фонд выбирает двух победителей — физических лиц или организации, внесшие значительный вклад в решение глобальных экологических проблем.
Проф. Мунасингхе сделал следующее заявление:
«Я глубоко признателен и для меня большая честь получить Премию Голубой планеты 2021 года, главную глобальную награду за экологическую устойчивость, символизирующую выдающуюся приверженность Японского фонда Asahi Glass Foundation лучшему будущему. .Я также в долгу перед многими, кто внесли щедрый вклад в мое интеллектуальное развитие и эмоциональный интеллект, включая учителей, наставников, коллег, семью и друзей. Социальные связи были неоценимы, чтобы пережить давление COVID-19.
Приятно узнать, что комитет по присуждению награды особо признал несколько ключевых концепций, которые я разработал, и их практическое применение во всем мире в течение почти пяти десятилетий, включая концепцию устойчивого развития, треугольник устойчивого развития (экономика, окружающая среда, общество), сбалансированный, инклюзивный зеленый рост. (BIGG) и Цели потребления тысячелетия (MCG).
Мои исследовательские интересы расширились от базовых дисциплин, таких как инженерия, физика и экономика, до прикладных секторов, таких как энергия, вода, транспорт, ИКТ и экологические ресурсы, и, наконец, до многопрофильных тем, таких как бедность, бедствия, изменение климата и устойчивое развитие. Этот эклектичный опыт помог мне разработать Sustainomics как интегративную междисциплинарную методологию. Опираясь на свою прошлую работу и глобальную платформу, предоставленную престижной премией Blue Planet Prize, я продолжу свои скромные усилия, чтобы сделать нашу планету более устойчивой для всех.»
РедакцияInderscience искренне поздравляет профессора Мунасингхе с этим выдающимся и значительным достижением.
Международный журнал устойчивого управления сельским хозяйством и информатики, индексируемый Clarivate Analytics ‘Emerging Sources Citation Index
22 мая 2021 г.
Inderscience is рад сообщить, что Международный журнал устойчивого управления сельским хозяйством и информатики был проиндексирован Clarivate Analytics ‘Emerging Sources Citation Index.
Проф. Бэзил Манос, главный редактор журнала, говорит: «Попадание IJSAMI в Индекс цитирования новых источников — результат наших настойчивых и методичных усилий по обеспечению высочайшего качества статей, привлечению компетентных рецензентов и быстрый обмен электронной почтой с нашими авторами и рецензентами. Я очень рад и взволнован этим признанием нашей работы, и я по-прежнему привержен обеспечению международного научного сообщества журналом высочайшего качества ».
Международный журнал гидромехатроники проиндексирован Clarivate Analytics ‘Emerging Sources Citation Index
20 мая 2021 г.
Inderscience рада сообщить, что Международный журнал гидромехатроники проиндексирован Clarivate Analytics’ Emerging Sources Citation Index.
Проф. Иминь Шао, главный редактор журнала, говорит: «Я очень рад, что IJHM был включен в Индекс цитирования новых источников. Это признание академических достижений и редакционной работы журнала. Я бы хотел хотел бы выразить нашу искреннюю благодарность всем, кто внес свой вклад в этот журнал.Мы продолжим придерживаться нашей политики публикации и публиковать высококачественные статьи для содействия академическому обмену и развитию в области гидроэнергетики и электромеханического управления.»
Произошла ошибка при настройке пользовательского файла cookie
Этот сайт использует файлы cookie для повышения производительности. Если ваш браузер не принимает файлы cookie, вы не можете просматривать этот сайт.
Настройка вашего браузера для приема файлов cookie
Существует множество причин, по которым cookie не может быть установлен правильно. Ниже приведены наиболее частые причины:
- В вашем браузере отключены файлы cookie. Вам необходимо сбросить настройки своего браузера, чтобы он принимал файлы cookie, или чтобы спросить вас, хотите ли вы принимать файлы cookie.
- Ваш браузер спрашивает вас, хотите ли вы принимать файлы cookie, и вы отказались. Чтобы принять файлы cookie с этого сайта, нажмите кнопку «Назад» и примите файлы cookie.
- Ваш браузер не поддерживает файлы cookie. Если вы подозреваете это, попробуйте другой браузер.
- Дата на вашем компьютере в прошлом. Если часы вашего компьютера показывают дату до 1 января 1970 г., браузер автоматически забудет файл cookie. Чтобы исправить это, установите правильное время и дату на своем компьютере.
- Вы установили приложение, которое отслеживает или блокирует установку файлов cookie. Вы должны отключить приложение при входе в систему или проконсультироваться с системным администратором.
Почему этому сайту требуются файлы cookie?
Этот сайт использует файлы cookie для повышения производительности, запоминая, что вы вошли в систему, когда переходите со страницы на страницу. Чтобы предоставить доступ без файлов cookie потребует, чтобы сайт создавал новый сеанс для каждой посещаемой страницы, что замедляет работу системы до неприемлемого уровня.
Что сохраняется в файле cookie?
Этот сайт не хранит ничего, кроме автоматически сгенерированного идентификатора сеанса в cookie; никакая другая информация не фиксируется.
Как правило, в файле cookie может храниться только информация, которую вы предоставляете, или выбор, который вы делаете при посещении веб-сайта. Например, сайт не может определить ваше имя электронной почты, пока вы не введете его. Разрешение веб-сайту создавать файлы cookie не дает этому или любому другому сайту доступа к остальной части вашего компьютера, и только сайт, который создал файл cookie, может его прочитать.
Подавление шума за пределами теплового предела с помощью нанотранзисторных биосенсоров
В этом разделе цель состоит в том, чтобы предложить теоретическую основу для отношения сигнал / шум в случае подхода явления одиночной ловушки. Мы рассматриваем вероятность занятости ловушки как сигнал и оцениваем шум \ (g \), чтобы определить отношение сигнал / шум (см. Рис. 3e, f). Мы демонстрируем экспериментально, численно и аналитически, что в оптимизированных условиях отношение сигнал / шум может быть выше, чем у теплового шума в устройствах без ловушек.
Вероятность занятости ловушки \ ({\ varvec {g}} \) и численное моделирование
Обычный сигнал в транзисторных биосенсорах — это сдвиг тока стока, а флуктуации тока — шум. Напротив, мы определяем сигнал в биосенсорах с одной ловушкой 21,22,32 как вероятность занятости ловушки \ (g \). Чтобы вычислить шум g-фактора (флуктуации во времени) с учетом двухуровневой временной шкалы RTS, можно извлечь \ (g \ left (t \ right) \) по заданному окну \ (\ Theta \) непосредственно из распределения колебания напряжения (см. рис.3е). Затем, сдвигая окно вместе с временной кривой RTS, можно получить новую временную кривую с флуктуациями фактора занятости ловушки во времени. Затем данные g-фактора во временной области можно преобразовать в частотный спектр, в результате чего получится спектральная плотность мощности \ ({S} _ {g} \).
Результаты экспериментов
На рисунке 4a показаны двухуровневые флуктуации тока стока, измеренные для Si NW FET с жидкостным затвором шириной 100 нм и длиной 100 нм. Устройство было изготовлено с использованием ранее описанного протокола 32 .Краткое описание основных этапов изготовления также представлено во вспомогательной информации (SI) этой работы. Все измерения шума проводились в специально изготовленной клетке Фарадея с использованием полностью автоматизированной установки для измерения сверхнизкого шума 22,33 . Транзистор, демонстрирующий шумовое поведение RTS, был смещен в линейном режиме работы и измерен при комнатной температуре. Для извлечения текущих состояний стока для измеренной временной кривой RTS был применен метод, основанный на скрытой марковской модели 34,35 (см.рис.4а). Средние постоянные времени захвата и излучения, характеризующие измеренный процесс RTS, показаны на рис. 4b. Среднее характеристическое время излучения остается примерно постоянным, в то время как среднее характеристическое время захвата демонстрирует сильную зависимость от приложенного напряжения на жидком затворе. Следует отметить, что такое поведение постоянных времени RTS типично для полевых транзисторов на основе нанопроволоки с жидкостным затвором 22,32,36 .
Рисунок 4Шумовые характеристики РТС. ( a ) Двухуровневые флуктуации RTS тока стока и соответствующие извлеченные RTS-состояния, измеренные в Si NW FET с жидкостным затвором шириной 100 нм и длиной 100 нм.( b ) Константы времени захвата и излучения в зависимости от напряжения на жидком затворе, извлеченные для смоделированных и измеренных временных кривых RTS. ( c ) \ ({S} _ {g} \) шум на частоте 10 Гц в зависимости от временного окна, рассчитанного для различных условий.
Чтобы не быть ограниченными статистически и иметь достаточно длинные временные диаграммы RTS для расчета шума g-фактора, мы также сгенерировали шум RTS численно, используя основные уравнения 37 (см. Уравнения S1-S3 в SI) с дополнительным учетом DP шум 10 .Смоделированный шум RTS имеет характеристики, аналогичные характеристикам, полученным для экспериментально измеренного шума RTS, как показано на рис. 4b. Шум фактора занятости ловушки, взятый на частоте 10 Гц как для измеренных, так и для смоделированных временных кривых, показан на рис. 4c. Следует отметить, что данные, представленные на рис. 4в, получены для RTS с \ (g = 0,5 \), что соответствует случаю, когда уровень энергии ловушки совпадает с уровнем Ферми системы. При этом условии количество событий перехода между состояниями максимизируется, поэтому шум, вносимый вычислением коэффициента занятости ловушки (шум g-фактора), также максимизируется.
Как видно из рис. 4c, шум g-фактора уменьшается с увеличением временного окна \ (\ Theta \). Зависимость шума g-фактора от временного окна можно объяснить, учитывая тот факт, что большее временное окно содержит больше переходных событий, позволяющих оценить g-фактор с более высокой точностью, как показано на рис. 3f.
Аналитическая модель шума с g-фактором
Рассмотрим двухуровневый сигнал RTS \ ({X} _ {t} \), который перескакивает между состояниями 0 и 1. {t + \ Theta} {1} _ {\ left \ {{X} _ {S} = 1 \ right \} } ds $$
(7)
, где \ ({1} _ {\ left \ {{X} _ {S} = 1 \ right \}} \) — индикаторная функция (равна 1, если \ ({X} _ {S} = 1 \)).{\ Theta} \ underset {s} {\ overset {s + \ Theta} {\ int}} {{\ mathbb {P}} (X} _ {max \ left (u, v \ right)} = 1 \ left | {X} _ {min \ left (u, v \ right)} = 1 \ right) \ times {{\ mathbb {P}} (X} _ {min \ left (u, v \ right)} = 1 ) du dv \ right) \ right] $$
(9)
Мы видим, что автокорреляционная функция следует двум режимам, которые связаны с фильтром усреднения и стохастическим переносом заряда соответственно (см. Рис. S5). После некоторых упрощений можно получить аналитическую модель для спектральной плотности мощности \ (g \) в случае, когда \ (\ lambda = \ mu = \ gamma \) (т.{2} \ right)} $$
(10)
где \ (\ omega = 2 \ pi f \) и \ (\ Theta \) — длительность скользящего временного окна (см. Рис. 3 (f)).
Шум g-фактора, приведенный к входу \ ({{\ varvec {S}}} _ {{\ varvec {g}} {\ varvec {g}}} \)
Для сравнения производительности и эффективности датчиков с нанотранзисторами, использующих явление одиночной ловушки, необходимо сначала ввести и вычислить эквивалентный приведенный к входу шум, вызванный изменением g-фактора.{2}} $$
(11)
где \ ({S} _ {g} \) — спектральная плотность мощности g-фактора, а \ ({g} _ {g} \) — производная g-фактора, вычисляемая как \ (\ frac {\ partial g } {{\ partial V} _ {G}} \).
На рисунке 5a показаны приведенные к входу спектральные плотности мощности шума напряжения с помощью лоренцевой арматуры, измеренные для тех же кремниевых NW полевых транзисторов с жидкостным затвором шириной 100 нм и длиной 100 нм, демонстрирующих ярко выраженный двухуровневый шум RTS (см. Рис. 4a). Темно-синяя пунктирная линия представляет зависимость шума 1/ f DP, рассчитанную для устройства по формуле.{-1} \) (как для экспериментальных данных) и \ (\ Theta = 20 s \). Следовательно, шум в датчиках, использующих явление RTS, фактически может быть подавлен при рассмотрении оптимальных условий для расчета g-фактора. Для этого необходимо внимательно рассмотреть в основном три параметра: временное окно \ (\ Theta \), частоту RTS \ ({f} _ {0} \) и наклон зависимости g-фактора от приложенного напряжения затвора. .
Рис. 5Шумоподавление для датчика на основе подхода с одной ловушкой.( a ) Приведенный к входу шум Si NW FET шириной 100 нм и длиной 100 нм, измеренный при различных напряжениях на жидком затворе (указано в легенде рисунка). Пунктирные цветные линии обозначают компоненты RTS в соответствующих измеренных спектрах \ ({S} _ {{V} _ {G}} \). Пунктирная линия представляет шум DP, рассчитанный для того же Si NW FET с жидкостным затвором. Стрелка указывает на подавление шума. ( b ) \ ({S} _ {gg} \) шум на частоте 10 Гц, рассчитанный для временных окон \ (\ Theta = 1 s \) и \ (\ Theta = 10 s \), и построенный как функция частоты излома RTS при \ (g = 0.5 \). ( c ) Коэффициент занятости ловушки \ (g \) и его производная \ ({g} _ {g} \) (вставка), рассчитанные для шума RTS, смоделированного с различными \ (\ alpha \) (соотношением между емкостью затвора \ ({C} _ {G} \) и туннельная емкость \ ({C} _ {j} \) — см. Уравнения (S1) и (S2) в SI). ( d ) Входной приведенный шум g-фактора \ ({S} _ {gg} \) при 10 Гц и временном окне 10 с, построенный как функция \ (g \) для различных условий. Пунктирная синяя линия обозначает здесь уровень шума DP на частоте 10 Гц, рассчитанный для того же транзистора.Стрелка указывает на подавление шума ниже теплового предела при рассмотрении шума RTS в качестве сигнала.
Влияние временного окна \ (\ Theta \) на шум g-фактора \ ({S} _ {g} \) показано на рис. 4c. Достаточно большое окно, содержащее достаточное количество переходных событий (> 200) 38,39 , необходимо для значимой статистической оценки \ (g \). Однако количество событий переключения между двумя уровнями в течение заданного периода времени также сильно зависит от угловой частоты RTS \ ({f} _ {0} \).Количество переходов во времени \ (\ Theta \) больше для высокочастотного RTS, чем для низкочастотного RTS при той же вероятности занятия ловушки. Следовательно, g-фактор может быть оценен с большей точностью для быстрого RTS, учитывая то же количество времени, что и для медленного (низкочастотного) RTS-процесса (см. Рис. 5b).
Наклон (крутизна) зависимости g-фактора от приложенного напряжения затвора является еще одним важным параметром, определяющим эффективность явления одиночной ловушки для биодатчика.Кривые g-фактора с разным наклоном показаны на рис. 5в. Для датчиков, использующих эффект RTS, сигналом являются ярко выраженные изменения параметров RTS (т. Е. G-фактора, времени захвата и т. Д.), Вызванные истощением или накоплением носителей заряда в кремниевой нанопроволоке, когда заряженные биомолекулы прикрепляются к ней. поверхность. Следовательно, чувствительность датчиков на основе RTS может быть записана как:
$$ {S} _ {RTS} \ приблизительно \ frac {\ Delta g} {\ Delta {V} _ {G}} = {g} _ {g} $$
(12)
Зависимость чувствительности от крутизны (крутизны) g-фактора доказана также экспериментально 22 .Более того, согласно формуле. Согласно (11), приведенный к входу шум g-фактора также сильно зависит от наклона кривой g-фактора. Как видно на рис. 5d, шум \ ({S} _ {gg} \) фактически может быть уменьшен на порядок величины из-за влияния наклона g-фактора.
Анализ отношения сигнал / шум для нанобиосенсоров на основе ловушек
Отношение сигнал / шум — важный параметр для любого сенсора, демонстрирующего его чувствительность. Следовательно, этот параметр необходимо тщательно исследовать для сенсоров с нанотранзисторами, использующих явления одиночной ловушки для оптимизации условий эксперимента.{f1} {S} _ {{V} _ {G}} df}} $$
(13)
где \ ({S} _ {{V} _ {G}} \) — эквивалентный шум напряжения, приведенный к входу, а \ (\ delta {V} _ {Th} \) — сдвиг порогового напряжения, вызванный взаимодействие целевой биомолекулы с чувствительной поверхностью биосенсора. Отношение сигнал / шум для нанобиосенсоров, принцип работы которых основан на явлении одиночной ловушки, можно определить аналогично:
$$ S / N = \ frac {\ delta {V} _ {Th}} {\ sqrt { {\ int} _ {f2} ^ {f1} {S} _ {gg} df}} $$
(14)
Отношение сигнал / шум, рассчитанное для шума RTS с разными угловыми частотами при \ (g = 0.5 \) показан на рис. 6а. Большее количество переходных событий из-за более высокой скорости RTS (\ (\ gamma = {\ pi f} _ {0} \)) приводит к меньшему \ ({S} _ {gg} \) шуму (см. Рис. 5b ), что приводит к увеличению отношения сигнал / шум. На рис. 6b показано отношение сигнал / шум, рассчитанное для явлений RTS с различными наклонами g-фактора (см. Рис. 5c). Пунктирная линия отражает уровень отношения сигнал / шум для устройства без ловушек с той же емкостью затвора, что и для устройства с одиночной ловушкой, демонстрирующего только шум DP. В качестве сигнала мы использовали сдвиг порогового напряжения на 5.9 мВ, вызванное изменением pH в управляющем растворе на 0,1 при рассмотрении идеальных ионно-чувствительных датчиков на основе полевых транзисторов. Из рис. 6a, b ясно видно, что в оптимизированных условиях отношение сигнал / шум действительно может быть существенно увеличено даже выше уровня, ожидаемого для устройств без ловушек, отслеживающих сдвиг порогового напряжения в качестве сигнала.
Рисунок 6Отношение сигнал / шум для сигнала 5,9 мВ, оцененное для подхода с использованием явления одиночной ловушки для различных условий. ( a ) Отношение сигнал / шум рассчитывается для временных окон \ (\ Theta = 1 s \) и \ (\ Theta = 10 s \) и строится как функция угловой частоты RTS.( b ) Отношение сигнал / шум в зависимости от \ (g \) для различных наклонов g-фактора и временного окна 10 с. Пунктирная линия представляет уровень S / N, рассчитанный для Si NW FET с шумом напряжения DP 1,4 × 10 –8 В 2 / Гц при 10 Гц. Стрелка указывает на увеличение отношения сигнал / шум для подхода с одной ловушкой.
.


