Силовая электроника №1549 — Архив тестов
Время восстановления обратного сопротивления для диодов общего назначения достигает:
1, от 15 до 25 мкс
2, от 25 до 100 мкс
3, от 100 до 250 мкс
4, от 10 до 50 мкс
При переходе в закрытое состояние мощность потерь в силовом диоде
1. плавно уменьшается
2. не изменяется
3. резко увеличивается
4. резко уменьшается
Коэффициент насыщения биполярного транзистора прямо пропорционален:
1. току базы в насыщенном режиме
2, току базы в граничном режиме
3. току коллектора в насыщенном режиме
Силовой биполярный транзистор в точке отсечки находится в:
1, открытом состоянии и характеризуется очень малым током
2, открытом состоянии и характеризуется очень высоким током
3, закрытом состоянии и характеризуется очень высоким током
4, закрытом состоянии и характеризуется очень малым током
Граничное условие перехода биполярного транзистора p-n-p-типа из активного режима в режим отсечки:
1, напряжение между базой и коллектором меньше нуля
3. напряжение между базой и коллектором равно нулю
4, напряжение между базой и эмиттером равно нулю
В основе биполярного транзистора лежит:
1, двухслойная полупроводниковая структура
2, четырехслойная полупроводниковая структура
3, трехслойная полупроводниковая структура
В каком режиме может находиться биполярный транзистор в зависимости от полярности приложенного к переходам напряжения. Выберите один или несколько ответов:
1, Индуктивном
2. Инверсном
3, Отсечки
4. Импульсном
В режиме отсечки биполярный транзистор можно заменить:
1. источником тока эмиттера, управляемого током базы
3, замкнутым ключом
4. разомкнутым ключом
В ключевом режиме работы биполярного транзистора мощности потерь в точках отсечки и насыщения будут:
1. значительно больше мощности потерь в рабочей точке нелинейного режима транзистора
2, значительно больше мощности потерь в рабочей точке линейного режима транзистора
3, значительно меньше мощности потерь в рабочей точке линейного режима транзистора
4. значительно меньше мощности потерь в рабочей точке нелинейного режима транзистора
Силовой диод содержит
1. один управляющий p-n-переход
2. два p-n-перехода
3. один p-n-переход
4. один управляемый p-n-переход
В режиме лавинного пробоя силового диода:
1. резко увеличивается обратный ток при незначительном изменении обратного напряжения
2, резко увеличивается обратный ток при резком изменении обратного напряжения
3, незначительно увеличивается обратный ток при незначительном изменении обратного напряжения
4. незначительно увеличивается обратный ток при резком изменении обратного напряжения
Мощность потерь обратного восстановления силового диода равна:
1. отношению частоты коммутации и энергии прямого восстановления
2. произведению энергии прямого восстановления и частоты коммутации
3. отношению энергии обратного восстановления и частоты коммутации
Идеальный диод переходит в замкнутое состояние, если:
1, напряжение на аноде больше, чем напряжение на катоде
2. ток на аноде меньше, чем ток на катоде
3. ток на аноде больше, чем ток на катоде
4, напряжение на аноде меньше, чем напряжение на катоде
Силовым диодом называется:
1, полупроводниковый управляемый прибор с тремя выводами
2, полупроводниковый управляемый прибор с двумя выводами
3, полупроводниковый неуправляемый прибор с двумя выводами
4, полупроводниковый неуправляемый прибор с тремя выводами
Электрический пробой силового диода возникает, когда:
2, обратное напряжение уменьшается ниже установленного порога
3, обратное напряжение увеличивается сверх установленного порога
4, прямое напряжение уменьшается ниже установленного порога
Величина заряда обратного восстановления силового диода:
1. прямо пропорциональна энергии прямого восстановления
2. обратно пропорциональна энергии обратного восстановления
3. обратно пропорциональна энергии прямого восстановления
4, прямо пропорциональна энергии обратного восстановления
Основная функция силового диода:
1. преобразование постоянного сигнала
2. выпрямление переменного сигнала
Транзисторы Дарлингтона используют для:
1. уменьшения коэффициента передачи тока в силовых высоковольтных транзисторах
2. увеличения коэффициента передачи тока в низковольтных транзисторах
3, увеличения коэффициента передачи тока в силовых высоковольтных транзисторах
4, уменьшения коэффициента передачи тока в низковольтных транзисторах
Транзистор — это
1. полупроводниковый полностью управляемый прибор с тремя и более выводами
2. полупроводниковый полностью управляемый прибор с двумя и более выводами
3. полупроводниковый частично управляемый прибор с двумя и более выводами
4. полупроводниковый частично управляемый прибор с тремя и более выводами
Полупроводниковый диод с малым падением напряжения при прямом включении, названный в честь немецкого физика?
1. Диод Шоттки
2. Диод Шокли
3. Диод Ганна
4. Диод Зенера
Полупроводниковый диод для стабилизации напряжения?
1. Диод Шоттки
2. Диод Ганна
3. Диод Шокли
4. Диод Зенера
Стабилизатор напряжения, в котором регулирующий элемент работает в ключевом режиме, называется
1. Импульсным
2. Переодическим
3. Синхронным
4. Волновым
Обязательным элементом импульсных источников питания является электронный …:
1. усилитель
2. ключ
3. интегратор
4. модулятор
Приведена схема …:
1. Преобразователи на основе дросселя
3. Преобразователь с повышением напряжения
4. Инжектирующий преобразователь
Преобразователь электрической энергии, позволяющий получить на выходе напряжение, находящееся в заданных пределах при больших колебаниях входного напряжения называется…
1. Выпрямителем
2. Стабилизатором
3. Усилителем
4. Компенсатором
Феррорезонансные стабилизаторы напряжения стали широко применяться …:
1. в 20 веке
2. Вначале 21-го века
Преобразователь электрической энергии, позволяющий получить на выходе напряжение, находящееся в заданных пределах при значительных колебаниях сопротивления нагрузки?
2. Стабилизатор
3. Выпрямитель
4. Конвертор
Какой стабилизатор переменного напряжения состоит из двух дросселей?
1. Широтноимпульсный
2. Фазоимпульсный
3. Электронный
4. Феррорезонансный
Аппараты дистанционного действия, предназначенные для частых включений и отключений силовых электрических цепей при нормальном режиме работы?
1. Теристорные ключи
2. Инверторы
3. Контакторы
4. Конверторы
В структуре биполярного транзистора крайний слой, являющийся источником носителей зарядов, называется:
1, База
2. Эмиттер
3. Коллектор
Время восстановления обратного сопротивления для диодов общего назначения достигает






























































































































































































































































































































































































































































































































 Время восстановления обратного сопротивления для диодов общего назначения достигает:
Время восстановления обратного сопротивления для диодов общего назначения достигает:от 25 до 100 мкс
Динамическими параметрами силового диода являются
время восстановления обратного напряжения
время нарастания прямого тока
При переходе в закрытое состояние мощность потерь в силовом диоде
резко увеличивается
Плоскостные диоды
имеют большую площадь p-n-перехода
используются для выпрямления больших токов
Точечные диоды
имеют малую площадь p-n-перехода
используются для выпрямления малых токов
Силовой диод содержит
один p-n-переход
В режиме лавинного пробоя силового диода
резко увеличивается обратный ток при незначительном изменении обратного напряжения
Схема замещения реального силового диода при низкой частоте не содержит
катушку индуктивности
Мощность потерь обратного восстановления силового диода равна
произведению энергии обратного восстановления и частоты коммутации
К статическим параметрам силового диода не относится
время нарастания прямого тока
Идеальный диод переходит в замкнутое состояние, если
напряжение на аноде больше, чем напряжение на катоде
Силовым диодом называется
полупроводниковый неуправляемый прибор с двумя выводами
Электрический пробой силового диода возникает, когда
обратное напряжение увеличивается сверх установленного порога
Величина заряда обратного восстановления силового диода
прямо пропорциональна энергии обратного восстановления
Основная функция силового диода
выпрямление переменного сигнала
К предельно допустимым параметрам силового диода относится
импульсное обратное напряжение
Какое импульсное обратное напряжение имеет силовой диод 6-го класса
600 В
Отсутствие неосновных носителей в диоде Шоттки не обеспечивает
предельное обратное напряжение более 100 В
Быстровосстанавливающиеся диоды характеризуются следующими параметрами
прямой ток — в диапазоне от 10 до 1000 А
обратное напряжение от 50 до 3000 В
При подаче прямого напряжения смещения сопротивление идеального диода
равно нулю
Время восстановления обратного сопротивления для быстровосстанавливающихся диодов достигает:
до 100 нс
К параметрам силовых диодов не относятся
потенциальные
Какой полупроводник используется при изготовлении диода Шоттки
кремний
При подаче обратного напряжения смещения сопротивление идеального диода
стремится к бесконечности
Диоды общего назначения на основе p-n-перехода характеризуются
высокими значениями обратного напряжения и прямого тока
В ключевом режиме работы силового биполярного транзистора рабочая точка может находиться в следующих положениях
в точке отсечки
в точке насыщения
В активном режиме работы биполярного транзистора
выходной ток равен входному току
выходной ток прямо пропорционален входному току
выходной ток обратно пропорционален входному току
К основным статистическим параметрам силовых биполярных транзисторов относятся
максимально допустимый ток коллектора
ток обратного смещенного коллекторного перехода
Транзисторы Дарлингтона используют для
увеличения коэффициента передачи тока в силовых высоковольтных транзисторах
В симметричных силовых биполярных транзисторах области коллектора и эмиттера имеют
одинаковые свойства и геометрические размеры
Для перехода биполярного транзистора p-n-p-типа в режим насыщения необходимо сместить переходы
эмиттер-база — в прямом направлении
коллектор-база — в прямом направлении
коллектор-база — в обратном направлении
эмиттер-база — в обратном направлении
Транзистор — это
полупроводниковый полностью управляемый прибор с тремя и более выводами
В структуре биполярного транзистора крайний слой, являющийся источником носителей зарядов, называется
эмиттер
Коэффициент насыщения биполярного транзистора прямо пропорционален
току базы в насыщенном режиме
току коллектора в насыщенном режиме
току базы в граничном режиме
Силовой биполярный транзистор в точке отсечки находится в
закрытом состоянии и характеризуется очень малым током
Для перехода биполярного транзистора p-n-p-типа в режим отсечки необходимо сместить переходы
коллектор-база — в обратном направлении
эмиттер-база — в обратном направлении
Для перехода биполярного транзистора p-n-p-типа в активный режим необходимо сместить переходы
Выберите один или несколько ответов:
эмиттер-база — в прямом направлении
коллектор-база — в обратном направлении
Граничное условие перехода биполярного транзистора p-n-p-типа из активного режима в режим отсечки
Выберите один ответ:
напряжение между базой и эмиттером равно нулю
напряжение между базой и коллектором меньше нуля
напряжение между базой и коллектором равно нулю
напряжение между базой и эмиттером меньше нуля
В основе биполярного транзистора лежит
трехслойная полупроводниковая структура
Коэффициент передачи тока в транзисторе Дарлингтона равен
произведению коэффициентов передачи тока двух составных транзисторов
В активном режиме биполярного транзистора большая часть неосновных носителей, перешедших из эмиттера в базу, достигает коллекторного p-n-перехода благодаря
малой толщины базы
большой площади коллекторного p-n-перехода
В режиме насыщения биполярный транзистор можно заменить
замкнутым ключом, на котором падает небольшое напряжение
источником тока эмиттера, управляемого током базы
разомкнутым ключом
В режиме отсечки силового биполярного транзистора
выделяемая мощность очень большая, а выходное напряжение очень низкое
выделяемая мощность и выходное напряжение очень большие
выделяемая мощность очень мала, а выходное напряжение высокое
выделяемая мощность и выходное напряжение очень маленькие
В каком режиме может находиться биполярный транзистор в зависимости от полярности приложенного к переходам напряжения
Выберите один или несколько ответов:
инверсном
отсечки
индуктивном
импульсном
В режиме отсечки биполярный транзистор можно заменить
Выберите один ответ:
разомкнутым ключом
источником тока эмиттера, управляемого током базы
замкнутым ключом
источником тока коллектора, управляемого током базы
В ключевом режиме работы биполярного транзистора мощности потерь в точках отсечки и насыщения будут
значительно меньше мощности потерь в рабочей точке линейного режима транзистора
Граничное условие перехода биполярного транзистора p-n-p-типа из активного режима в режим насыщения
напряжение перехода коллектор – база равно нулю
напряжение перехода коллектор – база меньше нуля
напряжение перехода база – эмиттер больше нуля
напряжение перехода база – эмиттер равно нулю
В инверсном режиме работы силового биполярного транзистора p-n-p-типа переходы смещаются
эмиттер-база — в обратном направлении
коллектор-база — в прямом направлении
В активном нормальном режиме силовой биполярный транзистор для малых приращений тока базы можно заменить
источником тока коллектора, управляемого током базы
источником тока эмиттера, управляемого током коллектора
источником тока коллектора, управляемого током эмиттера
источником тока эмиттера, управляемого током базы
В структуре биполярного транзистора крайний слой, принимающий заряды, называется
коллектор
Полевые транзисторы нельзя включать по схеме
с общей базой (ОБ)
Полевой транзистор в линейном режиме используется как
сопротивление, управляемое напряжением на затворе
Какие полевые транзисторы не входят в общую группу по принципу действия
МОП — транзисторы (металл -окисел-полупроводник)
транзисторы с управляющим p-n-переходом (p-n-затвором) (ПТУП)
транзисторы с изолированным затвором (ПТИЗ)
МДП — транзисторы (металл -диэлектрик-полупроводник
Для изготовления высоковольтных DМОП — транзисторов с n-каналом используются
вертикальные структуры с высоколегированной подложкой n+ — типа
Современные МОП-транзисторы обеспечивают коммутацию
токов до 50 А и напряжения до 1000 В
Поделитесь с Вашими друзьями:
снижение потерь в режиме жесткой коммутации
Замена кремниевых сверхбыстрых (Ultrafast) Si-диодов с плавной характеристикой восстановления, используемых в качестве оппозитных IGBT в режиме жесткой коммутации, на карбидокремниевые диоды Шоттки (SiC Schottky) позволяет снизить коммутационные потери в диоде на 80% и в IGBT на 50%.
Введение
Кремниевый (Si) IGBT, сочетающий в себе выходные и динамические характеристики биполярного транзистора и легкость управления MOSFET, стал основным силовым ключом, используемым в режиме жесткой коммутации в высоковольтных (более 500 В) и мощных (более 500 Вт) устройствах. К типичным областям применения относятся инверторы приводов, источники бесперебойного питания, сварочное оборудование и импульсные источники питания (SMPS).
Постоянно растущий спрос на повышение эффективности, упрощение системы охлаждения, уменьшение габаритов элементов силовой электроники, а также более строгие требования к уровню излучаемых помех EMI/RFI и качеству электроэнергии создают новые проблемы для разработчиков. Выполнение этих требований в значительной степени связано со снижением потерь включения IGBT при работе на индуктивную нагрузку в режиме жесткой коммутации. Ток обратного восстановления, наблюдаемый при выключении кремниевых оппозитных диодов, напрямую влияет на потери включения IGBT. Проблема усугубляется тем, что ток обратного восстановления увеличивается с повышением рабочей температуры, тока и di/dt.
Ток обратного восстановления диода и коммутационные потери IGBT могут быть существенно снижены при замене кремниевых оппозитных PiN-диодов на SiC-диоды с барьером Шоттки (SBD). Из-за особенностей кремния изготовить Si-диоды Шоттки с рабочим напряжением выше 200 В невозможно.
SiC-диоды Шоттки
SiC SBD выпускаются с номинальным напряжением 600 и 1200 В, 600-В диоды выпускаются с током 1, 4, 6, 10 и 20 А, 1200-В имеют номинальный ток 5 и 10 А. Основным преимуществом высоковольтных SiC SBD являются отличные динамические характеристики. Они имеют крайне низкий заряд обратного восстановления Qrr, который обусловлен барьерной емкостью, а не накоплением заряда. Кроме того, в отличие от Si-PiN-диодов, этот заряд не зависит от di/dt, прямого тока и температуры. Максимальная температура кристалла +175 °C у SiC SBD является фактической рабочей температурой. Сверхнизкая величина Qrr SiC SBD позволяет уменьшить уровень коммутационных потерь в типовых схемах на основе IGBT, работающих в режиме жесткого переключения. В результате снижается температура корпуса IGBT, повышается эффективность системы, что даже дает возможность использовать менее мощный IGBT. Для оценки преимуществ этих высокопроизводительных диодов была использована тестовая схема диодов с индуктивной нагрузкой, позволяющая измерить динамические потери IGBT и диодов. Это позволило провести сравнение потерь переключения сверхбыстрого кремниевого Si-диода с плавным восстановлением и SiC Cree Zero Recovery SBD и оценить влияние процесса их восстановления на потери переключения IGBT.
Измерительное оборудование

На рис. 1 показана схема, предназначенная для измерения характеристик переключения. В процессе работы на затвор IGBT подается двойной импульс. При тестировании 600-В прибора использовался резистор затвора 10 Ом для задания скорости коммутации 750 А/мкс. Для IGBT 12-го класса использовался резистор 22 Ом, при этом di/dt = 250 А/мкс.
В момент времени T1 IGBT включается, и ток через индуктор увеличивается до тех пор, пока не достигнет требуемого значения в момент T2. При этом IGBT выключается, и ток индуктивности перекоммутируется в диод. Потери включения IGBT и потери включения диодов измеряются в переходном процессе T2.
В момент T2 IGBT выключается, и ток индуктора переходит на оппозитный диод. Потери выключения IGBT и потери включения диодов измеряются в переходном процессе T2. Ток индуктора продолжает течь через диод до тех пор, пока IGBT не будет включен во время T3. Теперь ток индуктора передается из диода обратно в IGBT. Потери включения IGBT и потери выключения диода измеряются в переход- ном процессе T3.
Сравнение характеристик переключения
Параметры коммутации измерялись для 15-А/600-В Ultrafast Si-диода с плавной характеристикой восстановления (такой же используется совместно с 40-А Ultrafast IGBT) и 10-А SiC SBD вместе с потерями 40-А/600-В Si-IGBT. Измерение потерь проводилось при напряжении 500 В и токе 20 A.



На рис. 2 показаны эпюры напряжения, тока и мгновенной мощности, измеренные при выключении Ultrafast Si-диода при температуре кристалла +150 °C. Пик тока обратного восстановления достигает 23 А,время восстановления — 100 нс, пиковая мгновенная мощность —7 кВт. На рис. 2 видно перенапряжение 200 В, вызванное высокой скоростью изменения тока di/dt при обратном восстановлении.
На рис. 3 показаны эпюры выключения SiC SBD при +150 °C. Пик тока обратного восстановления здесь 4 А (снижение на 83%), время восстановления 33 нс (снижение на 67%), максимальная мгновенная мощность — 0,5 кВт (снижение на 93%). Резкое сокращение мощности переключения обусловлено тем, что SiC SBD должен рассеять лишь небольшой емкостной заряд, и это происходит при низком напряжении на диоде. Перенапряжение, формируемое при коммутации Si-диода, полностью отсутствует у SiC SBD.
На рис. 4 показаны эпюры напряжения, тока и мгновенной мощности при включении IGBT с Ultrafast Si-диодом, измеренные при температуре кристалла +150 °C. Во время включения транзистора ток обратного восстановления диода добавляется к току IGBT, что создает пик, достигающий 44 А. Пиковая мгновенная мощность 15 кВт рассеивается в IGBT. Кроме того, видны высокочастотные колебания на IGBT, возникающие при резком выключении кремниевого диода. Это является одной из основных причин генерации радиочастотных/ электромагнитных помех.
| Параметр | Si Pin при +25/+150 °C | SiC при +25/+150 °C | % снижения при +25/+150 °C |
| Пик тока восстановления Ipr, A | 13/23 | 4 | 69/83 |
| Время обратного восстановления Trr, нс | 83/100 | 30/33 | 64/67 |
| Заряд восстановления Qrr, нс | 560/1220 | 78/82 | 86/93 |
| Потери выключения диода Eoff_d, мДж | 0,11/0,23 | 0,02 | 82/91 |
| Потери включения диода Eon_d, мДж | 0,03 | 0,02 | 33 |
| Потери общие диода Eis_d, мДж | 0,14/0,26 | 0,04 | 71/85 |
| Потери выключения IGBT Eoff_IGBT, мДж | 0,63/0,94 | 0,23/0,24 | 63/74 |
| Потери включения IGBT Eon_IGBT, мДж | 0,46/0,89 | 0,32/0,64 | 30/29 |
| Потери общие IGBT Eis_IGBT, мДж | 1,09 | 0,55/0,64 | 50/28 |
| Потери общие Eis, мДж | 1,23/2,09 | 0,59/92 | 52/56 |
На рис. 5 показаны эпюры напряжения, тока и мгновенной мощности при включении IGBT с SiC SBD, измеренные при температуре кристалла +150 °C. Использование SiC SBD позволяет снизить пик тока до 22 А (на50%), а максимальную мгновенную мощность до 7,5 кВт (снижение на 50%). Также видно, что при этом отсутствуют высокочастотные осцилляции, что приводит к уменьшению генерации помех RFI/EMI.



Сравнение параметров переключения SiC SDB и Ultrafast Si-диодов приведено для температур кристалла +25 и +150 °C в таблице 1. Можно видеть, что общее снижение потерь переключения (IGBT + диод) составляет 52% при +25 °C и 56% при +150 °С.
На рис. 6 показаны токи выключения Si Ultrafast и SiC SBD при +25 и +150 °C, наложенные в одном масштабе. Параметры SiC SBD не зависят от температуры, пиковый ток восстановления — 5 А. Ток восстановления Ultrafast Si-диода заметно меняется с температурой,увеличиваясь с 13 А при +25 °C до 23 А при +150 °С.
На рис. 7 показаны кривые токов включения IGBT с Si Ultrafast и SiCSBD при температуре +25 и +150 °С, наложенные друг на друга. Пиковый ток IGBT с SiC SBD не зависит от температуры. Вариант с диодомSi Ultrafast показывает сильную температурную зависимость, связанную с высокой термозависимостью тока обратного восстановления.


На рис. 8 показаны суммарные динамические потери диода (включение и выключение) при частоте коммутации от 10 до 100 кГц и температуре +50, +100 и +150 °C. SBD имеет значительно меньшие потери (снижение до 85%), не меняющиеся с ростом температуры.
На рис. 9 показаны суммарные динамические потери IGBT (включение и выключение) при частоте коммутации от 10 до 100 кГц и температуре +50, +100 и +150 °C. Потери транзистора с SiC SBD примерно в два раза ниже, чем с Ultrafast Si-диодом. Этот вариант также демонстрирует гораздо меньшую зависимость от температуры. Температурная зависимость потерь переключения IGBT с SiC SBD обусловлена увеличением времени выключения транзистора, при этом потери включения не меняются с нагревом прибора. Такое заметное улучшение динамических свойств IGBT объясняется, в первую очередь, отсутствием процесса обратного восстановления SiC SBD.
Сравнение характеристик переключения 1200-В приборов
Параметры переключения измерялись для 8 А/1200 В Ultrafast Si-диода (такой же используется совместно с 11-А сверхбыстрым IGBT) и 5-А SBD, вместе с потерями 11 А/1200 В IGBT. Измерение потерь проводилось при напряжении 1000 В и токе 5 A. Максимальная температура кристалла при испытаниях составляла +125 °С, поскольку при температуре +150 °С начинается тепловое «убегание» IGBT.



На рис. 10 показаны эпюры напряжения, тока и мгновенной мощности при выключении Ultrafast Si-диода при температуре кристалла +125 °C. Пик тока обратного восстановления достигает 6 А, время восстановления — 148 нс, мгновенная пиковая мощность — 2,8 кВт. Перенапряжение на 600-В Si-диоде не является ярко выраженным, поскольку тестирование происходило при низком значении di/dt (250 вместо 750 А/мкс).
На рис. 11 показано выключение SiC SBD при температуре кристалла +125 °C.
Использование SiC SBD позволяет уменьшить пик тока до 1 А (снижение на 83%), время восстановления — до 30 нс (снижение на 80%), а максимальную мгновенную мощность — до 0,3 кВт (снижение на 89%).Такое значительное уменьшение пиковой мощности объясняется тем,что SBD рассеивает только емкостной заряд при низком напряжении.
На рис. 12 показаны эпюры напряжения, тока и мгновенной мощности при включении IGBT с Ultrafast Si-диодом при температуре кристалла +125 °C. В процессе включения ток обратного восстановления диода добавляется к току IGBT, что создает пик 11,7 А. Мгновенная мощность, рассеиваемая при этом транзистором, составляет 11 кВт.



На рис. 13 показаны эпюры напряжения, тока и мгновенной мощности при включении IGBT с SBD при температуре кристалла +125 °C. Использование SBD позволяет уменьшить пик тока до 6,7 А (снижение на 42%), а максимальную мгновенную мощность — до 6,2 кВт (снижение на 44%).
На рис. 14 показаны эпюры токов выключения Ultrafast Si-диода и SiC SBD при температуре +25 и +125 °C, наложенные друг на друга. Параметры SiC SBD неизменны с температурой, пиковый ток восстановления — 1 А. Диоды Si Ultrafast демонстрируют сильную температурную зависимость, ток увеличивается с 5 А при +25 °C до 6 А при +150 °С. Время обратного восстановления Si Ultrafast растет со 100 нс при +25 °C до 148 нс при +125 °С, в то время как параметр trr у SiC SBD при тех же условиях остается неизменным.
На рис. 15 показаны эпюры токов включения IGBT с Ultrafast Si-диодом и SiC SBD при температуре +25 и +125 °C, наложенные друг на друга. Пик тока IGBT с SiC SBD не зависит от температуры. Пиковый ток и время обратного восстановления IGBT с Ultrafast Si-диодом демонстрируют сильную температурную зависимость вследствие термозависимости процесса обратного восстановления.



На рис. 16 показаны суммарные динамические потери диода (включение и выключение) при частоте коммутации от 10 до 100 кГц и температурах +25, +75 и +125 °C. SiC SBD имеет значительно меньшие потери переключения (снижение до 75%), которые не зависят от температуры.
| Параметр | Si Pin при +25/+150 °C | SiC при +25/+150 °C | % снижения при +25/+150 °C |
| Пик тока восстановления Ipr, A | 5,5/6 | 1 | 82/83 |
| Время обратного восстановления Trr, нс | 100/148 | 30 | 70/80 |
| Заряд восстановления Qrr, нс | 295/540 | 20 | 93/95 |
| Потери выключения диода Eoff_d, мДж | 0,08/0,16 | 0,02 | 75/88 |
| Потери включения диода Eon_d, мДж | 0,03 | 0,02 | 33 |
| Потери общие диода Eis_d, мДж | 0,11/0,19 | 0,04 | 64/79 |
| Потери выключения IGBT Eoff_IGBT, мДж | 0,73/0,98 | 0,28 | 62/71 |
| Потери включения IGBT Eon_IGBT, мДж | 0,33/0,57 | 0,25/0,41 | 24/28 |
| Потери общие IGBT Eis_IGBT, мДж | 1,06/1,55 | 0,53/0,69 | 50/55 |
| Потери общие Eis, мДж | 1,17/1,74 | 0,57/0,73 | 51/58 |
На рис. 17 показаны суммарные динамические потери IGBT (включение и выключение) при частоте коммутации от 10 до 100 кГц и температурах +25, +75 и +125 °C. Потери транзистора с SiC SBD примерно в два раза ниже, чем с Si Ultrafast. У этого варианта также меньше температурная зависимость потерь. Ее наличие объясняется тем, что с ростом температуры растет время выключения, а потери включения остаются при этом неизменными. Такое заметное улучшение динамических свойств IGBT объясняется, в первую очередь, отсутствием процесса обратного восстановления SiC SBD.
Потери проводимости и общие потери
На рис. 18 показана прямая вольт-амперная характеристика 1200-В Ultrafast Si-диода и SiC SBD при температурах +25 и +125 °С. При токе 5 А прямое падение напряжения SiC SBD меньше на 0,75 В при 25 °Си на 0,18 В при +125 °С, таким образом, SiC-диод имеет меньшие потери проводимости.
| Параметр | Si Pin | SiC | % снижения |
| Потери диода динамические, Вт | 19 | 4 | 79 |
| Потери диода статические, Вт | 12,5 | 11,7 | 6 |
| Потери общие диода, Вт | 31,5 | 15,7 | 50 |
| Потери IGBT динамические, Вт | 155 | 69 | 55 |
| Потери IGBT статические, Вт | 14,5 | 14,5 | 0 |
| Потери общие IGBT, Вт | 169,5 | 83,5 | 51 |
| Потери общие, Вт | 201 | 99,2 | 51 |
В таблице 3 приведены расчеты суммарных потерь для преобразователя на модулях 12-го класса, работающего с частотой коммутации 100 кГц с коэффициентом заполнения 50% при среднем токе 2,5 А. Расчеты делались для температуры кристаллов +125 °С. Справочное значение потерь проводимости IGBT составляет 2,9 В при 5 А. При использовании SiC SBD общие потери диода уменьшаются на 50%, а потери IGBT — на 51%. Таким образом, простая замена Ultrafast Si-диодов на SiC SBD обеспечивает снижение потерь 1200-В конвертера на 51%.
Заключение
Потери включения IGBT в значительной степени зависят от характеристик обратного восстановления оппозитного диода. Параметры SiC SBD оказывают большое влияние на динамические свойства как самого диода, так и IGBT в режиме жесткой коммутации. Представленные выше результаты измерений демонстрируют значительные преимущества SiC-диодов Шоттки. В то время как ток обратного восстановления Ultrafast Si-диодов демонстрирует сильную зависимость от температуры, параметры SiC SBD остаются неизменными. При высоких значениях di/dt Ultrafast Si-диоды генерируют перенапряжение при выключении, в отличие от них SiC SBD практически не генерируют перенапряжения благодаря отсутствию тока обратного восстановления. Резкое выключение Si Ultrafast создает паразитные осцилляции напряжения на IGBT,что, в свою очередь, приводит к генерации радиочастотных/электромагнитных помех. Этот эффект также отсутствует у SiC SBD.
Снижение потерь переключения на 50% можно использовать для оптимизации характеристик устройства несколькими различными способами. Например, это дает возможность увеличения эффективности преобразователя, снижения требований к системе охлаждении или использования IGBT с меньшим номинальным током. Также это позволяет увеличить рабочую частоту и, соответственно, уменьшить размеры пассивных компонентов или улучшить акустические характеристики. Отсутствие коммутационных перенапряжений устраняет необходимость в снабберных цепях. Отсутствие высокочастотных осцилляций уменьшает требования к фильтрам RFI/EMI. Замена Ultrafast Si-диодов на SiC-диоды Шоттки, такие как Cree Zero Recovery SBD, приводит к существенному снижению коммутационных потерь как в диоде, так и в IGBT, что дает значительное улучшение характеристик всей системы.
Автор
Джим Ричмонд(Jim Richmond)
Перевод
Евгений Карташов
Валерия Смирнова — продакт-менеджер компании Макро Групп. [email protected]
Статья была опубликована в журнале «Силовая электроника», № 1’2018.
1.3 Расчет потерь в диодах
2.2. Порты ввода/вывода информации
Все четыре порта МК51 предназначены для ввода или вывода информации побайтно. Схемотехника портов ввода/вывода МК51 для одного бита показана на рис. 2.4 (порты 1 и 2 имеют примерно такую же структуру, как и порт 3). Каждый порт содержит управляемые регистр-защелку, входной буфер и выходной драйвер.
Рисунок 2.4 — Схемотехника портов ввода/вывода МК51:
а — порт 0; б — порт 3
Выходные драйверы портов 0 и 2, а также входной буфер порта 0 используются при обращении к внешней памяти (ВП). При этом через порт 0 в режиме временного мультиплексирования сначала выводится младший байт адреса ВП, а затем выдается или принимается байт данных. Через порт 2 выводится старший байт адреса в тех случаях, когда разрядность адреса равна 16 бит.
Все выводы порта 3 могут быть использованы для реализации альтернативных функций, перечисленных в табл. 2.3. Альтернативные функции могут быть задействованы путем записи 1 в соответствующие биты регистра-защелки (Р3.0 — Р3.7) порта 3.
Порт 0 является двунаправленным, а порты 1, 2 и 3 — квазидвунаправленными. Каждая линия портов может быть использована независимо для ввода или вывода информации. Для того чтобы некоторая линия порта использовалась для ввода, в D-триггер регистра-защелки порта должна быть записана 1, которая закрывает МОП-транзистор выходной цепи.
По сигналу СБР в регистры-защелки всех портов автоматически записываются единицы, настраивающие их тем самым на режим ввода.
Все порты могут быть использованы для организации ввода/вывода информации по двунаправленным линиям передачи. Однако порты 0 и 2 не могут быть использованы для этой цели в случае, если МК-система имеет внешнюю память, связь с которой организуется через общую разделяемую шину адреса/данных, работающую в режиме временного мультиплексирования.
Таблица 2.3 — Альтернативные функции порта 3
| Символ | Позиция | |
| P3.7 | Чтение. Активный сигнал низкого уровня формируется аппаратурно при обращении к ВПД | |
| P3.6 | Запись. Активный сигнал низкого уровня формируется аппаратурно при обращении к ВПД | |
| Tl | P3.5 | Вход таймера/счетчика 1 или тест-вход |
| T0 | P3.4 | |
| P3.3 | Вход запроса прерывания 1. Воспринимается сигнал низкого уровня или срез | |
| P3.2 | Вход запроса прерывания 0. Воспринимается сигнал низкого уровня или срез | |
| TXD | P3.1 | Выход передатчика последовательного порта в режиме УАПП. Выход синхронизации в режиме сдвигающего регистра |
| RXD | P3.0 | Вход приемника последовательного порта в режиме УАПП. Ввод/вывод данных в режиме сдвигающего регистра |
В микроконтроллерных системах, построенных на основе МК51, возможно использование двух типов внешней памяти: постоянной памяти программ (ВПП) и оперативной памяти данных (ВПД). Доступ к ВПП осуществляется при помощи управляющего сигнала , который выполняет функцию строб-сигнала чтения. Доступ к ВПД обеспечивается управляющими сигналами и , которые формируются в линиях Р3.7 и Р3.6 при выполнении портом 3 альтернативных функций (см. табл. 2.3).
При обращении к ВПП всегда используется 16-битный адрес. Доступ к ВПД возможен с использованием 16-битного адреса (MOVX А, @ DPTR) или 8-битного адреса (MOVX A,@ Ri).
В любых случаях использования 16-битного адреса старший байт адреса фиксируется (и сохраняется неизменным в течение одного цикла записи или чтения) в регистре-защелке порта 2.
Если очередной цикл внешней памяти (MOVX A,@ DPTR) следует не сразу же за предыдущим циклом внешней памяти, то неизменяемое содержимое регистра-защелки порта 2 восстанавливается в следующем цикле. Если используется 8-битный адрес (MOVX A,@ Ri), то содержимое регистра-защелки порта 2 остается неизменным на его внешних выводах в течение всего цикла внешней памяти.
Через порт 0 в режиме временного мультиплексирования осуществляется выдача младшего байта адреса и передача байта данных. Сигнал САВП должен быть использован для записи байта адреса во внешний регистр. Затем в цикле записи выводимый байт данных появляется на внешних выводах порта 0 только перед появлением сигнала . В цикле чтения вводимый байт данных принимается в порт 0 по фронту стробирующего сигнала .
При любом обращении к внешней памяти устройство управления МК51 загружает в регистр-защелку порта 0 код OFFH, стирая тем самым информацию, которая могла в нем храниться.
Доступ к ВПП возможен при выполнении двух условий: либо на, вход отключения резидентной памяти программ () подается активный сигнал, либо содержимое счетчика команд превышает значение 0FFFH. Наличие сигнала необходимо для обеспечения доступа к младшим 4К адресам адресного пространства ВПП при использовании МК31 (микроконтроллера без резидентной памяти программ).
Временные диаграммы на рис. 2.5 иллюстрируют процесс генерации управляющих сигналов САВП и при обращении к внешней памяти.
Основная функция сигнала САВП — обеспечить временное согласование передачи из порта 0 на внешний регистр младшего байта адреса в цикле чтения из ВПП. Сигнал САВП приобретает значение 1 дважды в каждом машинном цикле. Это происходит даже тогда, когда в цикле выборки нет обращения к ВПП. Доступ к ВПД возможен только в том случае, если сигнал САВП отсутствует. Первый сигнал САВП во втором машинном цикле команды MOVX блокируется. Следовательно в любой МК-системе, не использующей ВПД, сигнал САВП генерируется с постоянной частотой, равной 1/16 частоты резонатора, и может был использован для синхронизации внешних устройств или для реализации различных временных функций.
При обращении к РПП сигнал не генерируется, а при обращении к ВПП он выполняет функцию строб-сигнала чтения. Полный цикл чтения ВПД, включая установку и снятие сигнала , занимает 12 периодов резонатора.
Временные диаграммы на рис. 2.6 и 2.7 иллюстрируют процесс выборки команды из ВПП и работу с ВПД в режимах чтения и записи соответственно.
Рисунок 2.5 — Временные диаграммы операций с обращением к внешней памяти
Особый режим работы МК51. Содержимое памяти программ МК51 заполняется единожды на этапе разработки МК-системы и не может быть модифицировано в завершенном (конечном) изделии. По этой причине микроконтроллеры не являются машинами классической «фон-неймановской» архитектуры. Оперативная память данных (резидентная или внешняя) не может быть использована для хранения кодов программы, так как в МК выборка команд производится только из области адресов памяти программ. Эта особенность архитектуры МК объясняется тем, что в большинстве применений МК требуется наличие одной неизменяемой прикладной программы, хранимой в ПЗУ, наличие ОЗУ небольшой емкости для временного хранения переменных и эффективных, а следовательно, разных методов адресации памяти программ и памяти данных.
Однако на этапе разработки и отладки прикладных программ машина «фон-неймановского» типа оказывается очень удобной, так как позволяет разработчику оперативно изменять коды прикладной программы, размещаемой в ОЗУ. С этой целью МК-система может быть модифицирована для совмещения адресного пространства ВПП и ВПД путем подключения внешней логики, как показано на рис. 2.8.
Рисунок 2.6 — Временная диаграмма выборки команды из ВПП
Рисунок 2.7 — Временная диаграмма работы с ВПД
Здесь на выходе схемы И формируется строб-сигнал чтения, который может быть использован для объединения памяти программ и памяти данных во внешнем ОЗУ. При этом необходимо учитывать, что в МК51 на схемном уровне реализуются пять различных и независимых механизмов адресации для доступа к ПРР РПД, ВПП, ВПД и блоку регистров специальных функций. Вследствие этого перемещаемая версия прикладной программы, которая отлаживается в среде внешней памяти программ/данных, будет отличаться от загружаемой в РП (окончательной) версии программы.
Рисунок 2.8 — Схема совмещения адресного пространства ВПП и ВПД
Подобный способ организации управления внешней памятью может быть использован в тех применениях МК51, где требуется оперативная перезагрузка или модификация прикладных программ (с помощью УВВ), как в ЭВМ классической архитектуры.
Каковы потери мощности от диодного моста при преобразовании переменного тока в постоянный?
Всяк представил по своему.. . Не когда напряжение после однофазного выпрямительного моста не бывает выше питающего ! О сглаживающих конденсаторах речь не ведем, именно они позволяют получить выпрямленное напряжение большей величины, нежели выпрямляемое. На самом деле, на выходе мостовой схемы Греца, напряжение составляет 0,9 Uвходного. А так как токи входа и выхода равны, то потери мощности составят 10%. Если речь идет о конкретных потребителях, то их мощность упадет более чем на 10%, так как при меньшем напряжении и ток будет ниже. Тогда мощность составит примерно 0,81, а это уже 19% потери мощности номинальной, но не потребляемой. Потери потребляемой мощности по прежнему будут составлять 10% !!! Миллиметровать, учитывая прямые падения на переходах, в данном случае вряд-ли нужно.. . Но если уж очень нужно, то их следует приплюсовать к выше указанным 10%, тогда уже цифра будет выражена во втором приближении, и как следствие будет более точной. При трехфазных схемах выпрямления, Миткевича, и Ларионова, цифры будут другими, но они, как мне представляется, не именуются мостовыми.. . Ответ не претендует на истину в последней инстанции, по этому вам выбирать.. . Выслушайте всех, и сделайте выводы.
У диодов есть внутренне сопротивление перехода. Это приводит к падению напряжения на диодах. Этот параметр называется прямым падением напряжения (forward voltage) и указывается в данных на диод. Умножаем падение напряжения на ток — получаем потерю мощности.
в дополнение к первому ответу учитываем, что ток течет через 2 диода сразу, т. е. потерю умножаем на 2
зато посля диодного моста напряжение всегда на 10-15 % выше, это уже проверено не один раз!
В одном диоде на низких частотах рассеивается мощность, Вт: Pd=Uпр. мин*Iср+Iср^2*Rd Uпри. мин — прямое минимальное падение напряжения, В Iср — средний ток диода, А Iср^2 — средний ток диода в квадрате Rd — динамическое сопротивление диода, Ом Все данные берутся из справочника. Упрощенно. . На кремниевом диоде падает Uпр ~0,7 В, на диоде с барьером Шоттки ~0.15 В, на германиевом диоде ~ 0,2 В. Для мостовой схемы выпрямителя потеря напряжения будет 1,4 В (0,3 В или 0,4 В) . Мощность 2*Uпр*Iвыпрямленный.
1.3.3. Динамические режимы работы силовых транзисторов
Переход транзистора из выключенного состояния во включенное и наоборот происходит не мгновенно, а в течение характерного для каждого типа транзистора времени (рис.1.17).
Инерционность переходных процессов обусловлена инерционностью процессов изменения концентрации носителей электрических зарядов в структуре транзистора и наличием в ней внутренних (собственных) емкостей. Емкости, называемые иногда «паразитными», определяют быстродействие транзистора.
Ранее было показано, что на динамические режимы работы ключей влияют их быстродействие и параметры внешней цепи, в которой происходит коммутация. Рассмотрим процессы, обусловливающие быстродействие биполярных транзисторов как ключевых приборов. Для качественной оценки принимается допущение, что нагрузкой является активное сопротивление.
Включение
биполярного транзистора. Предположим,
что транзистор при t
< t0 находится
в режиме отсечки (выключен) и в момент
времени t
= t0 (рис. 1.17, б)
в
базу транзистора от источника тока
управления поступает импульс тока
значением  >
>  с
идеально крутым фронтом.
с
идеально крутым фронтом.
Рис. 1.17. Динамические процессы в биполярном транзисторе:
а – схема замещения; б – диаграммы
Так
как напряжение на входной емкости СВЕ не
может измениться скачком, начинается
процесс ее заряда до напряжения  при
котором увеличивается ток базового
перехода транзистора
(момент времени t1).
Этот процесс определяется временем
задержки на включение
при
котором увеличивается ток базового
перехода транзистора
(момент времени t1).
Этот процесс определяется временем
задержки на включение  транзистора. В момент времени t
= t2 заряд Q, в
базовом переходе достигает
граничного значения
транзистора. В момент времени t
= t2 заряд Q, в
базовом переходе достигает
граничного значения  , соответствующего
наступлению режима насыщения. При этом
дальнейшее увеличение тока коллектора iс прекращается,
а накопление
избыточного заряда ΔQ в базе будет продолжаться до момента
времени t
= t 3.
, соответствующего
наступлению режима насыщения. При этом
дальнейшее увеличение тока коллектора iс прекращается,
а накопление
избыточного заряда ΔQ в базе будет продолжаться до момента
времени t
= t 3.
Время
нарастания  тока коллектора iС при iВ >>
тока коллектора iС при iВ >> называют
длительностью
фронта включения транзистора. Время
включения транзистора tвкл состоит
из времени задержки на включение и
времени нарастания тока коллектора
называют
длительностью
фронта включения транзистора. Время
включения транзистора tвкл состоит
из времени задержки на включение и
времени нарастания тока коллектора  =
=  +
+  .
.
Если учесть инерционность, создаваемую выходной емкостью транзистора ССВ, окончательный спад напряжения иСЕ будет происходить несколько позже момента времени t2.
Выключение
биполярного транзистора. Предположим,
что в момент времени t = t4 в базу насыщенного транзистора поступает
отрицательный (запирающий)
импульс тока iВ2. Под
воздействием этого тока начинается
интенсивное рассасывание
избыточного заряда Q до значения Q = • В
момент времени t = t5 транзистор
выходит из режима насыщения. Время
рассасывания избыточного заряда
соответствует времени задержки на
выключение
• В
момент времени t = t5 транзистор
выходит из режима насыщения. Время
рассасывания избыточного заряда
соответствует времени задержки на
выключение  .
.
Общее
время выключения транзистора tвыкл =  выкл +
выкл +  ,
где
,
где  — длительность
спада тока коллектора до наступления
режима отсечки, т. е. длительность фронта
выключения. Восстановление
выходного напряжения
— длительность
спада тока коллектора до наступления
режима отсечки, т. е. длительность фронта
выключения. Восстановление
выходного напряжения  закончится позже момента времени
закончится позже момента времени  ,
когда ток
,
когда ток  станет равным нулю из-за наличия
собственной выходной емкости транзистора
станет равным нулю из-за наличия
собственной выходной емкости транзистора  .
.
Включение МОП- транзистора. Отсутствие явлений накопления и рассасывания неосновных носителей заряда обусловливает высокое быстродействие полевых транзисторов. Однако из-за особенностей структуры МОП- транзисторов значения межэлектродных емкостей в них больше, чем в биполярных. На рис. 1.18, а приведена схема замещения МОП- транзистора межэлектродными емкостями: СDS сток-исток, СDG сток-затвор, СDG затвор-исток.
Предположим
что МОП- транзистор находится в состоянии
отсечки (закрыт).В
момент времени t
= t0 (рис. 1.18, б)
на
его затвор подается сигнал управления
от источника напряжения управления Uy
внутренним сопротивлением Ry .
Емкость входного конденсатора при
условии, что Rу >> Rн,
может быть определена по: 

 +
+  .
.
При
достижении напряжением на затворе
транзистора порогового значения  в
момент времени t
= t1 транзистор
выходит из режима отсечки и напряжение
сток-исток
в
момент времени t
= t1 транзистор
выходит из режима отсечки и напряжение
сток-исток  уменьшается.
Интервал времени t0 – t1 соответствует времени задержки
на включение транзистора вкл.
В момент времени t = t2 напряжение
уменьшается.
Интервал времени t0 – t1 соответствует времени задержки
на включение транзистора вкл.
В момент времени t = t2 напряжение  увеличивается
и приводит транзистор в открытое
состояние. Этот интервал времени
соответствует длительности фронта
включения транзистора
увеличивается
и приводит транзистор в открытое
состояние. Этот интервал времени
соответствует длительности фронта
включения транзистора  .
.
Общее
время включения
транзистора составляет tвкл =  вкл +
вкл +  . Очевидно,
что при включении МОП-
транзистора, главным фактором, определяющим
его быстродействие, является
скорость заряда входного конденсатора
Сiss.
При этом необходимо отметить,
что при включении транзистора появляется
ток обратной связи истока и затвора
через емкость СGD. Этот
ток, замыкающийся через цепь управления
транзистором,
повышает эффективность емкости
. Очевидно,
что при включении МОП-
транзистора, главным фактором, определяющим
его быстродействие, является
скорость заряда входного конденсатора
Сiss.
При этом необходимо отметить,
что при включении транзистора появляется
ток обратной связи истока и затвора
через емкость СGD. Этот
ток, замыкающийся через цепь управления
транзистором,
повышает эффективность емкости  ,
замедляя спад напряжения
,
замедляя спад напряжения  . Этот
эффект называется эффектом
Миллера, а
емкость СGD —
емкостью
Миллера.
. Этот
эффект называется эффектом
Миллера, а
емкость СGD —
емкостью
Миллера.
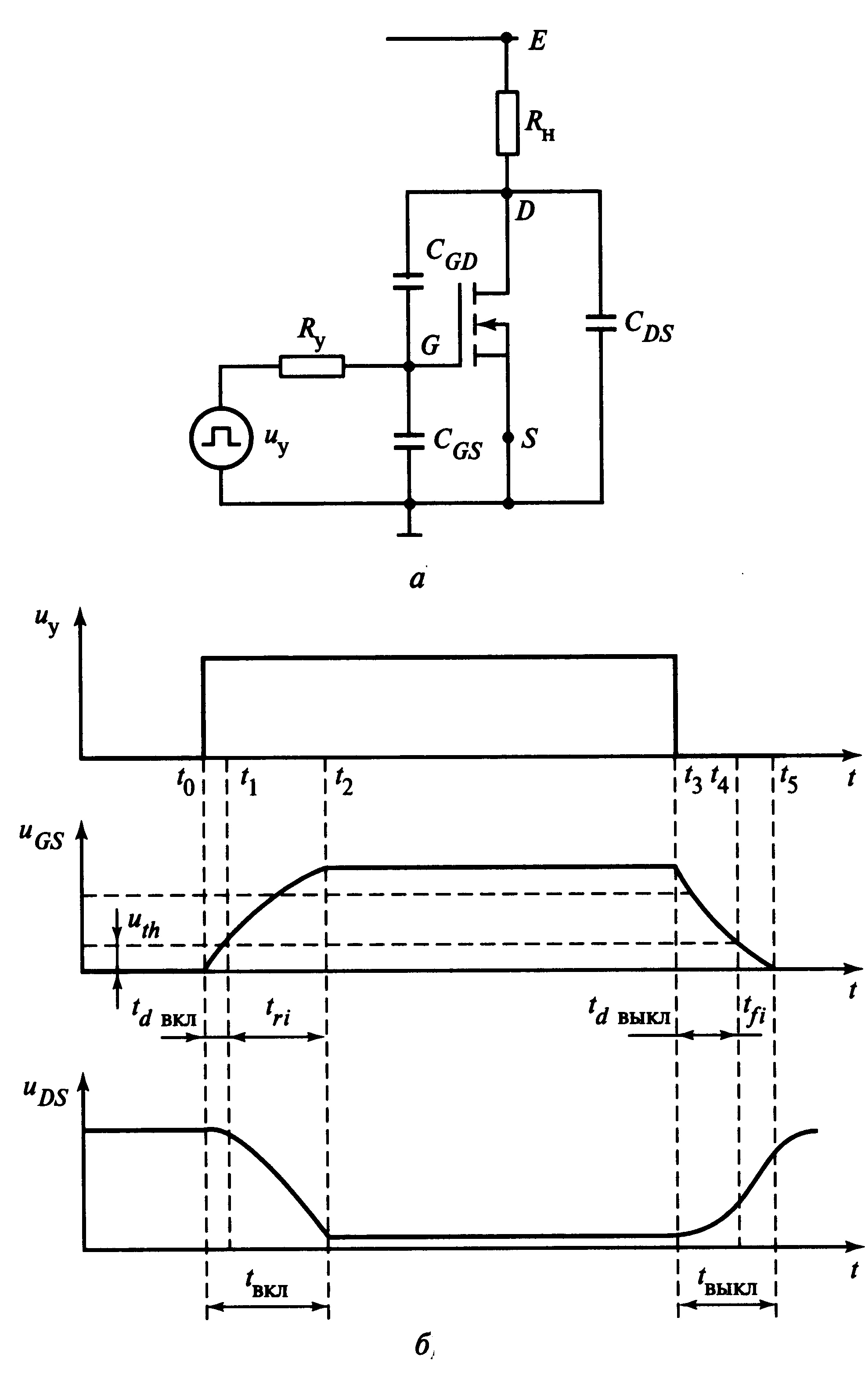
Рис. 1.18. Динамические процессы в МОП- транзисторе:
а – схема замещения; б – диаграммы напряжения
Скорость заряда емкости затвора определяется параметрами источника сигнала управления, поэтому в целях повышения быстродействия часто используют форсированное включение МОП- транзистора от источника тока на начальном интервале включения с последующим поддержанием необходимого сигнала управления от источника напряжения малой мощности.
Выключение МОП- транзистора. При скачкообразном снижении сигнала управления до нуля в момент времени t = t3 начинается выключение транзистора
(
рис. 1.18, б). В начале процесса выключения
на интервале задержки td выкл= t4— t3 напряжение на затворе выше порогового
значения напряжения  . При
этом
напряжении транзистор переходит в
активный режим и напряжение иDS практически
не увеличивается. В момент времени t = t5 напряжение на затворе уменьшается
до нуля и транзистор находится в режиме
отсечки, т.е. в выключенном
состоянии. Интервал времени t4— t5 соответствует длительности фронта
выключения
транзистора
. При
этом
напряжении транзистор переходит в
активный режим и напряжение иDS практически
не увеличивается. В момент времени t = t5 напряжение на затворе уменьшается
до нуля и транзистор находится в режиме
отсечки, т.е. в выключенном
состоянии. Интервал времени t4— t5 соответствует длительности фронта
выключения
транзистора  . Общее
время выключения tВЫКЛ =
. Общее
время выключения tВЫКЛ =  выкл +
выкл +  .
.
Динамические процессы МОПБТ. Быстродействие МОПБТ определяется тем, что они сочетают свойства биполярных и МОП- транзисторов. В начале включения переходные процессы МОПБТ и МОП- транзисторов сходны. На конечном интервале в переходном процессе МОПБТ начинают преобладать свойства биполярного транзистора. Это приводит к затягиванию спада напряжения между коллектором и эмиттером, так как переход биполярного транзистора из активного режима в насыщенный происходит более медленно. При выключении характер переходного процесса вначале сходен с процессом в полевом транзисторе, а на конечном интервале — с биполярным из-за накопления избыточных зарядов в одной из областей его структуры.
Меры по защите силовых транзисторов от теплового пробоя
При разработке силовых схем статических преобразователей первостепенными являются меры по защите силовых транзисторов от теплового пробоя. Поскольку полевые транзисторы MOSFET не имеют вторичного пробоя, в расчетах тепловых режимов вполне можно руководствоваться значениями максимальной температуры и максимальной рассеиваемой мощности. Полная мощность, выделяющаяся на транзисторе в режиме его переключения, определяется из выражения:
где Рп — полная рассеиваемая мощность;
Рпер — потери мощности при переключении;
Рпр — потери на активном сопротивлении канала открытого транзистора;
Pynp — потери на управление в цепи затвора;
Pyr — потери мощности за счет утечки в закрытом состоянии.
где ЛЛ(оп) — сопротивление транзистора в открытом состоянии (справочный параметр).
Потери проводимости Рпр являются основной составляющей потерь в полевом транзисторе. Эти потери можно вычислить, зная эффективное (действующее) значение тока стока:
Потери мощности, вызванные током утечки (P^) пренебрежимо малы (если, конечно, транзистор исправен), поэтому их вообще нет смысла учитывать. Кроме того, поскольку одно из главных преимуществ полевого транзистора — крайне малые потери в цепи его управления (Рупр), — поэтому и значение потерь на управление можно исключить из расчетов. С учетом проведенных допущений формула (2.1.7) для расчета полных потерь приобретает следующий удобный вид:
Здесь необходимо сделать некоторое уточняющее отступление и напомнить читателю, что расчет рассеиваемой мощности выполняется в целях обеспечения теплового режима силовых транзисторов. Этот расчет пригодится при проектировании охлаждающих радиаторов транзисторов (за подробностями можно обратиться к изданиям [1] и [2]). Очень важный параметр, без которого не удастся спроектировать охлаждающий элемент, — это так называемое тепловое сопротивление «кристалл—корпус» Rthjc транзистора. Исследования показали, что это сопротивление в значительной степени зависит от частоты переключения транзистора, а также от скважности управляющих импульсов, определяемой отношением времени открытого состояния к полному периоду коммутации. В технических условиях на транзисторы обычно приводятся так называемые нормированные переходные характеристики теплового сопротивления «кристалл—корпус» (transient thermal impedance junction-to-case). Как видно из рис. 2.1.11, вследствие инерционности тепловых процессов при больших частотах переключения и малой скважности тепловое сопротивление «кристалл—корпус» значительно снижается. В любом случае разработчику нужно произвести оценку этого сопротивления по графику, чтобы не проектировать радиатор охлаждения силовых элементов «на глазок». Читателю следует знать, что показанные на рис. 2.1.11 графики включаются в основной набор параметров, представляемых фирмами-производителями на силовую элементную базу. Если при выборе элементной базы разработчик столкнется с тем, что эти графики в документации отсутствуют, такой фирме-производителю лучше не доверять и ее продукцию не использовать в своих разработках.
С учетом графиков 2.1.11 тепловое сопротивление «кристаллкорпус» определяется по следующей формуле:
где ZjJJ, D) — переходной коэффициент сопротивления «кристаллкорпус»;
RQ{JC) — тепловое сопротивление «кристалл—корпус» в режиме больших скважностей управляющих импульсов или на постоянном токе.
На рис. 2.1.11 есть еще одна кривая, называемая single pulse (одиночный импульс). Снимается она для одиночного (неповторяющегося) импульса тока. Такой режим работы обычно используется для защитных схем и схем запуска, которые срабатывают один раз. В этом случае, как правило, тепловыделение невелико и силовому элементу радиатор не требуется.
Но вернемся к тепловым потерям. Гораздо сложнее дело обстоит с потерями переключения. Если нагрузка полевого транзистора чисто
Рис. 2.1.11. График зависимости нормированного теплового сопротивления от частоты и скважности импульсов: а — IRFP250; б — IRJL3103D1; в —FB180SA10
активная, потери на переключение невелики, и ими зачастую можно просто пренебречь. Однако активная нагрузка — случай в силовой преобразовательной технике редкий. Гораздо чаще транзисторы статических преобразователей «работают» на нагрузки с сильно выраженной реактивной (индуктивно-емкостной) составляющей, что характеризуется несовпадением максимумов токов и напряжений. Кроме того, в транзисторах, работающих в двухтактных схемах (сюда включаются полумостовые, мостовые и трехфазные схемы), возникают специфические потери обратного восстановления оппозитных диодов. Мы сразу обратимся к методикам расчета динамических потерь в двухтактных схемах, поскольку именно на их основе строится мощная преобразовательная техника.
Но прежде, чем приступить к рассказу о методике расчета динамических потерь, еще раз напомним читателю о наличии паразитного диода в составе полевого транзистора. Как уже было сказано выше, этот диод не отличается хорошими динамическими характеристиками, имеет большое время обратного восстановления. Поэтому его влияние на тепловой режим будет значительным и, зная это, производители приводят в технической документации всю необходимую информацию по его параметрам.
В двухтактной схеме необходимо рассматривать влияние индуктивности L на остальные элементы схемы. Следует помнить, что реально индуктивность L — это индуктивность намагничивания первичной обмотки высокочастотного трансформатора (если проектируемое устройство — статический преобразователь для питания типовых нагрузок), или индуктивность обмотки двигателя (если разрабатывается регулируемый частотный электропривод).
Обратимся к рис. 2.1.12 и рассмотрим коммутационные процессы, происходящие в представленной типовой схеме. Первоначально (что
отражено на рис. 2.1.12, 6) ключ VT1 замкнут, поэтому происходит передача энергии к индуктивности L. Если данная индуктивность представляет собой первичную обмотку трансформатора, то ток намагничивания не очень заметен на фоне тока реакции вторичной обмотки (если во вторичной цепи трансформатора «висит» номинальная нагрузка). Если же величина индуктивности достаточно велика, что наблюдается в устройствах частотного регулирования электродвигателей, индуктивный ток будет ярко-выраженным. Далее, как показано на рис. 2.1.12, e, ключ VT1 размыкается, но ток в индуктивности L, стремясь сохранить свою величину, замыкается через паразитный диод VD2, который коммутирует один из выводов индуктивности к «земле», а другой ее вывод по-прежнему останется присоединенным к средней точке конденсаторов C1 и C2. Напряжение, прикладываемое к выводам индуктивности L, заставляет ток iL быстро падать к нулевому значению. Замыкание ключа VT2 повторяет процесс, но уже в другой части полумоста (рис. 2.1.12, г). На первый взгляд, никаких ком-, мутационных токовых бросков не наблюдается — так оно и было бы, если бы схемы состояли из идеальных элементов. Однако в реальных схемах коммутационные броски возникают, и вот почему. Связано это именно с неидеальным характером элементов. Реальные трансформаторы имеют индуктивности рассеяния, межвитковые и межобмоточные емкости, паразитные емкостные связи с другими составляющими схем. Сочетание индуктивностей и емкостей образует колебательную систему (резонансный контур), которая накапливает энергию и производит выбросы напряжения с большой амплитудой (рис. 2.1.13). На этом рисунке показана диаграмма напряжения в точке соединения обмотки трансформатора и средней точки плеча полумоста реальной силовой схемы. При отсутствии переключений в этой точке имеется потенциал, равный половине питающего напряжения. Коммутационный выброс и последующие колебания происходят при
размыкании ключевого элемента. Понятно, что амплитуда выбросов не может стать больше напряжения питания или потенциала «земли», так как оппозитные диоды будут открываться и «разряжать» выбросы на источник питания. И все же, если энергия колебательного процесса достаточно велика, он может не закончиться к моменту следующего открытия ключевого элемента. Коммутация при протекании тока через обратный диод приведет к ситуации так называемого «тяжелого переключения», когда силовой транзистор будет кратковременно находиться в режиме «сквозных токов». Чтобы «погасить» эти выбросы, параллельно первичной обмотке трансформатора включают RC-цепь с последовательно соединенными конденсатором и резистором.
Только что мы рассмотрели так называемый «облегченный» режим работы транзистора в двухтактных схемах, когда управляющие импульсы поступают на затворы VT1 и VT2 симметрично, и в моменты начала коммутации токи через оппозитные диоды не проходят. Рассчитать мощность потерь переключения в данном случае несложно. Для каждого транзистора, работающего в полумостовой или мостовой схеме со стандартной трансформаторной нагрузкой, она может быть рассчитана по формуле
где /^тах — максимальный ток стока.
Встречается и другой случай, когда транзисторы вынуждены работать в «тяжелом» режиме переключения. Этот случай обычно рассматривают в устройствах частотного управления двигателями, имеющими значительную индуктивность обмоток. Здесь длительность открытого состояния «верхнего» (VT1) и «нижнего» (VT2) ключевых элементов полумоста и моста могут быть неравными: в предельном случае открывающие импульсы одного из силовых ключей вообще исчезают. В случае несимметрии управляющих импульсов ток в индуктивной нагрузке не меняет своего направления, а это значит, что, например, после выключения транзистора VT2 ток iL (рис. 2.1.12 в) будет протекать через его оппозитный диод. Следовательно, выключение транзистора VT1 пройдет в режиме кратковременного короткого замыкания, так.как диод VD2 не сможет мгновенно восстановить запертое состояние. Чем дольше оппозитный диод будет задерживать восстановление запертого состояния, тем больше тепла выделится на транзисторе. Поэтому для расчета потерь переключения в «тяжелом» режиме необходимо учитывать как динамические потери переключения транзистора, так и потери на обратное восстановление оппозитных диодов. Рассчитать потери переключения здесь поможет следующая формула:
где Qrr — заряд обратного восстановления оппозитного диода (справочный параметр).
Также следует знать, что заряд обратного восстановления оппозитного диода (согласно рис. 2.1.14) незначительно зависит от прямого тока, протекающего через диод после отключения транзистора, но в значительной степени определяется величиной изменения прямого тока во времени на этапе обратного восстановления, то есть величины производной тока. На практике это означает, что замедление коммутационного процесса, вызывающего обратное восстановление, может снижать заряд, а значит, и выделяемую энергию. Следовательно, в режиме «тяжелого» переключения необходимо замедлять процесс открывания полевых транзисторов. Снизить скорость открывания может ограничение тока затвора с помощью увеличения затворного резистора, а также шунтирование переходов «сток—исток» транзисторов RC-цепями, ограничивающими скорость переключения. Правда, при этом растут коммутационные динамические потери переключения.
Рис. 2.1.14. Зависимость заряда обратного восстановления диода от скорости коммутационного процесса
Довольно часто в практике разработки статических преобразователей встречаются случаи, когда нужно коммутировать ток, значение которого выше предельного тока одиночного транзистора. И если выбрать более мощный прибор оказывается затруднительно, можно просто включить параллельно несколько приборов, рассчитанных на меньшие токи. Тогда общий ток будет равномерно распределяться по отдельным транзисторам. Для параллельного их соединения нужно иметь приборы с близкими значениями порогового напряжения. Как правило, транзисторы одного типа имеют очень близкие значения порогового напряжения, поэтому крайне нежелательно выбирать для параллельной работы транзисторы разных типономиналов. А еще лучше вообще взять транзисторы из одной производственной партии, изготовленных в единых условиях.
Чтобы обеспечить равномерный прогрев линейки транзисторов, их нужно устанавливать на общий радиатор и, по возможности, ближе друг к другу. Необходимо также помнить, что через два параллельно включенных транзистора можно пропускать в два раза больший ток, не снижая нагрузочной способности одиночных приборов, но при этом входная емкость, а значит, и заряд объединенного затвора, возрастают в два раза. Соответственно, схема управления параллельно соединенными транзисторами должна обладать возможностью обеспечить заданное время коммутации.
Но и здесь есть свои особенности, свои «хитрости». Если соединить затворы полевых транзисторов непосредственно, можно получить весьма неприятный эффект «звона» при выключении — оказывая влияние друг на друга через затворы, транзисторы будут произвольно открываться и закрываться, не подчиняясь сигналу управления. Чтобы исключить «звон», на выводы затворов рекомендуется надевать небольшие ферритовые трубочки, предотвращающие взаимное влияние затворов, как показано на рис. 2.1.15, а.
Данный способ встречается сегодня очень редко (так как технология производства ферритовых трубок достаточно сложна). Более простой и доступный схемотехнический прием показан на рис. 2.1.15, б,
Рис. 2.1.15. Параллельное включение MOSFET: а — с гасящими ферритовыми трубками; б — с затворными резисторами
заключающийся в установке в цепях каждого затвора одинаковых резисторов сопротивлением в десятки—сотни Ом. Величина затворных резисторов обычно выбирается из соотношения:
где Qg — величина заряда затвора для одного транзистора.
После этого необходимо определить величину тока, которую обеспечивает устройство управления затворами транзисторов. Этот ток определяется из условия действия напряжения Ug на параллельно соединенные затворные резисторы. То есть величину Rg, полученную из формулы (2.1.13), необходимо при вычислениях уменьшить во столько раз, сколько транзисторов включается параллельно.
Очень важно выполнить связи между электродами транзисторов как можно короче, минимизировав паразитные индуктивности монтажа. Плохая топология проводников может привести к чрезмерному перенапряжению и неконтролируемому переключению. Возможное и наиболее часто встречающееся расположение параллельно включаемых транзисторов MOSFET показано на рис. 2.1.16.
Рис. 2.1.16. Вариант параллельного включения транзисторов MOSFET
Транзисторы VTl…VT4 установлены на общий радиатор максимально близко друг к другу, что обеспечивает их равномерный прогрев. Силовые шины, которые могут быть выполнены как печатными, так и объемными проводниками (например, медной полосой или луженым проводом), подключены к стоку и истоку всех транзисторов. Затворные резисторы Rg можно расположить над силовыми шинами. Закрепляются транзисторы на радиаторе с помощью винтов и прижимных пружин. Иногда для улучшения теплового контакта между
корпусами радиаторов используется следующая технология: транзисторы крепятся своими теплоотводящими пластинами к общей полосе из меди (или ее сплавов), а она, в свою очередь, привинчивается к радиатору, предварительно смазанному в месте контакта теплопроводящей пастой. И, конечно, следует обеспечить электрическую изоляцию отдельных групп транзисторов во избежание коротких замыканий в тех местах, где они по электрической схеме не должны существовать.
На рис. 2.1.17 приведен внешний вид варианта конструктивного узла трехфазного управляемого моста, составленного из параллельно включенных транзисторов MOSFET, а на рис. 2.1.18 — электрическая схема соединения транзисторов. Радиатор имеет сквозные каналы, через которые он принудительно продувается потоком воздуха.
Источник: Семенов Б. Ю. Силовая электроника: профессиональные решения. — М.: СОЛОН-ПРЕСС, 2011. — 416 c.: ил.



