Влияние радиационной обработки быстрыми электронами на кремниевые высокочастотные p-i-n-диоды с барьером Шоттки
Главная > Журналы > «Наукоемкие технологии» > Журнал «Наукоемкие технологии» №11 за 2013 г. > Влияние радиационной обработки быстрыми электронами на кремниевые высокочастотные p-i-n-диоды с барьером ШотткиЖурнал «Наукоемкие технологии» №11 за 2013 г.
Статья в номере:
Влияние радиационной обработки быстрыми электронами на кремниевые высокочастотные p-i-n-диоды с барьером Шоттки
Авторы:
О.Р. Абдуллаев — к.т.н., директор по науке и производству, ОАО «Оптрон». E-mail: [email protected]
А.С. Дренин — вед. инженер СКБ, ОАО «Оптрон». E-mail: [email protected]
П.Б. Лагов — к.т.н., доцент, кафедра «Полупроводниковая электроника и физика полупроводников», НИТУ «МИСиС». E-mail: lagov2000@mail. ru
М.Ю. Филатов — к.т.н., зам. директора СКБ, ОАО «Оптрон». E-mail: [email protected]
ru
М.Ю. Филатов — к.т.н., зам. директора СКБ, ОАО «Оптрон». E-mail: [email protected]
Аннотация:
Приведены результаты экспериментальных исследований влияния обработки быстрыми электронами и последующего низкотемпературного отжига на комплекс параметров кремниевых p-i-n-структур с различной толщиной i-слоя, используемых для изготовления СВЧ p-i-n-диодов и диодов с барьером Шоттки. Показаны экспериментальные образцы p-i-n-диодов с тонкой базой с применением радиационной обработки быстрыми электронами с энергией 5 МэВ. Дан сравнительный анализ основных электрических характеристик полученных диодов и их зарубежных аналогов HSMP3820 фирмы «Avago Technologies». Исследована возможность низкотемпературной радиационно-ускоренной активации и разгонки имплантированных ионов бора в кремний для создания р-n-перехода после формирования контактной металлизации и эффективность применения обработки ускоренными электронами для увеличения максимальной рабочей температуры и уменьшения обратных токов диодов с барьером Шоттки.
Страницы: 51-56
Список источников
- Дренин А.С., Лагов П.Б., Роговский Е.С., Руднев С.В. Радиационная обработка кремниевых p-i-n структур с различной толщиной i-слоя // ВАНТ. Сер.: Физика радиационного воздействия на РЭА. 2012. № 1. С. 76-78.
- Филатов М.Ю., Роговский Е.С., Колмакова Т.П., Меженный М.В., Дренин А.С. Исследование и устранение причин брака при производстве мощных кремниевых p-i-n диодов // Электронная техника. Сер. 2. Полупроводниковые приборы. 2012. № 2. С. 77-86.
- Жукова Н.С., Крымко М.М., Ледовских А.П., Максимов А.Н, Сопов О.В. Анализ способов снижения времени восстановления обратного сопротивления мощных быстродействующих диодов // Электронная техника. Сер. 2. Полупроводниковые приборы. 2010. С. 83-87.
- Рябка П.М., Балагура
В.С.
 Сер.: Ядерно-физические исследования. Харьков. 1999.
№ 1. С. 98-99.
Сер.: Ядерно-физические исследования. Харьков. 1999.
№ 1. С. 98-99. - Колмакова Т.П., Дренин А.С., Лагов П.Б.Исследование различных режимов эпитаксиального наращивания слоев кремния для создания p-i-n структур переключательных диодов // Тезисы IV Междунар. науч. конф. «Кремний 2007». Москва. 2007. С. 161.
- Лагов П.Б., Мусалитин А.М., Дренин А.С.Применение технологической обработки быстрыми электронами для повышения быстродействия переключательных p-i-n диодов // Тезисы IV Росс. конф. с междунар. участием по физике, материаловедению и физико-химическим основам технологий получения легированных кристаллов кремния и приборных структур на их основе «Кремний 2007». Москва. 2007. С. 238.
- Дренин А.С., Лагов П.Б.,
Филатов М.Ю.Исследование влияния режимов радиационной обработки на кремниевые высокочастотные
pin-диоды с тонкой
базой // Сб. тезисов. Твердотельная электроника.
 Сложные
функциональные блоки РЭА. Материалы VIII научно-техн. конф. молодых
специалистов. 2009. С. 19-20.
Сложные
функциональные блоки РЭА. Материалы VIII научно-техн. конф. молодых
специалистов. 2009. С. 19-20. - Лагов П.Б., Дренин А.С.,
Манякина Д.С.
- Дренин А.С., Лагов П.Б., Филатов М.Ю. Оптимизация параметров ВАХ детекторных диодов с барьером Шоттки на кремнии // Сб. тезисов VIII науч.-техн. конф. молодых специалистов «Твердотельная электроника. Сложные функциональные блоки РЭА». Дубна. 2009. С. 22.
- Дренин А.С., Лагов П.Б.,
Роговский Е.С., Филатов М.Ю. Влияние радиационной обработки на параметры ионнолегированных слоев
кремния // Сб. тезисов Х науч.-техн. конф. молодых специалистов «Твердотельная
электроника. СложныефункциональныеблокиРЭА».

Диод ДЛ112-10, цена 60 грн.
Диод ДЛ112-10 относится к силовым лавинным диодам штыревой конструкции.
Применяется в цепях переменного и постоянного тока. Диод состоит из двух выводов: анод и катод. В диодах прямой полярности анод ― основание диода, катод ― жесткий вывод, диоды обратной полярности маркируются буквой X, в этом случае анод ― жесткий вывод, а катод ― основание диода. Как правило полупроводниковые приборы устанавливаются на охладитель для обеспечения оптимальных характеристик.
Основные особенности:
- Герметичные металлостеклянные корпуса
- Соответствуют зарубежным аналогам и международным стандартам
- Гарантированная максимальная мощность рассеивания в режиме лавинного пробоя
- Диоды поставляются прямой и обратной полярности: с буквой «Х» ― катод на основании, без буквы «Х» ― анод на основании
Области применения:
- Везде, где необходимы выпрямительные диоды малой, средней и большой мощности
- Неуправляемые и полууправляемые выпрямительные мосты
- Мощные электропривода для промышленного применения и транспорта
- Тяговые подстанции
Структура маркировки диода (пример):
ДЛ112 — 10 — 18 — УХЛ2
ДЛ — Диод лавинный
112 — Конструктивное исполнение
10 — Средний ток в открытом состоянии, А
18 — Класс по напряжению (Номинальное напряжение 1800В)
УХЛ2 — Климатическое исполнение
| Примеры маркировки диода и основные характеристики | ||||
| Тип диода | UDRM, В/ URRM, В * | Класс | ITAV, А ** | Тип охладителя |
| ДЛ112-10-1 | 100 | 1 | 10 | О111 |
| ДЛ112-10-2 | 200 | 2 | 10 | О111 |
| ДЛ112-10-3 | 300 | 3 | 10 | О111 |
| ДЛ112-10-4 | 400 | 4 | 10 | О111 |
| ДЛ112-10-5 | 500 | 5 | 10 | О111 |
| ДЛ112-10-6 | 600 | 6 | 10 | О111 |
| ДЛ112-10-7 | 700 | 7 | 10 | О111 |
| ДЛ112-10-8 | 800 | 8 | 10 | О111 |
| ДЛ112-10-9 | 900 | 9 | 10 | О111 |
| ДЛ112-10-10 | 1000 | 10 | 10 | О111 |
| ДЛ112-10-11 | 1100 | 11 | 10 | О111 |
| ДЛ112-10-12 | 1200 | 12 | 10 | О111 |
| ДЛ112-10-13 | 1300 | 13 | 10 | О111 |
| ДЛ112-10-14 | 1400 | 14 | 10 | О111 |
| ДЛ112-10-15 | 1500 | 15 | 10 | О111 |
| ДЛ112-10-16 | 1600 | 16 | 10 | О111 |
| ДЛ112-10-17 | 1700 | 17 | 10 | О111 |
| ДЛ112-10-18 | 1800 | 18 | 10 | О111 |
| *UDRM, В/ URRM, В ― Повторяющееся импульсное напряжение в закрытом состоянии и повторяющееся импульсное обратное напряжение | ||||
| **I TAV, А ― Максимально допустимый средний ток в открытом состоянии | ||||
Разработка и исследование элементной базы на гетероструктурах на основе соединений А3В5 для СВЧ-модулей
УДК 621. 382
382
Юшенко Алексей Юрьевич
РАЗРАБОТКА И ИССЛЕДОВАНИЕ ЭЛЕМЕНТНОЙ БАЗЫ НА ГЕТЕРОСГРУКТУРАХ НА ОСНОВЕ СОЕДИНЕНИЙ А3В5 ДЛЯ СВЧ-МОДУЛЕЙ
Специальность 01.04.04 — физическая электроника
АВТОРЕФЕРАТ
диссертации на соискание ученой степени кандидата технических наук
1 8 А В Г 2011
Томск 20П
4852218
Работа’ ¿¿полнена в ОАО «Научво-исатедовахельский институт полупроводниковых приборов» и в ГОУ ВПО «Томский государственный университет систем управления и радиоэлектроники»
Научный руководитель:
доктор технических наук, Айзенштат Геннадий Исаакович
Официальные оппоненты:
доктор физико-математических наук, профессор
Войцеховский Александр Васильевич
доктор физико-математических наук, профессор
Гошин Геннадий Георгиевич
Ведущая организация:
Институт электрофизики Уральского отделения РАН, г. Екатеринбург
Зашита диссертации состоится «5» октября 2011 г. в 15 ч. 30 мин. на заседании диссертационного совета Д212.268.04 при ГОУ ВПО «Томский государственный университет систем управления и радиоэлектроники» по адресу: 634050, г.Томск, пр. Ленина, 40, ауд. 203.
в 15 ч. 30 мин. на заседании диссертационного совета Д212.268.04 при ГОУ ВПО «Томский государственный университет систем управления и радиоэлектроники» по адресу: 634050, г.Томск, пр. Ленина, 40, ауд. 203.
С диссертацией можно ознакомиться в библиотеке Томского государственного университета систем управления и радиоэлектроники по адресу: г. Томск, ул. Вершинина, 74.
Автореферат разослан « 2. » августа 2011 г.
Ученый секретарь диссертационного совета Д212.268.04
доктор технических наук, профессор
Ю.П.
Акулшшчев
ОБЩАЯ ХАРАКТЕРИСТИКА РАБОТЫ
Актуальность работы. Разработка и освоение новейших технологий в системах космической, спутниковой и мобильной связи, а также радиолокационных системах на основе приемо-передающих модулей активных фазированных антенных решеток (ППМ АФАР) является важнейшей и сложнейшей научно-технической задачей, без решения которой немыслимо производство перспективных, эффективных и конкурентоспособных образцов новой техники.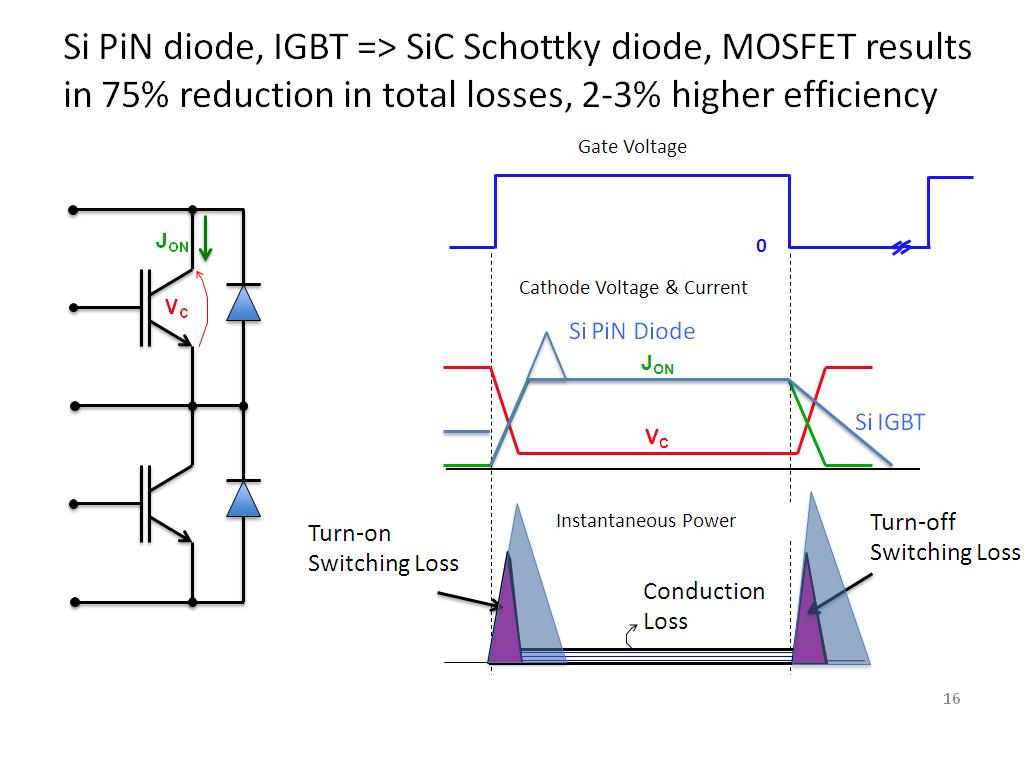 Прогресс в этой области обусловлен использованием СВЧ монолитных интегральных схем (МИС), базирующихся на последних достижениях в области гетероструктурной электроники.
Прогресс в этой области обусловлен использованием СВЧ монолитных интегральных схем (МИС), базирующихся на последних достижениях в области гетероструктурной электроники.
В настоящее время в США, Японии и ряде стран Европы и Южной Азии разработаны и серийно выпускается ряд СВЧ МИС на основе гетероструктур, предназначенный для построения указанных систем. Функциональный ряд этих МИС включает следующие схемы: малошумящие усилители (МШУ) и усилители мощности (УМ), защитные устройства, коммутаторы, фазовращатели, аттенюаторы, смесители и генераторы.
В России работы по созданию серийных изделий этого ряда ведутся всего на нескольких предприятиях, причем, основные усилия в этой области направлены на сокращение отставания от уровня зарубежных компаний [1,2].
Актуальность работ, связанных с разработкой элементной базы для СВЧ-модулей, продиктована острой необходимостью разработки аппаратуры нового поколения и, прежде всего, для специальной техники оборонного комплекса страны.
Требуется отметить, что к началу данной работы (2007 г.) в России СВЧ МИС выполнялись преимущественно по MESFET-технологии, полностью отсутствовало перспективное научно-техническое направление по созданию СВЧ монолитных интегральных схем на основе гетероструктурных арсенидгаллиевых pin-диодов, а работы по созданию рНЕМТ МИС МШУ были на начальном этапе.
Цель работы. Целью работы является разработка и исследование монолитных интегральных схем СВЧ диапазона на основе арсенидгаллиевых гетероструктурных pin-диодов, в рамках нового для страны направления, а также разработка и исследование СВЧ МИС на основе транзисторов с высокой подвижностью электронов.
Для достижения поставленной цели необходимо было решить следующие задачи.
1) Разработать и оптимизировать конструкцию и технологию изготовления дискретного СВЧ гетероструктурного pin-диода на отечественном материале.
Провести исследование особенностей поведения прибора при разных режимах работы и на разных материалах. Провести комплекс измерений его параметров, необходимых для построения СВЧ-модели рт-диода и проектирования монолитных интегральных схем на его основе.
Провести комплекс измерений его параметров, необходимых для построения СВЧ-модели рт-диода и проектирования монолитных интегральных схем на его основе.
2) Разработать технологию создания СВЧ монолитных интегральных схем с использованием гетероструктурных рт-диодов. Найти наиболее эффективные конструкторские и технологические решения для создания МИС коммутаторов и ограничителей СВЧ-мощности с параметрами, превышающими параметры известных аналогов.
3) Разработать и оптимизировать конструкцию и технологию изготовления малошумящего транзистора, выполненного по рНЕМТ-технологии на отечественном материале. Провести исследование его характеристик, построить СВЧ-модель. Провести комплекс работ для создания оптимальных технологических маршрутов изготовления МИС на основе гетероструктурных транзисторов, включающих создание активных и пассивных компонентов.
4) Разработать и исследовать МИС малошумящего усилителя Х-диапазона на основе разработанной рНЕМТ-технологии. Провести исследование созданных МИС МШУ и МИС защитного устройства на основе рт-диодов при их совместной работе (МШУ с защитой по входу).
Провести исследование созданных МИС МШУ и МИС защитного устройства на основе рт-диодов при их совместной работе (МШУ с защитой по входу).
5) Провести поиск конструктивных и технологических путей создания МИС на основе гетероструктурных транзисторов, имеющих более высокие предельные частоты, для работы в миллиметровом диапазоне волн.
Методы исследований. В качестве главных инструментов исследований использовались методы моделирования схем на основе апробированных моделей. Для подтверждения справедливости расчетов проводились экспериментальные исследования. С использованием осциллографических методов анализировались временные характеристики приборов. Для контроля субмикронных размеров использовались методы электронной и атомно-силовой микроскопии. Проводилось изучение вольт-амперных характеристик в диапазоне температур. Исследовались оптические спектры излучения приборов. Исследование СВЧ-характеристик приборов осуществлялось непосредственно на полупроводниковых пластинах в широком диапазоне частот (0,01-40 ГГц) с использованием векторного анализатора цепей и зондовой станции.
Научная новизна работы. 1) Впервые в стране созданы СВЧ гетероструктурные арсенидгаллиевые рт-диоды и монолитные интегральные схемы на их основе.
2) Экспериментально изучены особенности поведения СВЧ гетероструктурных рт-диодов в монолитных интегральных схемах. Впервые показано, что арсенидгаллиевые рт-диоды, входящие в состав СВЧ МИС, являются источниками инфракрасного излучения, обусловленного излучательной рекомбинацией электронов и дырок в диодах, что позволяет измерять температуру приборов и осуществлять дистанционный контроль схем при граничных испытаниях.
3) Впервые созданы СВЧ монолитные интегральные схемы ограничителей мощности, одновременно содержащие вертикальные структуры рт-диодов и диодов Шоттки. По совокупности параметров разработанные схемы превосходят известные аналоги. Конструкции схем защищены патентами (пат. РФ №94765 от 27.05.2010 и пат. РФ №102846 от 10.03.2011).
4) Впервые предложена и реализована МИС ограничителя СВЧ-мощности на основе рт-диодов с управляемым уровнем просачивающейся мощности (заявка на изобретение №2011102631 от 24. 01.2011г.). Схема также может быть использована в качестве управляемого аттенюатора и СВЧ-«отключателя».
01.2011г.). Схема также может быть использована в качестве управляемого аттенюатора и СВЧ-«отключателя».
5) Экспериментально исследованы температурные зависимости скорости дрейфа электронов от поля в квантовой яме гетероперехода АЮаАБЛпСаАБ разработанного транзистора, что позволяет более корректно оценивать изменение параметров прибора в диапазоне температур 230-400 К.
6) Предложена и реализована технологичная методика получения затворов с длинами порядка 100 нм, не опирающаяся на использование электронных литографов (Заявка на изобретение № 2011102638 от 24.01.2011 г., положительное решение от 08.06.2011).
Практическая значимость работы.
1) Результаты, полученные автором, положили начало реализации в стране нового научно-технического направления по созданию СВЧ монолитных интегральных схем на основе гетероструктурных арсенидгаллиевых рт-диодов.
2) В результате выполнения НИР и ОКР, проводимых в ОАО «НИИПП», были разработаны технологии создания гетероструктурных рт-диодов и транзисторов, а также СВЧ МИС на их основе. Были получены образцы СВЧ МИС, по своим параметрам не уступающие известным аналогам.
Были получены образцы СВЧ МИС, по своим параметрам не уступающие известным аналогам.
3) Разработан СВЧ гетероструктурный арсенидгаллиевый малошумящий транзистор серии АП399А-5.
4) Созданные СВЧ гетероструктурные транзисторы на арсениде галлия были внедрены в ОКР «Исследование и создание широкополосных
приемопреобразовательных устройств на основе GaAs интегральных СВЧ-схем усилителей, преобразователей вверх и вниз», шифр «Доводка-02» (Модули СВЧ М55147-1…6 АПТТ.434850.036 ТУ), и «Разработка конверторов диапазонов частот 2…16 ГГц в литерном исполнении», шифр «Кварк-02» (Модуль СВЧ М55326 АППТ.434850.038 ТУ).
5) Разработанные в рамках данной работы МИС на основе гетероструктурных приборов показали свою эффективность и перспективность для создания широкого спектра СВЧ модулей и устройств, разрабатываемых в ОАО «НИИПП»
6) Полученные результаты использованы в проектах (№П499 от 13.05.2010г., №П669 от 19.05.2010г., №14.740.11.0135 от 06. 09.2010г., №16.740.11.0092 от 01.09.2010 г.) по Федеральной целевой программе «Научные и научно-педагогические кадры инновационной России на 2009-2013 годы».
09.2010г., №16.740.11.0092 от 01.09.2010 г.) по Федеральной целевой программе «Научные и научно-педагогические кадры инновационной России на 2009-2013 годы».
Научные положения, выносимые на защиту.
1) Смещенные в прямом направлении арсенидгаллиевые СВЧ pin-диоды, входящие в состав монолитных интегральных схем, являются источниками инфракрасного излучения, обусловленного межзонной излучательной рекомбинацией, что позволяет определять максимальную температуру кристалла и его тепловое сопротивление.
2) При изменении смещения на каадом pin-диоде, входящем в состав интегральной схемы защитного устройства на основе арсенида галлия, от 0 до + 0,7 В можно уменьшать мощность просачивания устройства с 17,8 дБм (-60 мВт) до 9 дБм (~8 мВт) практически без изменения его малосигнальных параметров.
3) Использование эпитаксиальной гетероструктуры n-GaAs/n+-GaAs/p+-GaAs/p+-AIGaAs/i-GaAs/n+GaAs/SI-GaAs для создания монолитной интегральной схемы многокаскадного ограничителя мощности с вертикальными структурами pin-диодов дает возможность дополнительно формировать выходную группу диодов Шоттки вертикальной конструкции, что приводит к уменьшению мощности просачивания устройства в 4 раза (с 18 дБм (63 мВт) до 12дБм (16 мВт)), не ухудшая при этом остальных параметров.
4) Для диапазона температур 230 — 400 К скорость насыщения электронов двумерного электронного газа в квантовой яме перехода AlGaAs/InGaAs гетероструктурного транзистора с длиной активной области около 1 мкм изменяется от 1,5х107 до 1,3*107 см/с.
5) Использование непрямых литографических методов создания затвора, основанное, с одной стороны, на теневых эффектах при напылении тонких
пленок, а с другой стороны, на селективном травлении слоев гетероструктуры, позволяет создавать дискретные приборы и МИС с транзисторами, имеющими длину затвора порядка 100 им при разрешающей способности литографии 800 нм.
Апробация результатов работы. Основные результаты работы доложены на 4-й Международной научно-практической конференции «Электронные средства и системы управления. Опыт инновационного развития» (Томск 2007 г.), Всероссийской научно-технической конференции студентов, аспирантов и молодых ученых «Научная сессия ТУСУР-2008» (Томск 2008 г.), Международных конференциях «Актуальные проблемы радиофизики» (Томск 2008,2010 гг. ), IEEE International Siberian Conference on Control and Communications SIBCON-2009 (Tomsk 2009), Всероссийской научной конференции молодых ученых «НАУКА. ТЕХНОЛОГИИ. ИННОВАЦИИ.» (Новосибирск 2009 г.), на 20-й Международной Крымской конференции «СВЧ-техника и телекоммуникационные технологии» (Севастополь, Украина 2010 г.), VI Международной научно-практической конференции «Электронные средства и системы управления» (Томск 2010 г.), IEEE 2nd Russian School and Seminar on Fundamental Problems of Micro/Nanosystem Technologies Proceedings MNST’2010 (Novosibirsk 2010), Научно-практической конференции по физике и технологии наногетероструктурной СВЧ-электроники «Мокеровские чтения» (Москва 2011г.).
), IEEE International Siberian Conference on Control and Communications SIBCON-2009 (Tomsk 2009), Всероссийской научной конференции молодых ученых «НАУКА. ТЕХНОЛОГИИ. ИННОВАЦИИ.» (Новосибирск 2009 г.), на 20-й Международной Крымской конференции «СВЧ-техника и телекоммуникационные технологии» (Севастополь, Украина 2010 г.), VI Международной научно-практической конференции «Электронные средства и системы управления» (Томск 2010 г.), IEEE 2nd Russian School and Seminar on Fundamental Problems of Micro/Nanosystem Technologies Proceedings MNST’2010 (Novosibirsk 2010), Научно-практической конференции по физике и технологии наногетероструктурной СВЧ-электроники «Мокеровские чтения» (Москва 2011г.).
Публикации. Основные результаты диссертации опубликованы в 22 работах, в том числе — 9 статей опубликованы в журналах, входящих в перечень ВАК; 2 патента РФ.
Личный вклад автора. Диссертация является итогом исследований автора, проводившихся совместно с сотрудниками ОАО «НИИПП», ТУСУР и других организаций. Основные исследования, результаты которых представлены в диссертации, были выполнены по инициативе автора. Автором совместно с научным руководителем обсуждались цели работы, пути их достижения и результаты работы. Личный вклад автора включает выбор методик исследований, проведение численных расчетов, подготовку образцов и их измерение, обработку экспериментальных результатов. Большая часть статей по теме диссертации написана автором после обсуждения с соавторами. Автором выполнено обобщение представленного в диссертации материала.
Основные исследования, результаты которых представлены в диссертации, были выполнены по инициативе автора. Автором совместно с научным руководителем обсуждались цели работы, пути их достижения и результаты работы. Личный вклад автора включает выбор методик исследований, проведение численных расчетов, подготовку образцов и их измерение, обработку экспериментальных результатов. Большая часть статей по теме диссертации написана автором после обсуждения с соавторами. Автором выполнено обобщение представленного в диссертации материала.
Структура и объем диссертации. Диссертация состоит из введения, четырех глав, заключения, списка литературы. Объем работы составляет 135 страниц машинописного текста, включая 67 рисунков и список литературы из 114 наименований.
КРАТКОЕ СОДЕРЖАНИЕ РАБОТЫ
Во введении обоснована актуальность работы, сформулированы цель работы и задачи исследований, приведены научная новизна и практическая ценность, сформулированы научные положения, выносимые на защиту.
Первая глава посвяшена анализу литературных данных по проблеме создания функционального ряда СВЧ монолитных интегральных схем, предназначенных для построения приемопередающих устройств нового поколения. Она включает краткий обзор достижений по гетероструктурным СВЧ монолитным интегральным схемам, как в России, так и за рубежом.
Анализ научно-технической литературы показал, что, несмотря на крайнюю востребованность радиолокационных систем различного назначения в стране практически отсутствует современная элементная база с параметрами, соответствующими зарубежным аналогам. Существенное отставание отечественных разработок обусловлено недостаточным финансированием наукоемких отраслей производства в 90-е годы [3]. Поэтому приходится заново воспроизводить весь путь, уже пройденный западными фирмами: от разработки нового полупроводникового материала высокого качества и создания соответствующих технологических маршрутов до решения ряда физических задач прикладного характера.
Показано, что к началу данной работы разработки по созданию СВЧ МИС в России выполнялись преимущественно по MESFET-технологии, полностью отсутствовало перспективное научно-техническое направление по созданию СВЧ монолитных интегральных схем на основе гетероструктурных арсенидгаллиевых pin-диодов, а работы по созданию рНЕМТ МИС МШУ были на начальном этапе.
В заключении главы сформулированы основные цели и задачи исследований.
Вторая глава диссертации посвящена разработке бескорпусного гетероструктурного арсенидгаллиевого СВЧ pin-диода для диапазона частот 0,540 ГГц, его исследованию, построению СВЧ-модели диода и разработке монолитных интегральных схем коммутаторов на основе данных по исследованию диода.
Для изготовления pin-диодов был создан новый технологический маршрут, в настоящее время внедренный в ОАО «НИИПГ1» и базирующийся на отечественных эпитаксиальных структурах, выращенных в ИФП СО РАН г. Новосибирска. На рис. I и 2 представлены фотографии созданного диода и увеличенного фрагмента его активной области. Разработанные бескорпуспыс диоды с балочными выводами являются первыми отечественными СВЧ pin-
Разработанные бескорпуспыс диоды с балочными выводами являются первыми отечественными СВЧ pin-
диодами на основе гетероструктур А3В5 и по своим параметрам не уступают [ зарубежным аналогам.
Рис. 1 Фотография разработанного диода
Рис, 2 Рабочая область диода
Для проведения исследований диоды изготавливались из разнообразных эпитаксиальных структур. Исследования проводились с целью выбора конфигурации эпитаксиальных структур, выбора метода их выращивания, оптимизации геометрии приборов. Измерялись статические вольт-амперные характеристики (ВАХ), вольт-фарадные характеристики, времена жизни носителей и СВЧ-характеристики.
Показано, что анализ измеренных статических характеристик диода не позволяет уверенно прогнозировать пригодность эпитаксиальной
структуры для создания СВЧ рт-диодов. Наиболее информативными характеристиками качества структуры являются СВЧ-параметры рт-диодов. На рис.3 даны частотные зависимости вносимых потерь диодов с емкостью 30 фФ, включенных последовательно 50-омной копланарной линии, при управляющем токе 10 мА для трёх
гч -1. 0
0
10 20 30
Частота, ГГц
Рис. 3 Частотные зависимости вносимых потерь диодов: 1 — гетероструктура МЛЭ; 2 — гомострутура МЛЭ; 3 — гомострутура ГФЭ
типов эпитаксиальных структур: гомо- (кривая 2) и гетероструктуры (кривая I), выращенные методом молекулярно-лучевой эпитаксии (МЛЭ), гомоструктура, выращенная в ОАО «НИИПП» методом газофазной эпитаксии (ГФЭ) с последующей компенсацией хромом (кривая 3).
В результате сравнения характеристик диодов, созданных на различных материалах, было установлено, что минимальные потери получаются на
гетероструктурах. выращенных методом молекулярно-лучевой эпитаксии (МЛЭ) (рис.3, кривая I).
Проведенные расчеты параметров СВЧ-диодов показали, что они работают при плотностях тока порядка 2000-5000 А/см», при этом концентрации неравновесных носителей в активной области сравнимы с концентрациями электронов и дырок в светодиодах. Поэтому ваАБ СВЧ рт-диоды должны быть интенсивными источниками инфракрасного излучения. Это предположение подтверждено экспериментально. Эффекты излучения в СВЧ рт-диодных МИС обнаружены впервые. Иллюстрация этого эффекта показана на рис. 4. где приведены фотографии излучающих СВЧ рт-диодов при разных токах.
Это предположение подтверждено экспериментально. Эффекты излучения в СВЧ рт-диодных МИС обнаружены впервые. Иллюстрация этого эффекта показана на рис. 4. где приведены фотографии излучающих СВЧ рт-диодов при разных токах.
Рис. 4 Фотографии излучающих СВЧ pin-диодов
Спектры излучения диодов, измеренные спектрофотометром, содержали максимумы на длинах волн 890-910 нм. Положение максимумов на спектрах излучения свидетельствовало о существенной роли межзонной излучательной рекомбинации в диоде, причем наблюдалось заметное смещение максимумов спектров в длинноволновую область при разогреве диода, что позволяло определять тепловое сопротивление диодов по известной зависимости ширины запрещенной зоны арсенида галлия от температуры (формула Варшни) [4].
Для оптимизации топологии и построения СВЧ-модели pin-диода с использованием программ Microwave Office и CST STUDIO было проведено электромагнитное моделирование различных трехмерных конструкций прибора.
Полученные параметры модели сравнивались с измеренными параметрами изготовленных тестовых диодов. Расчетные и экспериментальные параметры совпали с высокой точностью. Это дало основание использовать их в дальнейшем при разработке монолитных интегральных схем.
Расчетные и экспериментальные параметры совпали с высокой точностью. Это дало основание использовать их в дальнейшем при разработке монолитных интегральных схем.
Ключевым моментом при решении поставленных задач явилась разработка нового технологического маршрута для создания pin-диодных монолитных интегральных схем на гетероструктурах, выращенных методом молекулярно-лучевой эпитаксии. Маршрут опирался на базовые технологические процессы ОАО «НИИПП» и позволял создавать оригинальные МИС с вертикальными структурами pin-диодов одновременно с вертикальными диодами Шоттки, индуктивностями, резисторами, конденсаторами, металлизированными сквозными отверстиями.
В зависимости от сложности монолитной интегральной схемы маршрут включал до 120 элементарных технологических операций и требовал введения в топологию кристалла специализированных тестовых элементов.
С использованием разработанной технологии создан комплект интегральных схем СВЧ-коммутаторов на pin-диодах. В его состав входят коммутаторы 1 *2 Си Х-диапазонов. Фотография кристалла коммутатора Х-диапазона показана на рис. 5. Топология МИС коммутатора С-диапазона схожа с представленной на рис. 5.
В его состав входят коммутаторы 1 *2 Си Х-диапазонов. Фотография кристалла коммутатора Х-диапазона показана на рис. 5. Топология МИС коммутатора С-диапазона схожа с представленной на рис. 5.
Рис. 5 Фотография кристалла коммутатора Х-диапазона
Частота, ГГц
Рис. 6 Измеренные АЧХ МИС коммутатора Х-диапазона
На рис.6 представлены измеренные амплитудно-частотные характеристики (АЧХ) МИС коммутатора Х-диапазона. Необходимо отметить, что результаты измерений параметров коммутаторов хорошо совпадают с расчетными значениями, опирающимися на построенную СВЧ-модель диода. Главной особенностью созданных схем являются низкие вносимые потери. По своим
параметрам все разработанные МИС соответствуют лучшим зарубежным аналогам и не имеют прямых аналогов в России.
В главе также рассматриваются вопросы проектирования и создания комплекта МИС сверхширокополосных коммутаторов 1×1, 1><2 и 1×4 на гетероструктурах с предельно низкими вносимыми потерями и высоким уровнем развязки в полосе частот от 0,5 до 40 ГГц. Показано, что параметры созданных схем полностью соответствуют расчету, причем в России такие схемы созданы впервые.
Показано, что параметры созданных схем полностью соответствуют расчету, причем в России такие схемы созданы впервые.
На рис. 7 показаны результаты измерений коммутатора 1×4. Для проведения измерений схем
широкополосных коммутаторов
использовались разработанные МИС смещения по постоянному току (данные схемы в России также не выпускаются).
На рис.8 показана разработанная
схема коммутатора 1×4 в рабочем состоянии. Как видно из рис. 8, pin-диоды, входящие в состав МИС и смещенные в прямом направлении, являются источниками инфракрасного излучения. Как и в случае с дискретным диодом, по спектрам излучения МИС было найдено ее тепловое сопротивление, которое равнялось 250 °С/Вт.
Одновременно проводился расчет температуры прибора с использованием симулятора CST STUDIO,
позволяющего рассчитывать
распределение температур в сложных трехмерных объектах. Измеренное значение теплового сопротивления соответствует расчетному.
В третьей главе приведены результаты разработки и исследования первых отечественных МИС ограничителей СВЧ-мощности на основе гетероструктурных
0 |s21| дБ |sll|,|s22|, jISOL|,flE
Частота, ГТц
Рис. 7 Измеренные АЧХ МИС коммутатора 1*4
Рис. 8 Фотография кристалла сверхширокополосного коммутатора 1 х4
арсенидгаллиевых рш-диодов, а также МИС офаничителей мощности с улучшенной ограничительной характеристикой, защищенные патентами.
Как известно, схемы ограничителей СВЧ-мощности используются для защиты малошумящих усилителей в приёмных трактах СВЧ-аппаратуры. В работе создана монолитная интегральная схема ограничителя СВЧ-мощности, имеющая прямой аналог — МИС ТСЬ2201 фирмы Тп<3шм. Разработанная гетеростроструктурная схема на основе рт-диодов характеризуется низкими вносимыми потерями в широком диапазоне частот (рис. 9), допустимой входной мощностью не менее 37 дБм и имеет мощность просачивания 16-18 дБм (рис. 10). Однако для ряда серийных МШУ данный уровень мощности не является безопасным. Поэтому была разработана новая схема, которая позволила уменьшить мощность просачивания в 7 раз с 17,8 до 9 дБм.
Поэтому была разработана новая схема, которая позволила уменьшить мощность просачивания в 7 раз с 17,8 до 9 дБм.
Частота, ГГц Рвх, дБм
Рис. 9 Измеренные малосинальные Рис. 10 Измеренная мощностная
параметры МИС ограничителя характеристика МИС ограничителя
на частоте 7 ГГц
Эксперимент показал, что при подаче на рт-диод положительного смещения величиной меньшей 0,8 В, ёмкость гетероструктурного рш-диода меняется слабо. Так, при изменении смещения от нуля до 0,7 — 0,8 В значение ёмкости диода возрастает всего на 15-20%. При этом величина тока, протекающего через диод, не превышает 30 микроампер. Исходя из этих результатов, была предложена схема ограничителя мощности, показанная на рис.11. Здесь группы входных и выходных диодов, соединенные отрезком микрополосковой линии, подключены через фильтры питания к источнику постоянного напряжения, смещающего каждый из них в прямом направлении до напряжений меньших 0,7 В. Наличие положительного смещения на диодах обеспечивает более низкую амплитуду СВЧ-сигнала переключающего диод, а, следовательно, и более низкий уровень мощности, при котором начинается ограничение входного сигнала.
Отличительной особенностью предложенной схемы является возможность управления уровнем просачивающейся мощности и вносимых потерь. На рис. 12 представлена фотография разработанной МИС.
Рис. 11 Принципиальная схема Рис. 12. Фотография кристалла
ограничителя мощности, управляемого ограничителя мощности, управляемого напряжением напряжением
Малосигнальные характеристики этих МИС измерялись на зондовой станции
непосредственно на пластине. На рис. 13 представлено семейство зависимостей
вносимых и обратных потерь от частоты, измеренное при разных смещениях.
1я211.пЕ 1б1 11. пБ Мощность
просачивания, дБм Ослабление, дБ
55 50
Частота, ГГц
Рис. 13 Измеренные малосигнальные параметры МИС
0,0 0,5 1,0 1,5 2,0 2,5
Напряжение, В
Рис. 14. Измеренные зависимости мощности просачивания и вносимых потерь от управляющего напряжения
Из измеренных характеристик МИС (рис. 13, 14) видно, что при увеличении смещения от нуля до +1,4 В (что соответствует 0,7 В на каждом диоде) происходит сравнительно слабое увеличение вносимых потерь (от 0,25 до 0,37 дБ на частоте 7 ГГц), при этом уровень просачивающейся мощности уменьшается от 17 до 9 дБм, (Г = 7 ГГц; Рвх = 30 дБм). Максимальная входная мощность устройства составляет не менее 37 дБм.
13, 14) видно, что при увеличении смещения от нуля до +1,4 В (что соответствует 0,7 В на каждом диоде) происходит сравнительно слабое увеличение вносимых потерь (от 0,25 до 0,37 дБ на частоте 7 ГГц), при этом уровень просачивающейся мощности уменьшается от 17 до 9 дБм, (Г = 7 ГГц; Рвх = 30 дБм). Максимальная входная мощность устройства составляет не менее 37 дБм.
Представленная схема может быть также использована в качестве управляемого аттенюатора или «выключателя». Глубина изоляции МИС составляет не менее 40 дБ при управляющем токе 10 мА в Х-диапазоне.
Монолитная интегральная схема ограничителя СВЧ-мощности на радиолах, в которой уровень просачивающейся мощности управляется напряжением, была создана впервые (заявка на изобретение №2011102631 от 24.01.2011 г.).
В работе предложена и реализована ещё одна оригинальная схема ограничителя СВЧ-мощности. Данная схема защищена патентами (№ 94765 от 27.05.2010 г. и № 102846 от 10.03.2011 г.). Она позволяет уменьшить мощность просачивания в 4 раза по сравнению с ограничителем 101,2201 фирмы Тп()шп1.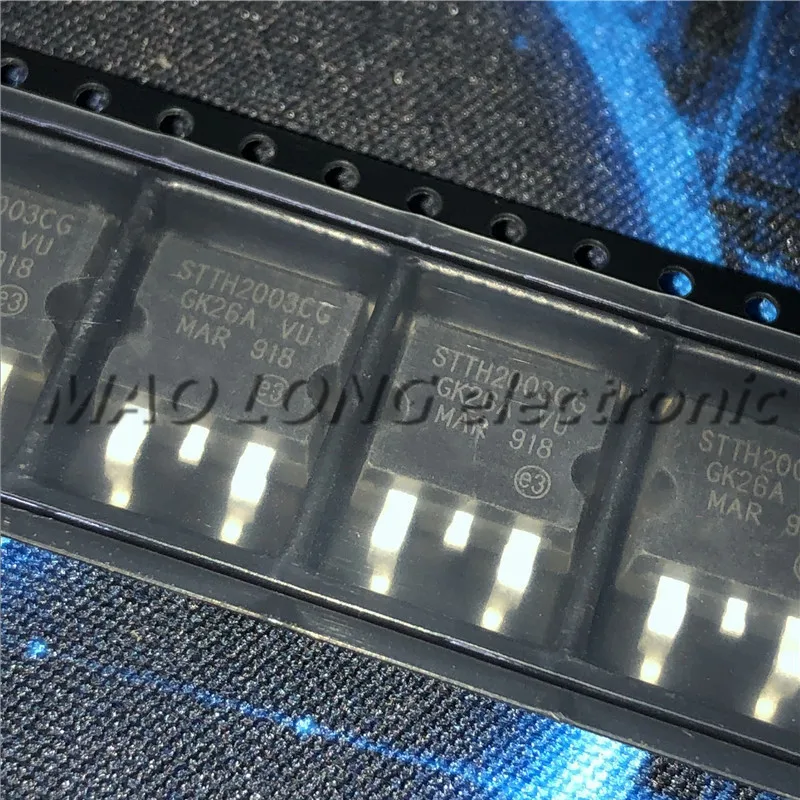 Предложенная МИС ограничителя мощности содержала вертикальные структуры рт-диодов и диодов Шоттки. Такая конструкция была создана впервые, она базировалась на использовании эпитаксиальной гетероструктуры п-СаАз/п’-ОаАз/р+-ОаАз/р»-А1СаА5/!-СаАз/п+-ОаАз/51-СаАз.
Предложенная МИС ограничителя мощности содержала вертикальные структуры рт-диодов и диодов Шоттки. Такая конструкция была создана впервые, она базировалась на использовании эпитаксиальной гетероструктуры п-СаАз/п’-ОаАз/р+-ОаАз/р»-А1СаА5/!-СаАз/п+-ОаАз/51-СаАз.
В качестве базового варианта была выбрана схема двухкаскадного защитного устройства на встречно-параллельных диодах: рт-диодах во входном каскаде -для обеспечения необходимого уровня входной мощности; диодах Шоттки в выходном каскаде — для увеличения быстродействия и уменьшения мощности просачивания. На входе и выходе схемы предусмотрены
разделительные конденсаторы. Фотографии кристалла МИС и фрагментов рт-диода и диода Шоттки представлены на рис. 15.
Для создания МИС защитного устройства использовались структуры на основе ОаАв, выращенные методом молекулярно-лучевой эпитаксии в ИФП СО РАН г. Новосибирска. При изготовлении кристаллов схем к технологическим операциям создания рт-диодных МИС, добавились операции, связанные с изготовлением вертикальных структур диодов Шоттки.
Рис. 15 Фотография кристалла защитного
Малосигнальные параметры разработанной МИС защитного устройства соответствуют рис. 9. На рис. 16 представлена измеренная ограничительная характеристика разработанной схемы в сравнении с рт-диодной МИС.
Ограничительные характеристики разработанных МИС измерялись в 50-омном микрополосковом тракте. Как видно из рис. 16, мощность просачивания в созданной схеме примерно в 4 раза меньше, чем в схеме на одних рт-диодах.
Экспериментальные исследования показали, что МИС СВЧ-ограничителей мощности с вертикальными структурами рт-диодов и диодов Шоттки характеризуются как низким уровнем мощности просачивания (11,5 дБм), так характеристики защитных устройств на и низкими вносимыми потерями в частоте 7 ГГц
диапазоне частот 1-22 ГТц. При этом разработанные МИС ограничителей обладают стойкостью к воздействию непрерывной СВЧ-мощности не менее 37дБм.
Четвёртая глава диссертации посвящена разработке ещё одной схеме функционального ряда — МИС малошумящего усилителя Х-диапазона. Реализация данной монолитной схемы по рНЕМТ-технологии потребовала проведения большого комплекса исследований. Результатом этих исследований стало создание, наряду с монолитной интегральной схемой МШУ, ещё и дискретного бескорпусного малошумящего транзистора АП399А-5, внедренного в производство на предприятии ОАО «НИИПП» в 2011г.
Реализация данной монолитной схемы по рНЕМТ-технологии потребовала проведения большого комплекса исследований. Результатом этих исследований стало создание, наряду с монолитной интегральной схемой МШУ, ещё и дискретного бескорпусного малошумящего транзистора АП399А-5, внедренного в производство на предприятии ОАО «НИИПП» в 2011г.
Транзисторы изготавливались на гетероструктурах п+-ОаАз/п-АЮаА5/АЮаА5/1пОаА5/Юх(АЮаА5/СаАз)/ОаА5/81-СаА5, выращенных методом молекулярно-лучевой эпитаксии в Санкт-Петербургском физико-технологическом научно-образовательном центре. Исходные структуры при комнатной температуре имели холловскую подвижность двумерного электронного газа рн = 5500 см2/В-с и поверхностную плотность электронов л/=2Т0и см-2.
Технологический маршрут создания транзисторов включал процессы, связанные с формированием омических контактов истоков и стоков, межэлементной изоляции, субмикронных затворов, пассивации и воздушных мостов. Ключевой операцией маршрута являются процессы электронной
; ! !
1~ р’т —
Г_\- —и
р!п +
1— -1-
О 5 10 15 20 25 30 35 40
Рвх,дБм Рис. 16 Ограничительные
16 Ограничительные
литографии на трёхслойной маске резистов для формирования субмикронных затворов Т-образной формы. Длина затворов разработанных транзисторов составляла 0,25.-0,3 мкм. Были созданы транзисторы встречно-штыревой конструкции с общей шириной затвора 4×40 = 160 мкм.
Измеренная крутизна в окрестности рабочей точки (Ц = 2,5 В, 1с = 12 мА) полученных транзисторов равнялась 330 -340 мСм/мм. Измерения параметров рассеяния
транзисторов были выполнены на зондовой станции в диапазоне частот 0,01 — 40 ГГц. По результатам измерений 5-параметров была построена малосигнальная модель
транзистора в виде
эквивалентной схемы. По результатам косвенных
измерений и расчетов были найдены шумовые параметры изготовленных транзисторов в диапазоне частот 2-18 ГГц. На рис. 17 представлены частотные зависимости минимального коэффициента шума (КРт1П) и оптимального коэффициента усиления (Оа) разработанного транзистора для рабочей точки ис = 2,5 В, 1с = 12 мА. 1 1 ■ /
1 1 ■ /
/ /
1
2 4 6 8 10 12 14 16 18
Частота, ГГц Рис. 17 Частотные зависимости №т1п и в, разработанного транзистора
изменялась от 1,5*107 до 1,3х107 см/с. Полученная зависимость позволяет более корректно оценивать изменение параметров прибора в диапазоне температур.
Рассмотрены вопросы
проектирования МИС МШУ. Схема выполнена по рНЕМТ-технологии и наряду с активными элементами также содержит спиральные катушки индуктивности, МДМ-конденсаторы, тонкопленочные резисторы и металлизированные сквозные
отверстия. На рис. 19 показана
фотография разработанной монолитной интегральной схемы МШУ Х-диапазона. Размер кристалла МИС МШУ составляет 1,4×1,4×0,1 мм.
Изготовленные усилители характеризуются следующими параметрами (при комнатной температуре): полоса рабочих частот ДГ =7-11 ГГц; минимальный
коэффициент шума №т1п = 0,9-1,1 дБ на частоте 9 ГГц; коэффициент усиления в = 18±0,4дБ в диапазоне частот 8-10,5 ГГц; коэффициенты отражения ^п] и ^ > 10 дБ; коэффициент устойчивости к > 1 во всем диапазоне частот; мощность при уменьшении коэффициента усиления на 1 дБ Р^дБ = 10,8 дБм на частоте 10 ГГц; максимально допустимая входная мощность Рвх. макс. = 19-20 дБм, рабочий режим по постоянному току Упигх1пвг = ЗВх38 мА. По совокупности параметров (рНЕМТ-технология, длина затвора, размер кристалла, рабочий режим по постоянному току, два каскада усиления, коэффициенты усиления, шума, отражения по входу/выходу и т.д.) созданная МИС МШУ соответствует отечественным и зарубежным аналогам. На рис. 20 и 21 представлены измеренные характеристики МИС МШУ Х-диапазона.
макс. = 19-20 дБм, рабочий режим по постоянному току Упигх1пвг = ЗВх38 мА. По совокупности параметров (рНЕМТ-технология, длина затвора, размер кристалла, рабочий режим по постоянному току, два каскада усиления, коэффициенты усиления, шума, отражения по входу/выходу и т.д.) созданная МИС МШУ соответствует отечественным и зарубежным аналогам. На рис. 20 и 21 представлены измеренные характеристики МИС МШУ Х-диапазона.
Рис. 18 Зависимость скорости насыщения электронов в канале гетероструктурного транзистора от температуры
С. |511|.|522|. дБ
С, дБ; Рвых. дБм
10 12
Частота, ГГц
ЗВ 38мА 00″С )’ -■ !() ГГц
-30 -25 -20 -15 -10 -5 0
Рвх. лБм
10 15 20
Рис. 21. Динамические характеристики МШУ на частоте 10 П и
3,4 3,2 3,0 2,8 2,6 2,4 2,2 2,0 1,8 1,6 1,4′ 1,2 1,0
ИГ, дБ
ЗВ 38мА *20″С
Рис. 20. Амплитудно-частотные и шумовые характеристики МШУ
Интерес представляют шумовые характеристики МШУ. на входе которого
на входе которого
включена МИС защитного устройства, созданная в данной работе. Для
эксперимента была выбрана МИС» ограничителя мощности на рт-диодах,
характеризующаяся вносимыми потерями 0.35 дБ и модулями коэффициентов
отражения на входе и выходе не менее 20 дБ в Х-диапазоне частот. Максимально
допустимая входная мощность устройства Рвх„акс > 37 дБм (5 Вт): мощность
просачивания Р8ЫХ < 18 дБм (60 мВт).
На рис. 22 показаны измеренные
шумовые характеристики отдельной
МИС МШУ, а также устройства.
содержащего МИС МШУ и схему
ограничителя мощности на входе.
Коэффициент шума МИС усилителя
измерялся непосредственно на пластине.
а коэффициент шума усилителя с
защитой по входу измерялся в оснастке в
коаксиальном тракте. Коэффициент шума
всего устройства был обусловлен как
шумом самого монолитного усилителя,
так и шумом МИС ограничителя
мощности, коаксиально-полосковых переходов и проволочных соединений: он не превышал 2 дБ в диапазоне частот 8-10. 5 ГГц. При этом амплитудно-частотные характеристики устройства практически не отличались от характеристик МИС МШУ и соответствовали рис. 20. Измерения шумов проводились после воздействия на вход устройства сигнала мощностью 5 Вт в течение 10 минут.
5 ГГц. При этом амплитудно-частотные характеристики устройства практически не отличались от характеристик МИС МШУ и соответствовали рис. 20. Измерения шумов проводились после воздействия на вход устройства сигнала мощностью 5 Вт в течение 10 минут.
9 10 11
Частота, ГГц
Рис’. 22 Частотная зависимость коэффициента шума МШУ с защитой по входу
По совокупности параметров представленный набор схем (МИС МШУ и МИС ограничителя СВЧ-мощности) превосходит отечественные аналоги (например, защитное устройство М44419 и квазимонолитный двухкристальный МШУ Х-диапазона М211317-1, разработанные ФГУП «НПП «Исток») и соответствует зарубежным (например, защитное устройство ТСТ,2201 и МШУ X-диапазона ТОА2511, разработанные фирмой Тп<3шп{;).
В работе создан задел для создания схем на транзисторах, работающих в КВЧ-диапазоне. Разработки опирались на некоторый опыт работы предприятия в данном направлении. Разработана технология изготовления транзисторов с длиной затворов порядка 100 нм без использования электронной литографии (заявка на изобретение № 201110263 8 от 24. дпаЛ А11 |п1еп5 ( 200пт ЕНТ«10.00кУ 5|дпа1 А * !пЫп5
дпаЛ А11 |п1еп5 ( 200пт ЕНТ«10.00кУ 5|дпа1 А * !пЫп5
сгитк Ь…………….ИГО« 6.10*71 иг*Мате-ОГЕЗГ » ‘————-$ WD- 4.1 тт Ц«#гГЬте »ОТ£57
50.00 К X ‘ _
Рис. 23 Фотографии сечения затворов: а) длина затвора 140 нм; б) длина затвора 80 нм
ОСНОВНЫЕ РЕЗУЛЬТАТЫ РАБОТЫ
1) Впервые в стране созданы гетероструктурные арсенидгаллиеиые рт-диоды и СВЧ монолитные интег ральные схемы на их основе.
2) Экспериментатьно изучены особенности поведения СВЧ гетероструктурных рт-диодов в монолитных интегральных схемах. Впервые показано, что арсенидгаллиевые рт-диоды, входящие в состав СВЧ МИС, являются источниками инфракрасного излучения, обусловленного излучателыюй рекомбинацией электронов и дырок в диодах, что позволяет измерять температуру приборов и осуществлять дистанционный контроль схем при граничных испытаниях.
3) Впервые созданы СВЧ монолитные интегральные схемы широкополосных ограничителей мощности, одновременно содержащие вертикальные структуры рт-диодов и диодов Шоггки. По совокупности параметров схемы превосходят известные аналоги.
По совокупности параметров схемы превосходят известные аналоги.
4) Впервые предложена и реализована МИС ограничителя СВЧ-мощиости на основе рт-диодоп с управляемым уровнем просачивающейся мощности.
5) Экспериментально исследованы температурные зависимости скорости дрейфа электронов от поля в квантовой яме гетероперехода АЮаАэЛпОаАБ разработанного транзистора, что позволяет более корректно оценивать изменение параметров прибора в диапазоне температур 230-400 К.
6) Разработан серийный отечественный малошумяший бсскорпусной СВЧ гетероструктурный транзистор серии АП399А-5.
7) Разработан малошумяший усилитель Х-диапазона. по совокупности параметров соответствующий известным аналогам.
8) Показана совместимость разработанных монолитных интегральных схем МШУ, созданного по рНЕМТ-тсхнологии, и ограничителя СВЧ-мощности, созданного на основе гетероструктурных арсенидгаллиевых рт-диодов.
9) Проведен поиск путей существенного снижения длины затворов в гетероструктурных полевых транзисторах. В результате разработана новая технология формирования затворов с длинами порядка 100 им без использования электронной литографии.
В результате разработана новая технология формирования затворов с длинами порядка 100 им без использования электронной литографии.
10) Новизна предложенных схем и методов их создания подтверждена двумя патентами России. Кроме того, поданы 3 заявки на изобретения, на одну из которых уже имеется положительное решение. Практическая значимость разработанных схем и методов доказана их использованием в ОКР. В ОАО «НИИПП» планируется серийное освоение всех разработанных схем.
Основные результаты диссертации опубликованы в следующих работах:
1) Разработка полевых транзисторов с субмикронными затворами / Г.И. Айзенштат, Л.П. Громова, C.B. Литвин, А.И. Иващенко, АЛО. Ющенко // Изв. вузов. Физика. — 2008. — №9/3. — С. 46-47.
2) Рекомбинация носителей заряда в арсенидгаллиевом p-i-n-диоде / Г.И. Айзенштат, А.Ю. Ющенко, С.М. Гущин, Д.В. Дмитриев, К.С. Журавлев, А.И. Торопов // Физика и техника полупроводников. — 2010. — том 44, вып. 10.-С. 1407-1410.
Recombination of Charge Carriers in the GaAs-Based p-i-n Diode / G. I. Ayzenshtat, A.Y. Yushenko, S.M. Gushchin, D.V. Dmitriev, K.S. Zhuravlev,
I. Ayzenshtat, A.Y. Yushenko, S.M. Gushchin, D.V. Dmitriev, K.S. Zhuravlev,
A.I. Toropov // Semiconductors. — 2010. — Vol. 44, No. 10. — pp. 1362-1364.
3) Айзенштат Г.И. Измерение скорости насыщения электронов в квантовой яме AlGaAs/InGaAs / Г.И. Айзенштат, В.Г. Божков, А.Ю. Ющенко // Изв. вузов. Физика. — 2010. — № 9. — С. 34-39.
Ayzenshtat G.I. Measurement of the Electron Saturation Velocity in an AlGaAs/InGaAs Quantum Well/ G.I. Ayzenshtat, V.G. Bozhkov, A.Y. Yushenko // Russian Physics Journal. — 2010. — Vol. 53, No. 9. — pp. 914-919.
4) СВЧ p-i-n — диоды на основе гетероструктур AlGaAs/GaAs / Г.И. Айзенштат,
B.Г. Божков, А.Ю. Ющенко. Е.А. Монастырев, И.М. Добуш / Изв. вузов. Физика. — 2010. — № 9/2. — С. 310-314.
5) Разработка и исследование СВЧ ограничителей мощности на основе p-i-n -диодов / А.Ю. Ющенко. Г.И. Айзенштат, В.Г. Божков, Е.А. Монастырев, А.И. Иващенко, A.B. Акимов // Изв. вузов. Физика. — 2010. — № 9/2. — С. 315— 319.
— С. 315— 319.
6) Разработка монолитных интегральных схем коммутаторов на p-i-n — диодах для С- и Х- диапазонов частот / А.Ю. Ющенко. Г.И. Айзенштат, В.Г. Божков, Е.А. Монастырев, А.И. Иващенко, С.С. Кузнецов // Изв. вузов. Физика. -2010. — № 9/2. — С. 320-323.
7) СВЧ псевдоморфный транзистор с высокой подвижностью электронов / А.Ю. Ющенко. Г.И. Айзенштат, В.Г. Божков, Л.И. Бабак, И.М. Добуш, A.C. Сальников // Доклады ТУСУРа. — 2010. — №2 (22), часть 1. — С. 59-61.
8) Разработка элементной базы для создания СВЧ-модулей / А.Ю. Ющенко, Г.И. Айзенштат, В.Г. Божков, Е.А. Монастырев // Доклады ТУСУРа. — 2010. — №2 (22), часть 1. — С. 62-66.
9) Сальников A.C. Обзор тестовых структур для измерения электрофизических параметров материалов при изготовлении СВЧ монолитных интегральных
схем / А.С. Сальников, А.Ю. Ющенко / Доклады ТУСУРа. — 2010. — №2 (22), часть 1.-С. 145-148.
10) Ющенко А.Ю. Определение геометрических размеров затвора ПТШ с помощью электронного микроскопа / Материалы докладов Всероссийской научно-технической конференции студентов, аспирантов и молодых ученых «Научная сессия ТУСУР-2008» (Томск). — 2008. — Часть 1. — С. 267-269.
— 2008. — Часть 1. — С. 267-269.
11) Research of the Creation Opportunity of Matrix X-ray Gallium Arsenide Detector / D.G. Prokopyev, M.A. Lelekov, A.N. Duchko, A.Y. Yushenko // IEEE International Siberian Conference on Control and Communications SIBCON-2009 (Tomsk). — 2009. — pp. 185-188.
12) Ющенко А.Ю. Разработка PHEMT транзисторов на основе гетероструктур AlGaAs-InGaAs И НАУКА. ТЕХНОЛОГИИ. ИННОВАЦИИ. Материалы всероссийской научной конференции молодых ученых. — Новосибирск: Изд-во НГТУ, 2009. — Часть2. — 2009.-С. 117-119.
13) Айзенштат Г.И. Дрейфовая скорость электронов в псевдоморфном транзисторе / Г.И. Айзенштат, В.Г. Божков, А.Ю. Ющенко // Сб. трудов 20-ой Междунар. Крымской конф. «СВЧ-техника и телекоммуникационные технологии» — Севастополь: Вебер, 2010. — Т. 1 — С. 125-126.
14) Монолитная интегральная схема защитного устройства L- и S- диапазонов на основе диодов Шоттки / B.C. Арыков, А.Н. Гусев, О.А. Дедкова, А.Ю. Ющенко И Сб. трудов 20-ой Междунар. Крымской конф. «СВЧ-техника и телекоммуникационные технологии» — Севастополь: Вебер, 2010. — Т. 1 -С. 147-148.
Крымской конф. «СВЧ-техника и телекоммуникационные технологии» — Севастополь: Вебер, 2010. — Т. 1 -С. 147-148.
15) Монолитная интегральная схема защитного устройства на основе pin-диодов / А.Ю. Ющенко, Е.А. Монастырев, Г.И. Айзенштат, В.Г. Божков, А.В. Акимов // Сб. трудов 20-ой Междунар. Крымской конф. «СВЧ-техника и телекоммуникационные технологии» — Севастополь: Вебер, 2010. — Т. 1 — С. 153-154.
16) Гетоероструктурные pin-диоды / Г.И. Айзенштат, В.Г. Божков, А.Ю. Ющенко. ЕА. Монастырев // Сб. трудов 20-ой Междунар. Крымской конф. «СВЧ-техника и телекоммуникационные технологии» — Севастополь: Вебер, 2010.-Т. 1 -С. 169-170.
17) Self-Aligned Multilayer Dielectric «Dummy Gate» Technology for L-, S- and X-Band GaAs MMICs Fabrication / E.V. Anishchenko, V.S. Arykov, A.M. Gavrilova, O.A. Dedkova, V.A. Kagadei, O.V. Kamchatnaya, Y.V. Lilenko, A.Y. Yushenko // IEEE 2nd Russia School and Seminar MNST’2010. PAPERS. -2011.-pp. 37-40.
18) Kuznetsov S.S. High-Speed Driver for PIN Diode Microwave Switch / S.S. Kuznetsov, A.Y. Yushenko. V.G. Bozhkov // IEEE 2nd Russia School and Seminar MNST’2010. PAPERS. — 2011. — pp. 41-42.
High-Speed Driver for PIN Diode Microwave Switch / S.S. Kuznetsov, A.Y. Yushenko. V.G. Bozhkov // IEEE 2nd Russia School and Seminar MNST’2010. PAPERS. — 2011. — pp. 41-42.
19) Yushenko A.Y. Integral Circuits of Voltage Control Limiters / A.Y. Yushenko, G.I. Ayzenshtat, E.A. Monastyryov // IEEE 2nd Russia School and Seminar MNST’2010. PAPERS.-2011.-pp. 43-44.
20) Гетероструктурные монолитные интегральные схемы малошумящего усилителя Х- диапазона и pin-диодного ограничителя мощности / А.Ю. Ющенко. Г.И. Айзенштат, В.Г. Божков, Е.А. Монастырев, И.М. Добуш// Мокеровские чтения. Научно-практическая конференция по физике и технологии наногетероструктурной СВЧ-электроники (Москва). -2011.-С. 26-27.
21) Пат. 94765 РФ, МПК H01L31/00. Ограничитель СВЧ мощности / Г.И. Айзенштат(РФ), Е.А. Монастырев(РФ), А.Ю. Ющенко(РФ). -№2010104470/22; заявл. 09.02.2010; опубл. 27.05.2010.
22) Пат. 102846 РФ, МПК H01L31/00. Ограничитель СВЧ мощности / Г.И. Айзенштат(РФ), Е. А. Монастырев(РФ), А.Ю. Ющенко(РФ). -№2010143654/28; заявл. 25.10.2010; опубл. 10.03.2011.
А. Монастырев(РФ), А.Ю. Ющенко(РФ). -№2010143654/28; заявл. 25.10.2010; опубл. 10.03.2011.
Список цитируемой литературы:
1) Комплект широкополосных СВЧ-микросхем на гетероструктурах AmBv для ППМ АФАР Х-диапазона / A.M. Темнов, К.В. Дудинов, В.А, Красник, Ю.М. Богданов, А.В. Крутое, В.Г. Лапин, С.В. Щербаков // Электронная техника. Сер. 1, СВЧ-техника (Фрязино). — 2010. — №2(505). — С. 30 — 49.
2) Монолитные интегральные схемы малошумящих усилителей КВЧ-диапазона на GaAs рНЕМТ-гетероструктурах / ДЛ. Гнатюк, Ю.В. Федоров, Г.Б. Галиев, Р.Р. Галлиев, М.Ю. Щербаков // Доклады ТУ СУ Ра (Томск). — 2010. — Часть 1, №2(22)-С. 49-55.
3) Алферов Ж.И. Полупроводниковая электроника в России. Состояние и перспективы развития // Электроника: Наука, Технология, Бизнес. — 2004. -№6.-С. 88-92.
4) Зи С. Физика полупроводниковых приборов. — В 2-х книгах. Кн. 1. Пер. а англ. — 2-е перераб. и доп. изд. — М.: Мир, 1984. — 456 е., ил.
Отпечатано в ООО «Вайар» г. Томе*, Московский тракт, 2г. Тел./факс 52-98-11 Тираж 100 Заказ №290 от 28 июля 2011 г.
Томе*, Московский тракт, 2г. Тел./факс 52-98-11 Тираж 100 Заказ №290 от 28 июля 2011 г.
: Альтернатива операционного усилителя
ПИН-диоды , которые помещают слаболегированную внутреннюю (I) область между сильно легированными P- и N-областями, широко используются в ВЧ- и СВЧ-устройствах. Обычно PIN-диоды применяются в микроволновых переключателях, фазовращателях и аттенюаторах, где требуются высокая изоляция и низкие потери. Их можно найти в испытательном оборудовании, контрольно-измерительных приборах, средствах связи, радарах и в различных военных приложениях.
Каждый PIN-диод в схеме переключения имеет сопутствующий драйвер PIN-диода или драйвер переключателя , который обеспечивает управляемый ток прямого смещения, напряжение обратного смещения и активирующий интерфейс между управляющим сигналом — обычно цифровой логической командой и одним или несколькими PIN-диоды.Эта функция драйвера может быть реализована в виде дискретной конструкции или со специализированными ИС для соответствия приложению.
В качестве альтернативы можно использовать широко доступные операционные усилители и специальные усилители, такие как ограничивающие усилители и дифференциальные усилители, вместо дискретных схем управления PIN-диодами и дорогих микросхем драйверов PIN-диодов. Операционные усилители этого класса имеют широкую полосу пропускания, высокую скорость нарастания напряжения и более чем достаточный установившийся ток для управления PIN-диодами. В этой статье обсуждаются три различные схемы ПИН-драйвера, в которых используются операционные усилители или специальные усилители — AD8037, AD8137 и ADA4858-3.Цепи предназначены для работы с однополюсными двухпозиционными переключателями на PIN-диодах, но они также могут быть адаптированы для других конфигураций цепей. Они будут подробно описаны после обсуждения природы и использования PIN-диодов.
PIN диоды
PIN-диоды используются в качестве резисторов с регулируемым током на ВЧ- и СВЧ-частотах, с сопротивлением, которое может варьироваться от долей Ом при прямом смещении или на , до более 10 кОм при обратном смещении или при обратном смещении. В отличие от типичных диодов с PN-переходом, PIN-диоды имеют дополнительный слой внутреннего полупроводникового материала с высоким сопротивлением (I в PIN), зажатый между материалами P и N (Рисунок 1).
В отличие от типичных диодов с PN-переходом, PIN-диоды имеют дополнительный слой внутреннего полупроводникового материала с высоким сопротивлением (I в PIN), зажатый между материалами P и N (Рисунок 1).
Когда PIN-диод смещен в прямом направлении, дырки из материала P и электроны из материала N инжектируются в область I. Заряды не могут мгновенно рекомбинировать; конечное время, необходимое для их рекомбинации, называется временем жизни носителей .Это вызывает чистый накопленный заряд в области I, снижая его сопротивление до значения, обозначенного как R S , эффективного на сопротивлении диода (рис. 2a).
При подаче напряжения обратного смещения или нулевого смещения диод выглядит как большое сопротивление, R P , зашунтированное емкостью, C T (рисунок 2b). Изменяя геометрию диода, можно адаптировать PIN-диоды к различным комбинациям R S и C T , чтобы удовлетворить потребности различных схемотехнических приложений и диапазонов частот.
Комбинация установившегося тока смещения, I SS и обратного напряжение, обеспечиваемое драйвером, определяет окончательные значения R S и C T . Набор взаимосвязей для членов типичного семейства PIN-диодов можно увидеть на рисунках 3 и 4 — для кремниевых диодов серии M / A-COM MADP 042XX8-13060.Материал диода влияет на его свойства. Например, диодам из арсенида галлия (GaAs) требуется небольшое обратное смещение — если оно вообще есть — для достижения низкого значения C T , как показано на рисунке 9.
Рисунок 3. Зависимость сопротивления кремниевого диода от прямого тока. Рисунок 4. Зависимость емкости кремниевого диода от обратного напряжения.Накопленный заряд в PIN-диоде может быть аппроксимирован уравнением 1.
| (1) |
где:
Q S = накопленный заряд
τ = срок службы носителя диода
I SS = установившийся ток
Чтобы включить или выключить диод, необходимо ввести или удалить накопленный заряд. Работа водителя заключается в том, чтобы очень быстро ввести или удалить этот накопленный заряд. В случаях, когда время переключения меньше, чем срок службы несущей диода, пиковый ток (IP), необходимый для быстрого переключения, может быть аппроксимирован уравнением 2.
Работа водителя заключается в том, чтобы очень быстро ввести или удалить этот накопленный заряд. В случаях, когда время переключения меньше, чем срок службы несущей диода, пиковый ток (IP), необходимый для быстрого переключения, может быть аппроксимирован уравнением 2.
| (2) |
где:
t = необходимое время переключения
I SS = установившийся ток, обеспечиваемый драйвером, который устанавливает сопротивление PIN-диода, RS
τ = срок службы носителя
Ток впрыска или удаления драйвера или пиковый ток , i можно выразить уравнением 3.
| (3) |
где:
C = емкость выходных конденсаторов драйвера или пиковых конденсаторов
В = напряжение на выходных конденсаторах
dv / dt = скорость изменения напряжения на конденсаторах
во времениИнтерфейс смещения ПИН-диода
Подключение схемы управления драйвером переключателя к PIN-диоду, чтобы он мог включать и выключать диоды, применяя прямое или обратное смещение, является сложной задачей.В схеме смещения обычно используется фильтр нижних частот между ВЧ схемой и драйвером переключателя. На рисунке 5 показан однополюсный двухпозиционный радиочастотный переключатель (SPDT) и его схема смещения. При правильной реализации фильтры L1 / C2 и L3 / C4 позволяют подавать управляющие сигналы на PIN-диоды D1 – D4 с минимальным взаимодействием с РЧ-сигналом, который переключается с RF IN на PORT 1 или PORT 2. Эти элементы позволяют относительно управляющие сигналы более низкой частоты проходят через PIN-диоды, но не позволяют высокочастотному сигналу выходить из тракта радиочастотного сигнала.Ошибочные потери РЧ-энергии означают нежелательно более высокие вносимые потери для коммутатора. Конденсаторы C1, C3 и C5 блокируют смещение постоянного тока, подаваемое на диоды, от проникновения в схемы на пути радиочастотного сигнала. Катушка индуктивности L2 в обратном пути постоянного тока к земле позволяет с легкостью передавать сигналы постоянного тока и низкочастотные сигналы переключателя-драйвера, но имеет высокий импеданс на ВЧ и микроволновых частотах, уменьшая потери РЧ-сигнала.
Рисунок 5. Типовая схема однополюсного двухпозиционного переключателя (SPDT).Поскольку схемы смещения, ВЧ и драйвера переключателя все взаимодействуют и влияют на производительность друг друга, компромиссы важны, как и в любой конструкции.Например, если C2 и C4 большие (> 20 пФ) — что желательно для ВЧ характеристик — у драйвера есть проблема, потому что большие емкости приводят к более медленным нарастающим и спадающим фронтам. В большинстве приложений желательно быстрое переключение, поэтому для оптимальной производительности драйвера емкости должны быть минимальными, но при этом достаточно высокими, чтобы соответствовать требованиям радиочастотной цепи.
Драйверы традиционных ПИН-диодов
Драйверыдля PIN-диодов бывают разных форм и размеров. На рисунке 6 представлена схема типичного драйвера дискретного переключателя, который обеспечивает хорошую скорость переключения.Такие драйверы могут быть реализованы либо с микросхемной схемой (гибридной), что очень дорого, либо с компонентами для поверхностного монтажа (SMT), которые недороги, но требуют большего количества печатных плат (PCB). площадь, чем гибрид.
Рисунок 6. Схема драйвера дискретного переключателя.Выделенный переключатель-драйвер Интегральные схемы (ИС) также доступны; они компактны, имеют интерфейс TTL и обладают хорошей производительностью, но их гибкость ограничена, и они, как правило, дороги.
Другой вид архитектуры переключателя-драйвера, который следует рассмотреть, использует операционные усилители . Явным преимуществом драйверов переключателей операционных усилителей является присущая им гибкость. Их можно легко настроить для различных приложений, напряжений питания и условий, чтобы предоставить проектировщику множество вариантов дизайна.
Драйверы ПИН-диодов операционного усилителя
Схемы операционного усилителяявляются привлекательной альтернативой традиционным драйверам на PIN-диодах. Помимо гибкости, они могут работать с переходными скоростями, часто приближающимися или превышающими 1000 В / мкс.Здесь будут показаны три различные схемы усилителя для управления ПИН-диодами RF. Выбранные усилители принципиально разные, но все они выполняют схожие функции. Эти схемы усилителя будут управлять PIN-диодами из кремния или арсенида галлия (GaAs), но каждый может предложить что-то свое.
AD8037 — Клещевой усилитель
Эта схема может работать на частоте до 10 МГц с отличными характеристиками переключения и общей задержкой распространения 15 нс. Выходное напряжение и ток могут быть изменены , чтобы соответствовать различным приложениям, изменяя либо усиление, либо напряжение фиксации.
Фиксирующий усилитель AD8037, изначально разработанный для управления АЦП, обеспечивает фиксированный выход для защиты от перегрузки входа АЦП. В конфигурации, показанной на Рисунке 7, пара AD8037 (U2 и U3) используется для управления PIN-диодами.
Рис. 7. Схема драйвера PIN-диода AD8037.Здесь U2 и U3 настроены на неинвертирующее усиление, равное 4. Уникальная функция ограничения входного сигнала AD8037 обеспечивает исключительно чистый и точный зажим. Он линейно усиливает входной сигнал до точки, где будет превышено усиление, умноженное на положительное и отрицательное напряжение фиксации (V CH и V CL ).С коэффициентом усиления 4 и фиксирующими напряжениями ± 0,75 В выходное напряжение будет в четыре раза больше входного напряжения для входов меньше ± 0,75 В, но будет ограничено максимумом ± 3 В, когда входной сигнал больше ± 0,75. V. Эта функция ограничения обеспечивает очень быстрое восстановление (обычно менее 2 нс) после перегрузки. Напряжения фиксаторов (V CH и V CL ) определяются делителями напряжения R2, R3, R7 и R8.
Цифровой интерфейс реализован логическим вентилем 74F86 XOR (U1), который выдает управляющие сигналы для U2 и U3 с минимальным перекосом задержки распространения между двумя дополнительными выходами.Сеть резисторов R4, R5, R6 и R9 обеспечивает сдвиг уровня выходов TTL примерно до ± 1,2 В, который подается на U2 и U3 через R10 и R12.
Входы ± 1,2 В для U2 и U3 обеспечивают 60% перегрузки, гарантируя, что выходы перейдут в фиксированное состояние (4 × 0,75 В). Таким образом, выходные уровни для кремниевого драйвера PIN-диода установлены на ± 3 В. Резисторы R16 и R17 ограничивают установившийся ток. Конденсаторы C12 и C13 устанавливают пиковый ток для PIN-диодов.
AD8137 — Дифференциальный усилитель
Дифференциальные усилители, такие как AD8137, используемые в этом примере, обеспечивают исключительную высокоскоростную коммутационную способность при невысокой стоимости и предлагают разработчикам большую гибкость при управлении различными типами ВЧ нагрузок.Доступны различные дифференциальные усилители, в том числе более быстрые и высокопроизводительные устройства.
Высокоскоростной дифференциальный усилитель AD8137, обычно используемый для управления АЦП, также может служить в качестве недорогого и маломощного драйвера PIN-диода. Достигая типичного времени переключения от 7 нс до 11 нс, включая задержки распространения драйвера и ВЧ-нагрузки, он имеет дополнительные выходы и является универсальной альтернативой более дорогим обычным драйверам.
Схема на рисунке 8 преобразует несимметричный вход TTL (0 В в 3.5 В) к дополнительному сигналу ± 3,5 В с минимизацией задержки распространения. Сигнал TTL усиливается в 4 раза для обеспечения требуемого размаха ± 3,5 В на выходах AD8137. Средняя точка (или синфазное напряжение) сигнала TTL составляет 1,75 В; то же значение должно применяться к R 2 , как V REF , чтобы избежать появления ошибки синфазного смещения на выходах усилителя. Лучше всего управлять этой точкой от источника с низким импедансом; любое последовательное сопротивление будет добавлено к R 1 и повлияет на усиление усилителя.
Рисунок 8. Схема драйвера PIN-диода.Коэффициент усиления выходного напряжения определяется уравнением 4.
| (4) |
Чтобы правильно ограничить входное сопротивление генератора импульсов до 50 Ом, необходимо определить входное сопротивление схемы дифференциального усилителя. Это можно вычислить с помощью уравнения 5, которое дает R T = 51,55 Ом, для которого ближайшее стандартное значение 1% составляет 51.1 Ом. Для симметричного размаха на выходе важно, чтобы две входные цепи имели одинаковый импеданс. Это означает, что инвертирующий входной импеданс должен включать импеданс Тевенина источника и оконечного сопротивления в сопротивление установки усиления, R 2 . Для более подробного объяснения см. Примечание по применению AN-1026.
| (5) |
На рисунке 8 R 2 примерно на 20 Ом больше, чем R 1 для компенсации дополнительного сопротивления (25 Ом), вносимого параллельной комбинацией резистора источника, R S. и согласующий резистор R T .Установка R 4 на 1,02 кОм, ближайшее стандартное значение к 1,025 кОм, гарантирует, что два соотношения резисторов равны, чтобы избежать появления синфазной ошибки.
Сдвиг выходного уровня легко выполняется с помощью вывода V OCM AD8137, который устанавливает синфазный уровень выходного постоянного тока. В этом случае вывод V OCM связан с землей для симметричного колебания выхода относительно земли.
Резисторы R5 и R6 устанавливают установившийся ток PIN-диода, как показано в уравнении 6.
| (6) |
Конденсаторы C5 и C6 устанавливают пиковый ток, который помогает вводить и удалять накопленный заряд в PIN-диодах. Их значения емкости можно регулировать для оптимизации характеристик, необходимых для конкретной диодной нагрузки. Пиковый ток можно определить по уравнению 7.
| (7) |
ADA4858-3 — Тройной операционный усилитель с нагнетательным насосом
Для многих приложений доступен только один источник питания.Это часто может быть проблематичным для разработчика схем, особенно при поиске низкой выходной емкости в схемах PIN. В таких случаях операционный усилитель со встроенной накачкой заряда полезен в схеме для управления кремниевыми или GaAs PIN-диодами, не требуя внешнего отрицательного источника питания. Это может обеспечить значительную экономию за счет экономии места, энергии и бюджета.
Одним из таких устройств является ADA4858-3, высокоскоростной тройной усилитель с обратной связью по току, отличающийся тем, что он включает в себя встроенную подкачку заряда, которая позволяет изменять выходной сигнал с –3 В до –1.8 В под землей, в зависимости от напряжения питания и нагрузки. Он достаточно надежен, чтобы на самом деле питать другие схемы отрицательным током питания до 50 мА.
ADA4858-3 обеспечивает уникальное решение проблемы управления СВЧ-переключателем с дополнительным PIN-диодом в системе с однополярным питанием. Вспоминая рисунок 4, можно увидеть, что, в зависимости от типа PIN-диода, даже небольшое обратное смещение помогает снизить емкость диода, C T . Пин-диоды GaAs выигрывают от этого типа драйвера, поскольку они обычно не требуют большого отрицательного смещения для поддержания низкой емкости в выключенном состоянии (C T ) (рисунок 9).
Рис. 9. Зависимость емкости трансформатора тока GaAs от напряжения.На рисунке 10 показана схема, использующая ADA4858-3 в качестве драйвера PIN-диода. Ко входу можно добавить буферный вентиль, чтобы схема была совместима с TTL или другой логикой. Для этой схемы требуется преобразовать размах входного сигнала TTL 0-В в 3,5 В в дополнительный размах от –1,5 В до + 3,5 В для управления PIN-диодами.
Рисунок 10. ADA4858-3 как драйвер PIN-диода.R1, R2, R3 и U1C образуют опорное напряжение –1,5 В для цепи с внутренним отрицательным напряжением CPO, генерируемым встроенной накачкой заряда.Конденсаторы C3 и C4 необходимы для работы зарядного насоса. Затем отрицательное задание пассивно суммируется с входом V TTL через делитель напряжения (R5 и R9). Результирующее напряжение (В RD ) появляется на неинвертирующем входе U1B. Выходное напряжение U1B можно рассчитать с помощью уравнения 8.
| (8) |
где:
| (9) |
Отрицательное задание также подается на усилитель U1A, где оно суммируется с входом TTL; результирующее выходное напряжение V2 можно рассчитать с помощью уравнения 10.
| (10) |
Поскольку в этих усилителях используется архитектура с обратной связью по току, необходимо уделить внимание выбору сопротивления обратной связи, которое играет важную роль в стабильности и частотной характеристике усилителя. Для этого приложения резистор обратной связи установлен на 294 Ом, как рекомендовано в техническом паспорте. Выходные напряжения V1 и V2 можно описать уравнением 8 и уравнением 10 соответственно.Величину пикового выходного тока можно определить с помощью уравнения 3 для напряжения на конденсаторах C5 и C6. Установившийся ток, который устанавливает сопротивление PIN-диода, определяется разностью напряжений на R11 и R12 и зависит от кривых PIN-диода и требований системы.
Для этого приложения в качестве нагрузки РЧ-переключателя использовался SPDT-переключатель на кремниевом PIN-диоде MASW210B-1, используемый во входном каскаде микроволнового понижающего преобразователя (рис. 11).
Рисунок 11. Блок-схема понижающего преобразователя.Форма выходного сигнала переключателя и входной сигнал TTL показаны на рисунке 12. Обратите внимание на быстрые нарастающие и спадающие фронты. В этом приложении не использовались пиковые конденсаторы C5 и C6 из-за относительно медленного времени переключения, требуемого переключателем, примерно 50 нс. R11 и R12, которые определяют установившийся ток диода, были резисторами 330 Ом.
Рисунок 12. Форма волны, показывающая скорость переключения РЧ. Рисунок 13. Спектральная характеристика понижающего преобразователя.На рисунке 13 показана спектральная частотная характеристика входного каскада понижающего преобразователя с переключателем SW1 в фиксированном положении для проверки вносимых потерь.Обратите внимание на отсутствие гармоник или боковых полос — это хороший признак того, что нет заметных артефактов переключения 100 кГц, исходящих от встроенной накачки заряда ADA4858-3 — важное соображение при использовании этих устройств в приложениях такого типа.
Заключение
Как показывают эти три примера, операционные усилители могут предоставить творческую альтернативу традиционным драйверам, с производительностью, сопоставимой с характеристиками специализированных ИС, предназначенных исключительно для управления PIN-диодами. Кроме того, операционные усилители предоставляют возможность настраивать коэффициенты усиления, управлять входами и — при использовании устройств, содержащих внутреннюю подкачку заряда — устранять отрицательное напряжение питания, добавляя гибкость конструкции драйверов для PIN-диодов и других схем.Простые в использовании и настройке операционные усилители относительно легко решают сложные проблемы.
использованная литература
Хиллер, Джеральд. Конструкция с PIN-диодами . Примечание по применению M / A-COM AG312.
Общие сведения о твердотельных коммутаторах ВЧ / СВЧ и их применении . Примечание по применению Agilent.
Благодарности
Данные о скорости переключения и спектральные характеристики, ВЧ-нагрузка и испытательное оборудование были любезно предоставлены Sage Laboratories, Hudson, NH.Испытания проводились под руководством Тони Каппелло, технического директора, при технической поддержке Дэвида Дункана, вице-президента по инженерным вопросам.
Микроволны101 | PIN-диоды
PIN-диоды — это рабочая лошадка в индустрии твердотельных переключателей СВЧ! Аббревиатура «PIN» соответствует полупроводниковому стеку из материала P-типа, внутреннего материала и материала N-типа. PIN-диоды могут быть выполнены как на GaAs, так и на кремнии.
Небольшой совет для всех, кто хочет узнать о PIN-диодах … во всемирной паутине есть множество отличных технических данных от поставщиков PIN-диодов, которые все объясняют! Вы спросите, почему мы не предлагаем ссылки на них с этой страницы… почему они не платят нам за бизнес, мы спрашиваем.
В PIN-диоде контакт P является анодом, а контакт N — катодом. Согласно принятому соглашению сторона, на которую подается постоянный ток (при прямом смещении), всегда называется анодом. На схематическом обозначении анод — это сторона с треугольником, катод — это сторона с «пластиной». Как вы запомните, что есть что? Обозначение анода — треугольник, входящий в состав буквы А …
.Типы PIN-диодов
На рисунке ниже показан горизонтальный PIN-диод, иногда называемый H-PIN.Здесь слои P и N формируются поверх слоя I.
Вот так называемый вертикальный PIN-диод или V-PIN. Здесь диод образован стопкой из трех материалов, сверху вниз, P, I, N.
Наконец, вот структура, известная как диод NIP. Это просто перевернутый PIN-диод.
ПИН-диодный отклик
PIN-диод действует как резистор с регулируемым током. Чем больше тока вы вводите через область I, тем ниже сопротивление RF.В идеале характеристика тока / сопротивления имеет вид R = K / I (где K — постоянная), что выглядит как прямая линия на графике в логарифмическом масштабе. Спасибо за исправление, Мортен!
Посмотрите на диапазон сопротивления, который вы можете получить, от 0,1 Ом до 10 000 Ом … да, PIN-диод в значительной степени покрывает всю горизонтальную ось диаграммы Смита! (Посмотрите на таблицу выше и обратите внимание, что сопротивление 50 Ом находится очень близко к центру отклика). Это то, что делает его таким универсальным устройством, оно может вести себя как разомкнутая цепь, короткое замыкание или любой промежуточный коэффициент отражения.Вы можете использовать его для создания переключателей, фазовращателей и регулируемых аттенюаторов, и мы покажем вам, как это сделать, если вы перейдете по ссылкам в верхней части страницы.
Нижнее ограничение частоты PIN-диодов
PIN-диодыимеют ограничение по низкой частоте из-за срока службы несущей. Что за перевозчик? Какая разница? Проблему можно объяснить, не беспокоясь о физике полупроводников.
«Обычный» диод работает как выпрямитель, независимо от частоты. Выпрямитель имеет знакомую нелинейную кривую ВАХ.При прямом смещении ток уходит на Луну после полувольта или около того. При обратном смещении ток для многих вольт практически равен нулю, пока не произойдет пробой. Диод Шоттки — отличный пример выпрямительного диода, поэтому его используют как детектор. РФ входит, постоянный ток уходит.
PIN-диод действует как выпрямитель только на низких частотах. На микроволновых частотах ВАХ претерпевает изменение, так что он ведет себя как резистор, значение сопротивления которого определяется уровнем постоянного тока, присутствующего в I-области.Таким образом, PIN-диод — это, по сути, высокочастотный резистор, управляемый постоянным током. Не менее важно, что при отсутствии постоянного тока диод ведет себя как разомкнутая цепь.
Частота, при которой PIN-диод переходит от действия диода к действию резистора, является функцией толщины I-области. Более толстые диоды можно использовать в качестве переключателей на более низкие частоты. Тщательно подобрав диоды, вы можете заставить переключатели на PIN-диодах работать на частотах до 1 МГц.
Как будто этого поведения недостаточно, подождите, это еще не все! Управляющий постоянный ток может быть небольшим, в то время как СВЧ-ток может быть огромным…. несколько миллиампер тока при постоянном токе могут привести к короткому замыканию PIN-диода на ампер или более высокочастотного тока. Это огромное преимущество для разработчиков РЧ-переключателей, которым необходимо учитывать управление мощностью.
PIN диодные ограничители
PIN-диодытакже могут использоваться для создания ограничителей (типа нелинейного устройства), обычно в качестве одного или нескольких шунтирующих элементов на линии передачи. Часто диоды разделены волшебной четвертьволной, чтобы улучшить отклик на слабый сигнал. Ограничитель — это (обычно) пассивное устройство, которое имеет низкие потери для слабых сигналов, а затем увеличивает свое затухание при увеличении уровней мощности.
Некоторые ограничители PIN-диодов являются пассивными, что означает, что PIN-диод сам создает нелинейный отклик. «Активный ограничитель» добавляет детекторную схему, которая подает постоянный ток на PIN-диод, чтобы включить его сильнее при более низкой мощности. В детекторе используется диод Шоттки. Переключаемый ограничитель использует управляющий сигнал постоянного тока для включения PIN-диода.
Проектирование с использованием диодов: почему выбирают AlGaAs?
24 октября 2017 г.
На протяжении десятилетий полупроводниковые компоненты управления, такие как PIN-диоды , использовались в устройствах управления ВЧ и СВЧ, таких как переключатели , и аттенюаторы.PIN-диоды действуют как переменные ВЧ-резисторы с регулируемым зарядом, обеспечивая низкие вносимые потери , большую развязку , превосходную мощность и превосходную линейность, и во многих случаях лучше, чем может обеспечить любой полевой транзистор. Диапазон импеданса, который может представлять PIN-диод, может достигать 5 или 6 декад, крайние значения которых соответствуют разомкнутому и короткому замыканию.
ПИН-диодымогут быть размещены последовательно или шунтируются с линиями передачи, такими как микрополосковые, копланарные волноводы и т. Д.Сопротивление и емкость PIN-диода определяют вносимые потери и изоляцию, соответственно, для последовательного соединения или, наоборот, для шунтирующего соединения.
PIN-диод представляет собой 3-слойное устройство, состоящее из
- анод , акцепторный (p-тип) P слой
- нелегированный ( внутренний ) I слой
- катод , донорно-легированный (n-тип) слой N
Когда эта структура представлена в виде прямоугольного сечения, мы можем увидеть, что площадь перехода и толщина I-слоя определяют емкость (C) PIN-диода, когда он не проводит, и последовательное сопротивление . (R) диода при смещении на проводимость согласно элементарным уравнениям:
Диэлектрическая проницаемость слоя I (e) и его удельное сопротивление (r) определяются типом материала, из которого изготовлен диод.Толщина, также известная как длина ( l ) слоя I, определяет или влияет на несколько рабочих параметров, включая, среди прочего, емкость диода, сопротивление диода, напряжение лавинного пробоя диода и вызывает гармонические искажения. Площадь диодного перехода в первую очередь влияет на C и R.
Практика проектирования электроники — это непреложное упражнение в поиске компромиссов. Поскольку частоты, на которых используются PIN-диоды, увеличились, требуемая емкость диодов должна быть меньше для достижения приемлемых характеристик.В первую очередь это было достигнуто за счет уменьшения площади стыка. Это снижение емкости произошло за счет соразмерного увеличения последовательного сопротивления, что привело к увеличению вносимых потерь для приложений с последовательным подключением или к снижению изоляции для приложений с параллельным подключением. За исключением увеличения толщины слоя I, что также приводит к увеличению последовательного сопротивления, инженер-конструктор ничего не мог сделать.
Сопротивление сериитакже может быть определено с точки зрения физических свойств полупроводника диода.
Где l — толщина слоя I, µ amb — амбиполярная подвижность носителей заряда, инжектированных в слой I, а Q представляет количество свободных носителей заряда, инжектированных в слой I.
По мере увеличения частот до такой степени, что µ amb Si создавал слишком большое последовательное сопротивление, были приняты материалы с более высоким значением µ amb , такие как арсенид галлия (GaAs).Для приложений миллиметрового диапазона (ммВт) даже более высокое значение µ amb для GaAs имеет недостатки.
Чтобы удовлетворить эту потребность в улучшении сопротивления и более низкой емкости на частотах миллиметрового диапазона, MACOM разработал PIN-диоды с гетеропереходом с использованием новой структуры из арсенида алюминия-галлия (AlGaAs), чтобы устранить ограничения GaAs и Si PIN-диодов. PIN-диоды AlGaAs также являются трехслойными диодами, но с существенным отличием: алюминий (Al) используется в качестве легирующей примеси p-типа в анодном слое диода.Слои I и N диода состоят из GaAs. Добавление Al в анодный слой увеличивает ширину запрещенной зоны диодного перехода по сравнению с GaAs PIN-структурой, что создает больший барьер для диффузии дырок из I-слоя обратно в P-слой, когда диод находится ниже прямое смещение , таким образом увеличивая Q, количество свободных носителей заряда в слое I. Это увеличение популяции носителей заряда с прямым смещением в слое I снижает последовательное сопротивление PIN-диода AlGaAs без изменения характеристик обратного смещения диода .
Конечный результат состоит в том, что один ранее нерушимый компромисс был облегчен: для PIN-диода AlGaAs и PIN-диода GaAs с одинаковой длиной слоя I и одинаковыми значениями сопротивления PIN-диод AlGaAs может иметь меньшую площадь перехода с более низкой емкостью перехода. , что позволяет улучшить характеристики схемы.
Глоссарий:
Анод: Слой диода, легированный акцепторными атомами.
Напряжение пробоя Avalance / Напряжение пробоя: Напряжение обратного смещения, при котором протекает заданная величина обратного тока (обычно 10 микроампер).Обозначение наличия напряжения пробоя: В BR или В B .
Катод: Слой диода, легированный донорными атомами.
Диод: Пассивное электронное устройство с двумя выводами, которое, как правило, способно к выпрямлению.
Примесь: Инородное вещество, которое добавляется к полупроводниковому материалу для достижения желаемого эффекта. Например, материал акцепторного атома, который добавляется к полупроводнику для образования анодного слоя, представляет собой легирующую добавку.
Прямое смещение: Состояние, при котором напряжение, приложенное к аноду выпрямительного полупроводникового диода, является отрицательным по отношению к его катоду.
Вносимые потери: Снижение передаваемой мощности, обычно выражаемое в децибелах, которое возникает, когда компонент или другая структура вставляется в линию передачи. Этот термин используется, когда предполагается, что потери будут небольшими.
Изоляция: Внесенные потери, обычно выражаемые в децибелах, создаваемые компонентом.Этот термин используется, когда предполагается, что вносимые потери будут большими.
Внутренний слой «I-слой»: Слой PIN-диода, который имеет концентрацию легирования, типичную для той, которая считается естественным состоянием полупроводника. В PIN-диоде собственный слой обычно имеет концентрацию донорных атомов, концентрация легирования которых на несколько порядков ниже, чем у катодного слоя.
PIN-диод: Полупроводниковый диод, состоящий из трех слоев.Центральный слой изначально легирован (l-слой) и находится между слоем, сильно легированным акцепторными атомами (P-слой), и слоем, сильно легированным донорными атомами (N-слой).
Последовательное сопротивление «RS»: Противодействие протеканию тока в полупроводниковом переходе, где переход моделируется как параллельная цепь. Обозначение последовательного сопротивления — R S .
Коммутатор: Устройство, которое разрешает или предотвращает распространение сигнала между точками, является средой передачи.
Обратное смещение: Состояние, при котором напряжение, приложенное к аноду выпрямительного полупроводникового диода, является положительным по отношению к его катоду.
Заявление об ограничении ответственности
Все прогнозы финансового руководства, упомянутые в этом посте, были сделаны на дату публикации или другую историческую дату, указанную в данном документе, и любые ссылки на такие прогнозы в настоящем документе не предназначены для их подтверждения на более позднюю дату. MACOM не берет на себя никаких обязательств по обновлению каких-либо прогнозных заявлений или прогнозов в будущем.Этот пост может включать информацию и прогнозы, полученные из сторонних источников, в отношении доступного размера рынка и темпов роста, а также аналогичные общие экономические или отраслевые данные. MACOM не проводил независимую проверку какой-либо информации и прогнозов из сторонних источников, включенных в настоящий документ. Этот пост может также содержать рыночную статистику и отраслевые данные, которые подвержены неопределенности и не обязательно отражают рыночные условия. Хотя MACOM считает, что эти статистические данные и данные являются разумными, они были получены из сторонних источников и не были проверены MACOM независимо.
MMVL3401T1 — Кремниевый штыревой диод
% PDF-1.4 % 1 0 объект > эндобдж 5 0 obj / Название (MMVL3401T1 — кремниевый штыревой диод) >> эндобдж 2 0 obj > эндобдж 3 0 obj > транслировать BroadVision, Inc.2020-11-19T10: 56: 23 + 08: 002010-09-27T14: 05: 38-07: 002020-11-19T10: 56: 23 + 08: 00application / pdf
IEppxHX,! ͅʯ6chh ځح D + Nx ‡ `
Электроника | Бесплатная полная -Text | Оценка конструкции устройства диодов Шоттки
с объединенным GaN-соединением PiN На рисунке 4 показано распределение электрического поля MPS при -400 В с расстоянием между слоями p-GaN W d от 0.От 5 до 6 мкм, при сохранении ширины бокса p-GaN W p 1 мкм, глубины Dp 800 нм и концентрации i-GaN 2 × 10 16 / см 3 . При обратном смещении МПС область пространственного заряда в PN-переходе расширялась наружу. В случае W d –W p = 0,5–1 мкм, область пространственного заряда соседнего PN-перехода будет сливаться вместе, чтобы поддерживать вертикальное напряжение под контактом Шоттки, что приводит к уменьшению электрического поля в точке Шоттки. контактная поверхность по сравнению с чистым SBD.В этом случае контакт Шоттки был защищен от сильного электрического поля. При увеличении обратного смещения до 550 В пиковое электрическое поле внутри МПС могло достигать критического значения, при котором МПС выходил из строя. Можно обнаружить, что напряжение блокировки 550 В было лишь немного ниже, чем у чистых P-i-N диодов (600 В). При увеличении W d от 0,5 до 4 и 6 мкм можно обнаружить, что при тех же обратных 400 В эффект слияния двух соседних областей пространственного заряда уменьшился, или, другими словами, эффект экранирования от области пространственного заряда для защиты контакт Шоттки был ослаблен, как показано на рис. 4b, c.Должно быть более высокое падение напряжения, чтобы область пространственного заряда PN-перехода расширилась до такой степени, что две соседние области пространственного заряда могли бы слиться друг с другом. Кроме того, возможно, что до того, как область пространственного заряда сможет получить заряд для плавления, пробой может уже произойти на границе контакта Шоттки, которая определяется как горячая точка пробоя, как в случае на рисунке 4c. Таблица 2 суммирует извлеченные характеристики устройства при пробое для различных областей между p-GaN (расстояние W d ), сохраняя при этом поперечный размер p-GaN фиксированным на уровне 1 мкм.Можно обнаружить монотонно уменьшающееся напряжение пробоя по мере увеличения W d в результате непрерывно уменьшающихся эффектов экранирования электрического поля. Соответственно, горячая точка пробоя перемещалась изнутри области объемного заряда GaN на контактную поверхность Шоттки. MPS с концентрацией i-GaN 1 × 10 16 / см 3 был также смоделирован, как показано на рисунке 5. Аналогично MPS с концентрацией слоя i-GaN 2 × 10 16 / см 3 , контакт Шоттки был хорошо защищен коротким W d , например W d –W p = 0.5–1 мкм (рис. 5а). По мере увеличения W d эффект экранирования уменьшался. Кроме того, было обнаружено, что критическая точка (одновременный пробой) возникает при комбинации W d –W p = 8–1 мкм, что сильно отличается от MPS с концентрацией слоя i-GaN 2 × 10 16 / см 3 . Точку одновременного пробоя можно рассматривать как индикатор того, что горячая точка пробоя сместилась изнутри МПС и оказалась на контактной поверхности Шоттки.В последнем случае эффект экранирования электрического поля от PN-переходов был скомпрометирован, так что контакт Шоттки не был хорошо экранирован от сильного электрического поля. Дальнейшее сравнение таблиц 2 и 3 показало, что для MPS с такими же размерами устройства напряжение пробоя может быть значительно увеличено за счет уменьшения фоновой концентрации дрейфового слоя в результате генерируемой большей области пространственного заряда.(PDF) Гибкие микроволновые PIN-диоды и переключатели, использующие переносимые монокристаллические Si наномембраны на пластиковых подложках
Дж.Phys. D: Прил. Phys. 42 (2009) 234006 G Qin et al
2. Изготовление устройства
Процесс изготовления PIN-диодов и включение
пластиковой подложки с использованием технологии переноса SiNM
полностью совместим с той, которая использовалась для изготовления гибкой
TFT, как показано ранее [13]. Совместимость
значительно упростит возможную монолитную интеграцию активных
TFT и переключателей на одной гибкой подложке.Технологический поток
проиллюстрирован на рисунке 1. Изготовление
начинается со слаболегированной подложки из кремния p-типа (0 0 1) UNIBOND®SOI
с верхним слоем Si 200 нм и скрытым оксидом
толщиной 200 нм. (BOX) слой. Оптическая фотолитография была выполнена
для определения сильно легированных областей n- и p-типа в верхнем слое
Si. Затем была выполнена двухэтапная ионная имплантация
для областей N + и P + со следующими условиями:
4 × 1015 см − 2 ионов фосфора при 40 кэВ и 4 × 1015 см − 2
ионов бора при 25 кэВ, соответственно. .После этого образец
был отожжен при 850 ◦C в течение 45 мин в окружающем N2 в печи
(рисунок 1 (а)). Эти этапы обработки дали желаемые высокие концентрации легирования
в верхнем слое Si, которые обеспечивают низкое сопротивление листа
и низкое контактное сопротивление [13], которые являются критическими
для реализации высокопроизводительных ВЧ-устройств, включая переключатели RF
в качестве описано далее по тексту. Вся последующая обработка
состоит из низкотемпературных (low-T) этапов.Из слоя Si
200 нм затем был сформирован узор в виде полос шириной 30 мкм с помощью фотолитографии
с последующим плазменным сухим травлением (SF6 / O2)
до слоя BOX (рисунок 1 (b)). После удаления фоторезиста
образец помещали в соляную кислоту (HF), чтобы
стравил нижележащий слой BOX и освободил полоски Si.
Чтобы освободить верхний слой Si, ему можно придать узор
многих других форм. Например, высвобожденный слой Si может иметь узор
в виде единого листа, содержащего массив отверстий.Все
этих форм обычно называют Si наномембранами (SiNMs).
Когда структурированный SiNM был выпущен, он осел
и слабо связан с обрабатываемой подложкой Si за счет слабых сил Ван-дер-Ваальса
[15]. Из-за тонкости слоя BOX
(200 нм здесь по сравнению с толщиной микрометра в некоторых других типах КНИ
), высвобожденные полоски Si, несмотря на то, что они были очень гибкими, сохраняли свою пространственную регистрацию на прежнем уровне. во время
шаг фотолитографии (рисунок 1 (c)).Затем образец
был тщательно промыт деионизированной водой и затем был помещен лицом к лицу
и прочно контактировал с полиэтиленовой подложкой из терефталата
(ПЭТ), на которую методом центрифугирования нанесен эпоксидный слой SU-8
. Умышленного воздействия на СУ-8 по адресу
на данный момент не было. Поскольку сила связи между SiNM и
эпоксидной смолой сильнее, чем связь Si-to-Si, SiNM
можно снять с подложки SOI и перенести на
подложку из ПЭТФ (рис. 1 (d )).Затем для отверждения SU-8 использовали этап УФ-облучения
.
Техника переноса изгиба гарантирует, что положение
полосок Si с рисунком не меняется на протяжении всего процесса
, так что предварительно легированные области могут быть дополнительно зарегистрированы
с остальными маскирующими слоями даже после того, как они были перенесла
на пластиковую подложку [11,13]. В результате может быть легко достигнута более высокая точность регистрации SiNM
, чем при использовании
любых других методов передачи.Однако для переноса IP-адреса требуется
, чтобы в
использовался тонкий слой BOX (примерно менее 0,5 мкм), чтобы избежать использования якорей или тросов [16] для предотвращения сдвигов положения
SiNM во время их освобождения. Кроме того, из-за мерцания SiNM
во время переноса необходимы надлежащие условия ионной имплантации и
отжига, чтобы гарантировать, что высокие концентрации легирования
для n- и p-типов реализованы на нижней стороне
Si слой перед выпуском (чтобы в дальнейшем на нижней поверхности формировать качественные омические контакты
).Требования к специальной ионной имплантации и отжигу
делают тонкие SiNM
более подходящими для этого процесса изготовления
, чем очень толстые.
На следующем этапе подложка из ПЭТ была перевернута поверх
, чтобы обнажить нижнюю сторону SiNM для дальнейшей обработки
(рисунок 1 (e)). Наконец, металлические контакты и межсоединения
были сформированы путем испарения слоя пакета 40/500 нм
Cr / Au после этапа фотолитографии (рисунок 1 (f)).И отдельные PIN-диоды
, и однополюсные однопроходные (SPST) переключатели
были изготовлены на той же подложке из ПЭТ, что и
, показанном на рисунке 1 (f). Как можно видеть, объединив
высокотемпературный (высокотемпературный, выполняется на КНИ) и
низкотемпературный процессы, мы обошли парадоксальную проблему
, заключающуюся в том, что пластиковые подложки не переносят высокую температуру —
. процессов и что высокотемпературные процессы
абсолютно необходимы для достижения высоких концентраций легирования
и, следовательно, низких паразитных сопротивлений.Фактически, самая высокая температура
, которая применялась к пластиковым подложкам, поддерживалась
ниже 120 ◦C (применительно к ПЭТ для запекания фоторезиста), что
ниже температурного допуска (∼170 ◦C: размягчение по Вика
). точка) подложек из ПЭТ.
В отличие от обычных вертикальных структур PIN-диодов,
P-, I- и N-области в этом исследовании были расположены сбоку
на SiNM. В то время как тонкость SiNM
позволяет достичь желаемой механической гибкости, боковое расположение
PIN-структуры упростило ее изготовление на тонких SiNM
.Ширина I-области
определяется расстоянием между областями P + и N + во время фотолитографии
. В данном исследовании
используется ширина I-области 2 мкм для достижения высокочастотного отклика, в то время как
поддерживает правильное напряжение пробоя для управления мощностью.
Площадь поперечного сечения диода можно рассчитать, умножив
ширины области P + (или N +) на толщину
SiNM (200 нм). Изготовленные диоды имеют различные площади
от 80 до 320 мкм2.Переключатели SPST, сконфигурированные с
этих PIN-диодов, также были изготовлены на подложке из ПЭТ.
На рис. 2 (а) представлено схематическое поперечное сечение бокового PIN-диода
SiNM. На рис. 2 (b) показано оптическое изображение гибких PIN-диодов
и переключающих матриц на подложке из полиэтилентерефталата.
На рисунках 2 (c) и (d) показаны изображения с помощью оптического микроскопа полированного бокового SiNM PIN-диода
с площадью 80 мкм2 и шунтирующего SPST-переключателя
, содержащего два PIN-диода (площадь
оба составляет 40 мкм2) соответственно.На вставках к этим двум рисункам
показаны соответствующие принципиальные схемы PIN-диода и переключателя
SPST, соответственно.
3. Результаты и обсуждение
3.1. Серия PIN-диодов
Характеристики постоянного тока гибких SiNM-диодов
были измерены с помощью полупроводникового параметра HP4155B. В новых мощных ВЧ- и СВЧ-переключателях на ПИН-диодах Пастернака
используется полупроводниковая технология GaN.Технологии GaN и микросхемы и провода в производственном процессе обеспечивают самые современные характеристики мощности с отличным соотношением мощности к объему, что идеально для широкополосных приложений с высокой мощностью. Эти переключатели на ПИН-диодах обладают превосходными тепловыми свойствами и значительно более высоким напряжением пробоя, что позволяет выдерживать более высокие уровни входной мощности в широкополосных и узкополосных ВЧ и СВЧ частотах. Поскольку это конструкции с PIN-диодами, они также обеспечивают быструю скорость переключения менее 50 нс.
Другие особенности включают производительность холодного переключения до 100 Вт входной мощности CW RF, широкий диапазон частот от постоянного тока до 18 ГГц с использованием отражающих SPDT и SP4T PIN-диодов, TTL-совместимую схему драйвера для точного логического управления и компактные коаксиальные корпуса. Все устройства соответствуют требованиям EAR99 и соответствуют ряду условий окружающей среды, таких как высота, вибрация, влажность и удары.
«Эти новые GaN-переключатели на PIN-диодах обладают отличными тепловыми свойствами, соотношением мощности к объему и более высоким напряжением пробоя, что обеспечивает передовые возможности управления мощностью в небольших компактных корпусах.Кроме того, мы предлагаем эти новые высокомощные переключатели на ПИН-диодах в готовом виде с доставкой в тот же день », — сказал Тим Галла, менеджер по линейке продуктов.
Новые мощные ВЧ- и СВЧ-переключатели на ПИН-диодах Pasternack есть в наличии и доступны. для немедленной доставки без минимального количества заказа (MOQ).
По всем вопросам обращайтесь в Pasternack по телефону + 1-949-261-1920.
О Pasternack:
Компания Pasternack является лидером в области производства продукции в РФ с 1972 года. 9001: 2015 сертифицированный производитель и поставщик, предлагающий самый большой в отрасли выбор активных и пассивных устройств RF, микроволнового и миллиметрового диапазонов, доступных для доставки в тот же день.Pasternack — это бренд Infinite Electronics.
О Infinite Electronics:
Компания Infinite Electronics, расположенная в Ирвине, Калифорния, предлагает широкий спектр компонентов, сборок и решений для проводных / беспроводных подключений, обслуживающих аэрокосмическую / оборонную, промышленную, правительственную, бытовую электронику, приборы, медицину и телекоммуникации. . Бренды Infinite включают Pasternack, Fairview Microwave, L-com, MilesTek, ShowMeCables, NavePoint, INC Installs, Integra Optics, PolyPhaser, Transtector, KP Performance Antennas, RadioWaves и Aiconics.




 Сер.: Ядерно-физические исследования. Харьков. 1999.
№ 1. С. 98-99.
Сер.: Ядерно-физические исследования. Харьков. 1999.
№ 1. С. 98-99. Сложные
функциональные блоки РЭА. Материалы VIII научно-техн. конф. молодых
специалистов. 2009. С. 19-20.
Сложные
функциональные блоки РЭА. Материалы VIII научно-техн. конф. молодых
специалистов. 2009. С. 19-20.